放射線利用技術データベースのメインページへ
作成: 1998/09/18 日下部 俊男
データ番号 :040151
レーザー電離を用いたスパッタ二次中性粒子質量分析法による表面元素・深さ分析
目的 :レーザー電離を用いたイオンスパッタ2次中性粒子質量分析法による物質表面の元素および深さ分析
放射線の種別 :重イオン,中性粒子
放射線源 :液体金属ガリウムイオン源(8-25keV, 0.2-6nA)、 セシウムイオン源(8-14keV)、 KrFエキシマレーザー(5eV, 109-1010 W/cm2)
利用施設名 :ローザンヌ理工科大学、カイザースラウテルン大学
照射条件 :超高真空中
応用分野 :固体物理、表面科学、材料科学、分析化学
概要 :
重イオンビーム衝撃による中性のスパッタ粒子をイオン化して分析する、スパッタ二次中性粒子質量分析法(SNMS)が発展してきている。スパッタ粒子を電子で電離する方法が最初に考案されたが、レーザーによる電離法も発展し、SIMSに匹敵する深さ方向および面分解能を持つようになった。またこの方法はSIMSなどの装置に付帯設備として組み込まれ、容易に他の分析法に切り替えることが出来る。
詳細説明 :
物質の表面・深さ元素分析には、今日様々な方法が開発されてきた。またプローブとして用いる粒子も多様である。このうちイオンビームをプローブとして用いる分析法には、後方散乱法(RBS)、PIXE法、核反応分析法、二次イオン質量分析法(SIMS)、イオン弾性散乱法(ISS, MEIS)などがある。比較的近年になって、重イオンの衝撃によって固体表層から放出されるスパッタ粒子のうち、中性粒子をイオン化して分析する「スパッタ二次中性粒子質量分析法(SNMS)」もまた発展してきた。中性スパッタ粒子をイオン化する方法も種々考案され、主として、電子による方法(e-gas SNMSとe-beam SNMS)と、レーザー(laser SNMS)による方法とが今日一般的である。
スパッタ粒子のうち二次イオンを分析するSIMSは、面分解能:数μm、深さ方向分解能:数nmと実用化している。しかしスパッタリング粒子の大部分は中性であり、SNMSがより有利である。またスパッタリングと電離過程を分離したSNMSでは、SIMSで問題となる化学マトリックス効果がなく、中性粒子のイオン化効率は装置ごと一定である。
1972年カイザースラウテルン大学のOechsnerらによって、RFプラズマを用いたSNMSが、初めて開発されて以来、電子電離によるSNMSは着実な発展を遂げてきた。一方レーザーで中性のスパッタ粒子を電離する方法は、これより約10年ほど遅れて、非共鳴電離型がアメリカのBeckerらにより、また共鳴電離型のものがほぼ同時期に幾つかのグループにより研究された。非共鳴電離型 laser SNMSでは今日SIMSと組み合わせた装置が多く見られる。 図1にその一例を示す。

図1 Schematic overview of the experimental set-up: combained SIMS / Laser-SNMS time-of-flight mass spectrometer. (原論文1より引用)
レーザーがパルス運転となるため、質量分析には飛行時間法(TOF)が使用される。またセシウムイオン源を使用すると、二次の負イオンおよび正イオンの両方がSIMSモードで分析出来るようにもなっている。イオン源もパルス運転となる。イオン源のパルス周期は、TOF分析とスパッタのための2つのサイクルの繰り返し運転となり、物質の深さ分析が容易に行えるようになっている。
なお、この装置のイオン源は、Gaイオンも発生できるようになっており、この場合負イオンのSIMS解析は出来ないが、より高分解能の深さ分析が行えるようにもなっている。Gaイオンによる金属タンタル表面の酸化層のSNMS深さ分析の例を図2に示す。
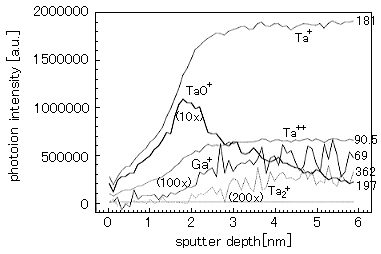
図2 Laser-SNMS sputter depth profile of the about 2 nm thin naturally grown oxide overlayer on metallic Ta using 11.6 keV Ga+ ion bombardment. A quantitative evaluation will be given in Ref. 43. (原論文1より引用)
この図から、酸化層は約2nmであり、約5nmまで酸素が拡散していることが分かる。これはSIMSによる結果とも一致している。このようにスパッタをおこさせるイオンを選べば、SNMSでも約1nmの分解能の深さ方向分析が可能であり、SIMSとほぼ同じ分解能を持つようになってきた。
一方、物質表面の元素分布を二次元影像として可視化する装置の開発も進んでいる。その一例としてカイザースラウテルン大学による銀板上のニッケルメッシュのSNMS二次元像を図3に示す。
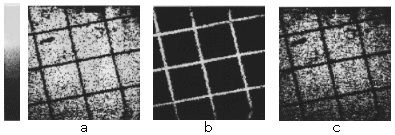
図3 SNMS images of a Ni grid (300 μm mesh width, 20 μm bar width) pressed into a silver substrate. All images were acquired simultaneously with one laser shot per pixel. Field of view: 1 mm × 1 mm, 128 × 128 pixels; ionizing laser: 248 nm, 109 W cm-2, 100 Hz; primary ion beam: 25 keV Ga+, 6nA, 1 μm spot size (FWHM). (a) 107Ag signal; (b) 58Ni signal; (c) 69Ga signal.(原論文2より引用)
このうち(a)は銀板からのAg信号で、ニッケルメッシュは影となる。(b)がニッケルメッシュからのNiの信号である。(c)は入射イオンとして使用したGaイオンが主に銀板にインプラントされ、それが再スパッタされて検出されたものである。この写真ではピクセルの分解能の関係で、面分解能はおよそ10μmである。彼らはさらに種々の検討の結果約1μmの位置分解能を得ている。
共鳴型レーザー電離の原理や方法にもいくつもの種類がある。また非共鳴型と共鳴型の比較研究は少ないが、例えばHavrillaらの研究が参考となるであろう。
コメント :
レーザー電離によるSNMSは、SIMSと共に一つの装置で行えるので、今後利用が広まるものと思われる。
原論文1 Data source 1:
Reactive Ion Sputter Depth Profiling of Tantalum Oxides: a Comparative Study Using ToF-SIMS and Laser-SNMS
K.Franzreb, H.J.Mathiueu and D.Landolt
Laboratoire de metallurgie chimique, Department des materiaux, Ecole Polytechnique Federale de Lausanne (EPFL), MX-C Ecublens, CH-1015 Lausanne, Switzerland
Surface and Interface Analysis, VOL. 23, p. 641-651 (1995)
原論文2 Data source 2:
Laterally Resolved Chemical Analysis of Solid Surfaces by Laser-SNMS
W.Berthold and A.Wucher
Fachbereich Physik, Universitat Kaiserslautern, Erwin-Schrodinger-Str., D-67663 Kaiserslautern, Germany
Surface and Interface Analysis, VOL. 23, p. 393-398 (1995)
参考資料1 Reference 1:
Microanalysis of solid surfaces by Secondary Neutral Mass Spectrometry
A.Wucher
Fachbereich Physik, Universitat Kaiserslautern, Erwin-Schrodinger-Str., W-6750 Kaiserslautern, Germany
Fresenius J. Anal. Chem., vol.346, p. 3-10 (1993)
参考資料2 Reference 2:
Comparison of resonant and nonresonant ionization in sputtered initiated laser ionization spectrometry
G.J.Havrilla, M.Nicholas, S.R.Bryan, J.G.Pruett
BP Research Warrensville Research Center, Cleveland, Ohio 44128-2837, USA
Inst. Phys. Conf. Ser., No 114: Section II, Paper presented at RIS 90, Varese, Italy, 16-21 September, 1990, p. 405-408
キーワード:イオンスッパッタリング、二次中性粒子質量分析法(SNMS)、レーザー電離、深さ方向分析、元素分布二次元像
ion sputtering, secondary neutral mass spectrometry (SNMS), laser post-ionization, depth profiling analysis, two- dimensional image of elemental distribution
分類コード:040402, 040501, 040502
放射線利用技術データベースのメインページへ