���������ѵ��ѥǡ����١����Υᥤ��ڡ�����
������ 1998/09/18 ������������
�ǡ����ֹ桡������040150
�Ż���Υ���Ѥ������ѥå�������γ�Ҽ���ʬ��ˡ�ˤ��ɽ�̸��ǡ�����ʬ��
��Ū���������������ץ饺�ޤ��Żҥӡ���ˤ����Υˡ���Ѥ��������ѥå�������γ�Ҽ���ʬ��ˡ�ˤ��ʪ��ɽ�̤θ��Ǥ���ӿ���ʬ��
�������μ��̡������ť�����,�Ż�,����γ��
���������������������르��RF�ץ饺��(Ar+:0.1-2keV, 250��A; e-: 10eV), ���ζ�°������(2-5keV, 1-8��A), �Żҽ�(40-100eV)
���ѻ���̾�������������������饦�ƥ�����
�ȼ;���������Ķ�⿿����
����ʬ�������������ʪ��,ɽ�̲ʳ�,�����ʳ�,ʬ�ϲ���
���ס�������������
���ť�����ӡ����ˤ�������Υ��ѥå�γ�Ҥ�����ʬ�Ϥ��롢���ѥå�������γ�Ҽ���ʬ��ˡ(SNMS)��ȯŸ���Ƥ��Ƥ��롣�ץ饺�ޤΥ�����ǥ��ѥå����������ŻҤ���Υ������ˡ���ǽ�˹ͰƤ��졢SIMS��ɤŨ���뿼��ʬ��ǽ����Ĥ褦�ˤʤä�������˽ť����������ߤ����ޤ��������Żҥӡ���ǹԤ���ˡ����ȯ���졢SIMS�ʤɤ����֤��Ȥ߹��ޤ졢ʪ��ɽ�̤θ���ʬ�������ʬ��ǽ��������褦�ˤʤäƤ�����
�ܺ���������������
��ʪ����ɽ�̡���������ʬ�Ϥˤϡ������͡�����ˡ����ȯ����Ƥ������ޤ��ץ����֤Ȥ����Ѥ���γ�Ҥ�¿�ͤǤ��롣���Τ���������ӡ����ץ����֤Ȥ����Ѥ���ʬ��ˡ�ˤϡ���������ˡ(RBS)��PIXEˡ����ȿ��ʬ��ˡ�����������ʬ��ˡ(SIMS)����������������ˡ(ISS, MEIS)�ʤɤ����롣
�����Ū��ǯ�ˤʤäơ��ť�����ξ�ˤ�äƸ���ɽ�ؤ������Ф���륹�ѥå�γ�ҤΤ���������γ�Ҥ�����ʬ�Ϥ���֥��ѥå�������γ�Ҽ���ʬ��ˡ(SNMS)�פ�ޤ�ȯŸ���Ƥ������������ѥå�γ�Ҥ�������ˡ���ͰƤ��졢��Ȥ��ơ��ŻҤˤ����ˡ(e-gas SNMS��e-beam SNMS)�ȡ��졼����(laser SNMS)�ˤ����ˡ�Ȥ���������Ū�Ǥ��롣
�����ѥå�γ�ҤΤ����������ʬ�Ϥ���SIMS�ϡ���ʬ��ǽ������m����������ʬ��ǽ����nm�ȼ��Ѳ����Ƥ��롣�����������ѥå����γ�Ҥ�����ʬ�������Ǥ��ꡢSNMS��ͭ���Ǥ��롣�ޤ������ѥå������Υ������ʬΥ����SNMS�Ǥϡ�SIMS������Ȥʤ벽�إޥȥ�å������̤��ʤ�������γ�ҤΥ�����Ψ�����֤��Ȱ���Ǥ��롣
��1972ǯ�����������饦�ƥ����ؤ�Oechsner��ˤ�äơ�RF�ץ饺�ޤ��Ѥ���SNMS(e-gas SNMS)�����Ƴ�ȯ���줿����1�ˤ��θ����ޤ����ǽ�˳�ȯ���줿�Τϡ��ץ饺�ޤȸ��λ����Ȥδ֤�ľή���Ű̺�(��1(a))����ä����ץ饺����νť����������˾⤵���ƥ��ѥå�������������ˤ�äƥץ饺��������Ф��줿�����Υ��ѥå�γ�Ҥ�ץ饺������ŻҤˤ�ä���Υ�������������������ץ饺���˰����Ф��Ƽ���ʬ�Ϥ����ΤǤ��ꡢľ�ܾ�⡼��(DBM)��e-gas SNMS�ȸƤФ�롣
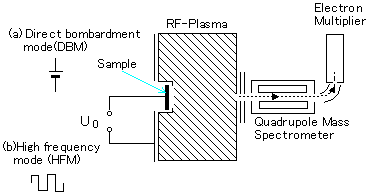
��1��Schematic of the electron-gas secondary neutral mass spectrometry. Electric potential U0 between the RF-plasma and sample apply is supplied with a constant DC voltage in the direct bombardment mode (a) and a square-wave high-frequency voltage in the high-frequency mode (b), respectively.
��������ˡ�ˤ�뿼��ʬ�Ϥΰ�����2�˼����������Si��˥���ץ��Ȥ��줿P�ο�������ʬ�ۤ�ɽ����P��ʬ�ۤ���10nm�����ζ���˾��η����֤���¤������졢�������ȿ�Ф�Si��ʬ�ۤ�����Ƥ��롣�����Si���Ҥ�P���Ҥ��֤�����ä����Ȥ��б����Ƥ��롣
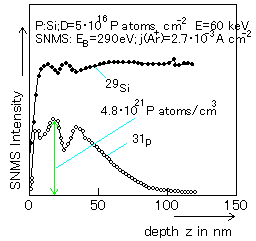
��2��SNMS analysis of an unannealed P implantation profile in Si for a relatively high implantation dose D of 5��1016 P atoms cm-2. The 31P and 29Si peaks have been recoded alternatively in the same experiment.�ʸ���ʸ1�����ѡ���Reproduced from J. Vac. Sci. Technol., vol.A3(3), May/Jun (1985) 1403-1407, H.Oechsner et al., Figure 5 (Data source 1, pp.1406), Copyright (1985) by American Institute of Physics, Woodbury, NY, USA, and with permission of the copyrighter and the author.��
�������Oechsner��ϡ��ץ饺��-�����֤��Ṳ̋����Ȥ������ȤȤ��뤳�Ȥǡ�����ɽ�̤����Ť�ڸ������ʪ�������ʬ�ϤǤ���褦�ˤ�������������ȥ⡼��(HFM)��e-gas SNMS�ȸƤ֡��������ʪ�Υ���ߥå�(BaTiO3)�ʤɤ�HFM��ʬ�Ϥ���𤷤Ƥ��롣�������Ƴ���������ˤĤ��Ƥ�DBM��Ʊ�ͤ�ʬ�ϤǤ���ɽ�̤ιӤ줬���ʤ��ʤ롣
������������«�����ɤ��ť�����Ƥ������ߤ�������ˤ�ꥹ�ѥå����������RF�ץ饺�ޤǥ��ѥå�γ�ҤΥ����Τ߹Ԥ��褦�ˤ�������ɽ�̤θ���ʬ�������¬�������֤Ⳬȯ���졢��Ϥ�Oechsner���SIMS������Ӥ��Ƶ������Ƥ��롣����ϡ�ʬΥ��⡼��(SBM)��e-gas SNMS�ȸƤФ�롣
�������Ȥ��̤�RF�ץ饺�ޤ�����ˡ��ŻҽƤ��ߤ�����ˤ�äƥ��ѥå�γ�Ҥ�������ˡ����ȯ���줿�����줬�Żҥӡ���ˤ��SNMS(e-beam SNMS)�Ǥ��ꡢ���γ�ǰ�ޤ��3�˼�����
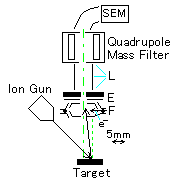
��3��Schematical setup for electron beam SNMS.�ʸ���ʸ5�����ѡ���Reproduced from Fresenius J. Anal. Chem., vol.346 (1993) 3-10, A.Wucher: Microanalysis of solid surfaces by Secondary Neutral Mass Spectrometry, Figure 3 (Data source 5, pp.4), Copyright (1993) by Springer-Verlag, Heidelberg, Germany, and with permission of the copyrighter and the author.��
����ϡ�e-gas SNMS��꾮���˽��衢SIMS�ʤɤ�¾��ʬ����ˡ�ˤ��Τޤ��ڤ��ؤ���졢�ޤ��ץ饺�ޤ�ư�����ϳ�̤�ʤ���Ķ�⿿�����Ǥ�ʬ�Ϥ��Ԥ���ʤɤ����������롣
�����������̾�θ��ǡ�����ʬ�Ϥˤ����Ƥϡ����̤�e-gas SNMS�Ǥϻ����ؤνť�����ξ⥨�ͥ륮�����100 eV�̤ˤޤ��㤯�Ǥ��뤬��������Ψ���㤤e-beam SNMS�Ǥϥ��ѥå����Ψ�褯���������뤿��ˡ�������ξ⥨�ͥ륮���Ͽ�keV��ʬ�Ϥ��Ԥ��롣Ganschow��ϡ�DBM�����SBM��e-gas SNMS��e-beam SNMS�Ȥ���Ӥ�Ҥ٤Ƥ��롣�ޤ������϶�°���μ�ζ�°ʬ������¬�ꤷ(����ϳ�ȯ����Τ�ΤǤ��뤬)������20nm����ʬ��ǽ�����Ƥ��롣
�����ȡ���������
���Żҥӡ�����Ѥ���SNMS�ϡ�SIMS�ʤɤ�¾�����֤��Ȥ߹��ळ�Ȥ������Τǡ��졼����SNMS�ȶ��˺����ȯŸ�����Ԥ���롣
����ʸ�� Data source 1��
High resolution sputter depth profiling of implantation structures in Si by low energy SNMS
H.Oechsner, H.Paulus, and P.Beckmann
University of Kaiserslautern, Federal Republic of Germany
J. Vac. Sci. Technol,. A3(3), May/Jun (1985) p. 1403-1407,
����ʸ�� Data source 2��
Recent instrumental developments in surface and thin-film analysis by electron and mass spectrometric techniques
H.Oechsner
Fachbereich Physik und Institut fur Oberflachen- und Schichtanalytik, Universitat Kaiserslautern, D-6750 Kaiserslautern, Germany
Applied Surface Science, 70/71 (1993) p.250-260,
����ʸ�� Data source 3��
Analysis of solids with a secondary-neutral microprobe based on electron-gas post-ionization
W.Bieck, H.Gnaser, H.Oechsner
Institut fur Oberflachen- und Schichtanalytik und Fachbereich Physik, Universitat Kaiserslautern, D-67663 Kaiserslautern, Germany
Fresenius J. Anal. Chem., vol. 353, p. 324-328 (1995)
����ʸ�� Data source 4��
Progress in solids analysis by sputtered neutral mass spectrometry
O.Ganschow, R.Jede and U.Kaiser
Leybold AG, Bonner Str. 496, D-5000 Koln 51, FRG
Vacuum, Vol. 41, No. 7-9, 1654-1660 (1990)
����ʸ�� Data source 5��
Microanalysis of solid surfaces by Secondary Neutral Mass Spectrometry
A.Wucher
Fachbereich Physik, Universitat Kaiserslautern, Erwin-Schrodinger-Strasse, W-6750 Kaiserslautern, Germany
Fresenius J. Anal. Chem., vol.346, p. 3-10 (1993)
������ɡ������ѥå����,������γ�Ҽ���ʬ��ˡ(SNMS),����ȥץ饺��,�Ż���Υ,��������ʬ��,����ʬ������
ion sputtering, secondary neutral mass spectrometry (SNMS), RF-plasma, electron post-ionization, depth profiling analysis, two-dimensional image of elemental distribution
ʬ�ॳ���ɡ�040402, 040501, 040502
���������ѵ��ѥǡ����١����Υᥤ��ڡ�����