放射線利用技術データベースのメインページへ
作成: 1998/09/16 川面 澄
データ番号 :040146
中エネルギーイオン散乱分光法(MEIS)を用いた表面・界面の解析
目的 :イオンビームを利用した表面・界面の組成および構造解析
放射線の種別 :陽子,軽イオン
放射線源 :静電型加速器 (0.3 MeV H2+, 1.5 MeV He+)
フルエンス(率):積分値で数μC
利用施設名 :トヨタ中研ヴァン・デ・グラフ加速器
照射条件 :真空中
応用分野 :電子デバイス材料開発、イオンビーム分析技術、照射損傷の研究、表面・界面科学
概要 :
固体表面や界面の元素組成や構造の決定、深さ方向の組成分析に用いられるイオン散乱分光法のなかで、特に、中エネルギーイオン散乱分光法(MEIS)をとりあげて、低および高エネルギーイオン散乱分光法と比較しながら、その原理、特徴などを概説した。
詳細説明 :
固体表面や界面の元素組成や構造の決定、深さ方向の組成分析は、半導体・セラミックスなどでの新デバイス・新素材の開発にとって重要な課題である。入射エネルギーが数100eVから数MeVのイオン散乱分光法は、それらを非破壊で測定できる方法の一つとして利用されている。イオン散乱分光は入射イオンのエネルギーにより3種類に分類される。
低エネルギーイオン散乱分光法(LEIS、またはISS)は数100eVから数keV領域、中エネルギーイオン散乱分光法(MEIS)は数10keVから数100keV領域、高エネルギーイオン散乱分光法(HEIS、またはRBS)は数100keVから数MeV領域の入射イオンを使用する。ここでは中エネルギーイオン散乱分光法の特徴、およびそれにより得られて結果について概説する。
MEISでは、数10keVから数100keVのエネルギーを持つ水素・ヘリウム等の軽元素イオンの平行ビームを入射させ、標的試料によって散乱されたイオンのエネルギースペクトルおよび角度スペクトルを測定する。入射イオンは標的原子と弾性散乱を行い、その角度を変え、同時にそのエネルギーを失う。したがって、入射イオンの質量m、エネルギーE0と標的原子の質量M及び散乱角度が決まれば、散乱後のイオンのエネルギーEは式(1)によって与えられる。
E = E0{m/(m+M)}2{cosΘ + (M2/m2-sin2Θ)1/2}2 (1)
入射イオンが標的原子により散乱される場合、シャドーイング効果により、シャドーコーンと呼ばれる、入射イオンが入り込めない包絡面が形成される。このシャドーコーン内に第2の原子が存在すると入射イオンからは見えないことになる。このシャドーコーンの大きさは入射イオンの種類とエネルギーおよび標的原子の種類により異なる。入射イオンや標的原子の原子番号が大きくなると、大きくなり、入射エネルギーが大きくなると、小さくなる。その他、チャネリング効果やブロッキング効果を利用して固体試料の構造解析や原子位置の精密測定が可能となってくる。
MEISでは散乱イオンのエネルギー分析に静電型分光器を用いることが多い。この分光器のエネルギー分解能 △E/E は4x10-3程度であり、このとき、深さ分解能は0.3nmのオーダーである。このようにMEISは高い深さ分解能を持つことが大きな特徴で、2-3原子層の分解能で濃度分布や構造解析が出来る。さらに、入射角や取り出し角を試料表面にすれすれにするか、分光器のスリットを絞ることで、1原子層オーダーの分解能を示す研究も報告されている。
次に、MEISとRBS(またはHEISと呼ばれることもある)を比較した実験例を示す。実験はSi(100)基板の上に、Au薄膜を厚さ約40 nm程度蒸着した試料をRBSとMEISにより解析したものである。
図1(a)は、1.5 MeV He+ イオンを用いたRBSスペクトルの実験結果(丸印)とシミュレーションの結果(実線)を示す。図1(b)は300 keV H2+ イオンを用いたMEISスペクトルの実験結果(丸印)とシミュレーションの結果(実線)を示す。
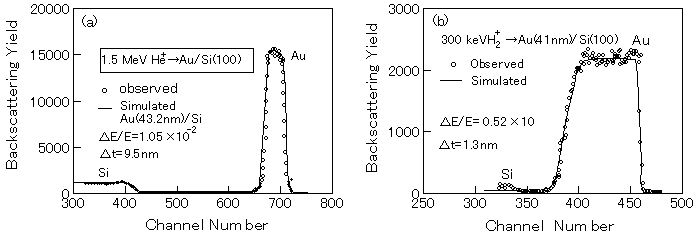
図1 (a) Observed (data points) and simulated (solid curve) RBS spectra from the Au/Si target. A 1.5 MeV He+ beam was used as a probe and the incident and detection angles were 15° and 42° with respect to surface normal, respectively. (b) Observed (data points) and simulated (solid curve) MEIS spectra. The 300 keV H2+ beam impinged on the Au/Si target in the surface normal direction. The H+ ions were detected at an scattering angle of 135°.(原論文1より引用。 Reproduced from Surface Science, 207 (1989) 427-440, I.Konomi, A.Kawako, Y.Kido:Damage Profile of Ar+-Irradiated Si(100) and GaAs(100) by Medium Energy Ion Scattering, Figure 1 (a) and (b) (Data source 1, pp.429), Copyright (1989), with permission from Elsevier Science, Oxford, England. )
RBSスペクトルの解析からAu膜の厚さは43 nm、相対的なエネルギー分解能は1.05x10-2であることが示された。これは深さ分解能が9.5 nmであることを示している。一方、MEISスペクトルからは、Auの膜厚が41 nm、エネルギー分解能が5.2x10-3であることが示された。これは深さ分解能が1.3 nmであることを示す。MEISを用いることによってエネルギー分解能および深さ分解能が著しく改善されていることが示された。
中エネルギーイオン散乱分光法(MEIS)は、低及び高エネルギーイオン散乱分光法のそれぞれの長所を取り入れるという考え方で開発されてきた。イオンエネルギーの分析に静電型分光器を使用するため、中性粒子を計測できないので、定量性には問題が残る。これも構造解析の点では何ら問題はない。この欠点を克服するため、飛行時間型の分析器の利用などが考えられる。
コメント :
中エネルギーイオン散乱分光法(MEIS)は、低及び高エネルギーイオン散乱分光法のそれぞれの長所を取り入れるという考え方で開発されてきた。表面だけではなくある程度の深さまで分析可能であり、界面の分析によも適用できる方法である。イオンエネルギーの分析に静電型分光器を使用するため、深さ分解能は高いが、中性粒子を計測できないので、定量性ではRBS(HEIS)に劣る。表面・界面での原子位置の決定精度は非常に優れている。原子量が近い元素の区別がつきにくい(GaとAs等)。検出器がやや複雑で大きいのが欠点である。
原論文1 Data source 1:
Damage Profile of Ar+-Irradiated Si(100) and GaAs(100) by Medium Energy Ion Scattering
I.Konomi, A.Kawano and Y.Kido
Toyota Central Research and Development Laboratories, Inc., Nagakute-cho, Aichi-gun, Aichi-ken, 480-11, Japan
Surface Science, vol. 207 (1989) 427-440.
原論文2 Data source 2:
中エネルギーイオン散乱法を用いた表面界面研究
越川孝範、安江常夫
大阪電気通信大学エレクトロニクス基礎研究所応用電子工学科、572寝屋川市初町18-8
応用物理, 第64巻, 第5号 (1995) 427-437
原論文3 Data source 3:
中エネルギーイオン散乱スペクトロメトリ
西岡 孝
日本電信電話(株)基礎研究所、243-01神奈川県厚木市森の里若宮3-1
Radioisotopes, Vol. 44, No. 5 (1995) 349-353.
キーワード:中エネルギーイオン散乱分光法、イオン散乱、表面、界面、構造解析、イオンビーム解析
medium-energy ion scattering spectroscopy, ion scattering, surface, interface, structure analysis, ion beam analysis
分類コード:040402, 040501,040502
放射線利用技術データベースのメインページへ