���������ѵ��ѥǡ����١����Υᥤ��ڡ�����
������ 1998/08/30 ����������
�ǡ����ֹ桡������040143
2�����������ʬ�Ϥˤ��Ƽ������ʬ����
��Ū���������������ⲽSiO2���졢��ͻ��ϧ������Ķ��Ƴ�κ����������˼��ʬ�ۤ��Ф���2�����������ʬ�Ϥ�����
�������μ��̡������ڥ�����
������������������PHI Model 6600 SIMS��Combined Perkin-Elmer Atomica SIMS-AES system (Mod ADIDA 3000-30)��
�ե륨��Ψ�ˡ�����ʬ�� 1500eV D������ 1016��1018 ����/cm2
���ѻ���̾��������Swiss Federal Institute of Technology��RCA�������(�ƹ�)
�ȼ;���������������
����ʬ���������ɽ�̹�¤������ʬ�ϡ�����ʬ�ϡ��ſ���ʬ�ϡ�Ķ��Ƴ�θ���ʬ��
���ס�������������
�����IJ�SiO2�ؤΥ����ǤˤĤ��ƿ����ץ��ե���������뤿���2�����������ʬ��(SIMS)���Ѥ����㥨�ͥ륮Cs�ȼͤ�ʻ�Ѥ���Cs�ǥ��饹����������2�����ѥĥ����郎�����Ǥ˹ⴶ�٤��Ļ���������ͻ�絻�Ѥ˱��Ѥ���SIMS�Ǥ������ӡ�����ο��Ǥ�ſ��Ǥγ˼ﺮ�硢ú����νſ��Ǥ�˰��ǻ�١�����Ʊ���θ�����Ĵ�٤���Ķ��Ƴ��YBa2Cu3O7����ˤĤ����������ú�DZ����̡������ץ��ե����롢���������ˤĤ���SIMS��AES��XPS�ˤ��Ĵ�٤���
�ܺ���������������
����°����ʪȾƳ�ΥǥХ�����¤����SiO2Ͷ��������˥�����(N)��������ȡ�������ŵ�Ū����¤Ū��������������롣�ۤʤ���IJ��ޤ��Ѥ������٤Ȼ��֤��Ѥ��������Ĺ������ȡ�N�϶ˤ����������ʪ( < 100��)���桢Ǥ�դο����� " ǻ�� " ����롣
�������ͤ��������Nʬ�ۤ�SIMS�ˤ�ĤƷ���Ǥ���ǻ�٤��������������SiO2��ɸ��������Ѥ���̤�λ��������Τ����̤�Ԥ���Cs�����饹����SIMS�ˤ�����Cs������ȼͤ����2�����������Ф�¥�ʤ����Ѥ��졢N��O��Si���ͤ��ŵ������٤��ij˼��ͭ���Ǥ��롣�������̲��ȱ������Si/SiO2���̤����˽Ҥ٤Ƥ��롣
����1�Ǥϡ��ޥȥ�ĥ������̤���Ȥ���N�ο����ץ��ե�����ǤϺƻ������SiO2/Si���̡��ޤ��Ϥ��ζ�ǽ�ᤫ�����Ѥ��줿N�����̤����ư�����ǽ�Ū�ˤ�����ֶ�˻Ĥ뤳�Ȥ���EPROM���Ѥ�Ŭ�Ѥ���������η������ع�¤��¿���Ǵ�Ͷ�����������ġ��������Ҥθ��Ϥ���ߤ�С�����SIMS���Ѥ϶ɺߤ���N��ѻ�����Τ�ɬ�פʹ⤤����ʬ��ǽ�������Ƥ��롣
��SIMS�ϥ��IJ�����ʪ�ؤ�N�ι⤤ʬ��ǽ�������ץ��ե���������뤿������ѤǤ��롣�㥨�ͥ륮��Cs�ȼͤǤ�Cs�ǥ��饹����������2�����ѥĥ������N�˹ⴶ�٤��ġ����տ�����ȯ��������ץ��ȥ�������Ѥ������̤���������ɸ����������Ѥ�ޤᡢ��ʬ��ˡ�Ϲ⤤���Τ������٤����롣
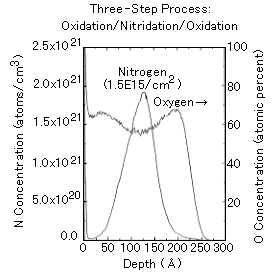
��1��Three-Step Process: Oxidation /Nitridation /Oxidation. �ʸ���ʸ1�����ѡ���Reproduced from Applied Surface Science, 104/105 (1996) 379-384, M.R.Frost, C.W.Mageea: Characterization of nitrided SiO2 thin films using secondary ion mass spectrometry, Figure 4 (Data source 1, pp.382), Copyright (1996), with permission from Elsevier Science.��
����ͻ�縦��ˤ�����SIMS�ˤ�����(H)�Ƚſ���(D)��ʬ�Ϥ˴ؤ������Ǥ��롣������ʬ�Ϥˤϥ��å����ץ饺�ޤˤ�����H��D�Υե�å����ȥ��ͥ륮��¬�ꡢH��D��Ʊ����ʬΥ��Ʊ���θ��桢����������狼�������ӡ�������H��D���Ф���˼����¬������ޤࡣ
�����饹��˾�ȯ������2000�������ú�������1016��1018����/cm2�Υե륨��1500eV��D�������������������2�˼����ͤ�D(3He, p)4He��ȿ����1016D/cm2��������100%��ͤ�����������1018D/cm2����������������2.8��1017D/cm2������ͭ���뤳�Ȥ�Ƚ�Ĥ��������ͤ�SIMS�ϳƻ�������D�ο���ʬ�۷���ˤΤ��Ѥ���������Ǥ�SIMS���Ѥ���H��D�ο����ץ��ե���˴�Ϣ�����������������褦�Ȼ�ߤ������������ưפ˲�褹����������Ȥ�Ƚ�Ĥ����������Ǥ���г�ͻ�����֤Υץ饺������ߺ��Ѥθ���˹��Ǥ���ȹͤ����롣
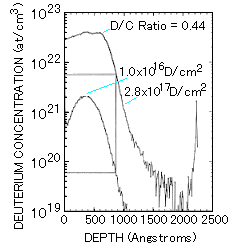
��2��Composite of SIMS 2D depth profiles 1500 eV 2D��C. Carbon was in the form of 2000-��-thick amorphous films evaporated onto glass substrates. The implanted fluences were 1016 and 1018 atoms/cm2. D(3He, p)4He NRA detected 1016 and 2.8��1017 atoms/cm2, respectively, for the implants. Together, SIMS and NRA can accurately determine the D/C ratio at the saturated peak of the high fluence implant. 5 keV 40Ar+, positive ion detection (from Ref.18). Film=36��gm/cm2=9.0��1022 atoms/cm3(for 2000�� film). �ʸ���ʸ2�����ѡ���Reproduced from J. Vac. Sci Technol., vol.A1(2), Apr.-June 1983, p.901-906, C.W.Magee: Analysis of hydrogen and deuterium by secondary ion mass spectrometry as applied to fusion technology, Figure 2 (Data source 2, pp.905), Copyright (1983), with permission from American Institute of Physics and the authors.��
���⤤Ķ��Ƴ���ܲ���(Tc=79K)����100-200mm������Ķ��Ƴ��YBa2Cu3O7-x(YBCO)�����SiO2����Y2O3������ؤ���SrTiO3����Si�ξ��350��650����ϽФ����������ο����ץ��ե�����ʬ�Ϥ�AES��XPS��SIMS�ˤ�ĤƹԤä���
����3��YBCOñ�뾽��YBCO��Τ�������1��2�ؤˤĤ���Ʊ�����¬�ꤷ������Ū������SIMS�ǡ����������פʥ��������Ҥ����Ƥ�Ʊ�ꤵ��Ƥ��롣���������������Ҥ�¸�ߤȶ��٤ˤ϶Ϥ�����㤬���롣ñ�뾽(a)�ξ�硢Al�κ��פϻ�����������Ѥ�������ߥ��Ƥˤ���ΤǤ��ꡢ����(b)�ξ��ˤϡ�Si�ˤ��ɽ�̱������ĤȤ���CO�Ф��롣��Ԥ�650��ǤΥ��ѥĥ����Ͻ���ΥХ륯�Ȼ��ˤ���ΤǤ��롣m/q=12(C), 28(CO)��44(CO2)�ˤ�����ú�DZ����϶ˤ���㤯��ñ�뾽����ξ���ɤŨ���롣���Ǥ�ξ���ξ��˸��Ф���Ƥ��롣ξ�Ԥμ��̥��ڥ��ȥ�϶ˤ��������Ƥ��ꡢ�ؤ�Ʊ���ɽ�������ȥ�����Ψ����
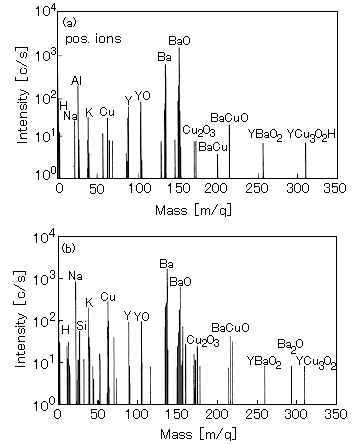
��3��Positive static SIMS mass spectra of (a) YBCO monocrystal and (b) thin superconducting film(run 147). Intensity(counts s-1) is shown as a function of mass/charge ratio using 5 keV Ar+ primary ions at 5 nA primary current. �ʸ���ʸ3�����ѡ���Reproduced from Vacuum, vol.41, Nos.4-6, p.870-874 (1990), A.Gauzzi, H.J.Mathieu, J.H.James and B.Kellett: AES, XPS and SIMS characterization of YBa2Cu3O7 superconducting high Tc thin films, Figure 4 (Data source 3, pp.874), Copyright (1990), with permission from Elsevier Science.��
�����ȡ���������
������ɽ�̤�����ʬ��ˡ�Ȥ���ȯŸ��������SIMS�α�����ˤĤ��ƾҲ𤷤�������ϡ���ȾƳ���ǻҤ���¤�ץ�������ɽ�̲����˴�Ϣ����SiO2�졢����ͻ��ϧ��1�ɤ�ɽ�̲����˴�Ϣ�������ǡ��ſ���ʬ�ϡ���Ķ��Ƴ��Ba2Cu3O7���������ʬ�ϤǤ��롣������ˤ�AES��NRA���ͤ����ʬ��ˡ�ˤ���̤�ޤޤ졢SIMS�����ʬ��ˡ����ߤ��䴰����ĤƤ�����������뤳�Ȥ����褿��ɽ�̲ʳؤβ����Τ���ˤ�����ʬ�ϵ��Ѥ�ȯŸ����Ԥ�������
����ʸ�� Data source 1��
Characterization of nitrided SiO2 thin films using secondary ion mass spectrometry
M.R.Frost, C.W.Magee
Evans East, 666 Plainsboro Road, Suite 1236, Plainsboro, N. J 08536, USA
Applied Surface Science, 104/105 (1996) 379-384
����ʸ�� Data source 2��
Analysis of hydrogen and deuterium by secondary ion mass spectrometry as applied to fusion technology
C.W.Magee
RCA Laboratories, Princeton, New Jersey 08540
J. Vac. Sci Technol., A1(2), Apr.-June (1983) p.901-906
����ʸ�� Data source 3��
AES, XPS and SIMS characterization of YBa2Cu3O7 superconducting high Tc thin films
A.Gauzzi*), H.J.Mathieu*), J.H.James2*) and B.Kellett3*)
Swiss Fedral Institute of Technology, (EPFL), *)Materials Department, CH-1007( 2*)Physics Department, CH-1015), Lausanne, Switzerland
Vacuum, vol.41, Nos. 4-6, 870-874 (1990)
������ɡ�2�����������ʬ�ϡ��ⲽSiO2�� ���졢 ��ͻ�絻�ѡ� ����/�ſ��ǡ� Ķ��Ƴ��YBa2Cu3O7�����������Ż�ʬ����X�����Ż�ʬ��
secondary ion mass spectrometry, nitrided SiO2, thin film, fusion technology, hydrogen/deuterium, superconducting YBa2Cu3O7, Auger Electron Spectroscopy, X-ray Photoemission Spectroscopy
ʬ�ॳ���ɡ�040101, 040405, 040501
���������ѵ��ѥǡ����١����Υᥤ��ڡ�����