放射線利用技術データベースのメインページへ
作成: 1997/11/20 栗原 正義
データ番号 :040106
放射光利用光電子分光法による深さ分析
目的 :放射光を用いたX線光電子分光法によるSi酸化薄膜の表面状態・構造の評価
放射線の種別 :エックス線,電子
放射線源 :シンクロトロン放射光(1.8-6.0 keV)
利用施設名 :高エネルギー物理学研究所ビームラインBL-27A,BL-8A
照射条件 :BL-27Aでは3×10-3Pa, BL-8Aでは1.3×10-4Pa
応用分野 :Si, SiO2, 薄膜厚さ測定
概要 :
高エネ研放射光実験施設BL-27Aを用い、高エネルギーシンクロトン放射光によるX線光電子分光(XPS)により、Si(100)面上SiO2薄膜の厚さを求めた。放射光の様なエネルギー可変励起源を用い、「分析深さは励起エネルギーにより変化する」という関係を適用し、深さ分布を精度よく測定できた。同様に高エネ研放射光実験施設BL-8Aにより、Si表面の酸化初期段階をXPSを用いて調べ、最表面から深さ方向の酸化状態を原子層オーダで明らかにした。
詳細説明 :
XPSによる固体試料の分析深さは、検出する光電子の平均自由行程に依存する。通常のXPSでは、励起源としてMgKα線(1486.6eV)やAlKα線(1253.6eV)を用いており、光電子の運動エネルギーはこれ以下であるため、電子の運動エネルギーと平均自由行程との関係より、分析深さは約2nm以下と見積もられる。一方、より大きい半導体薄膜厚さの測定には分析深さをより深くする必要が生じた。
この為、放射光の様なエネルギー可変の励起源を用いXPS分析を行う場合、固体内の光電子の平均自由行程はその運動エネルギーに従い50eV以上で単調増加する事から、同一の内殻軌道から放出される光電子の運動エネルギーを徐々に変える事により分析深さを連続的に変化させる事が可能となる。特に4〜5keVの高エネルギーのX線を用いた場合、XPSの分析深さは測定する光電子の運動エネルギーによって10nm程度に達する事が計算上知られている。
以上の背景の下に、山本らは1.8〜6.0keVの広範囲なエネルギーの放射光が利用可能なXPSシステムを試作し、Si(100)酸化表面の深さ方向分析等に応用した。空気中で熱酸化(300,700℃)したSiO2薄膜で、Si 1s領域のXPSスペクトルを種々の励起エネルギーで測定した。熱酸化したSiO2薄膜は極めて安定な均一膜である事から、その厚みを変数として基板のSiとSiO2薄膜から得られる光電子強度{I(Si),I(SiO2)}を求めた。更にこれらの強度比I(Si)/I(SiO2)の値を、種々の膜厚dのSiO2層について、光電子の運動エネルギーEkの関数とし図1に破線で示した。併せて実際のスペクトルから得たピーク強度比も黒丸(300℃,15分酸化)と白丸(700℃,30分酸化)で示した。
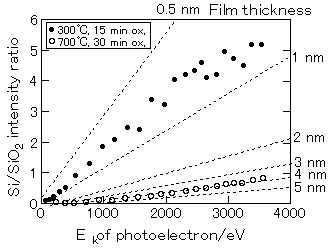
図1 Experimental and calculated results of the relationship between kinetic energy of photoelectrons and ratios of peak intensity I(Si)/I(SiO2) for the thermally oxidized specimens. Experimental results are observed from the Si1s spectra at the various photon energies. Calculated results are obtained from eqs.1〜3.(原論文2より引用)
また、10keVO2+のイオンをO原子で7x1016atoms/cm2の量を注入した、深さ方向に分布をもつSiO2薄膜でも前記の測定方法を検討する為に、イオン注入層の深さ方向分析を試みた。不均一な濃度分布をもつ試料では、ピーク強度比のEk依存性は試料の深さ方向の濃度分布を反映すると考えるため、イオン注入試料の強度比を種々の励起エネルギーで求め、SiO2の深さ方向分布の測定を行った。
試料のEkの関数としたI(Si)/I(SiO2)の値は理論曲線からずれた。ここで、予め典型的な濃度分布を仮定して理論値を計算し、実験値と比較した。その結果、SiO2の濃度分布が最表面で最大値をもつ半ガウス型と仮定した理論曲線(図2(c))が実験値に最も近い傾向を示した。以上の結果、±5%以内の精度でのSiO2薄膜の膜厚測定及びSiO2の深さプロフイル測定が可能となつた。
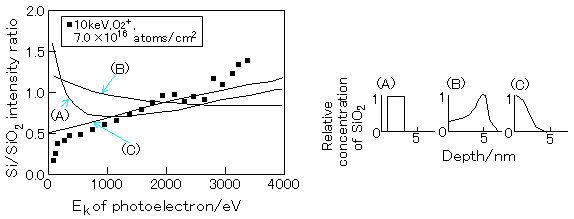
図2 Experimental and calculated results of the relationship between kinetic energy of photoelectrons and ratios peak intensity I(Si)/I(SiO2) for the O2+-ion implanted specimen. Experimental results are the same data as shown in 図1. Calculated results are obtained from eqs.4〜8 by using the depth profiles of the models(A)〜(C).(原論文2より引用)
高エネ研放射光実験施設BL-8Aにより、酸化初期状態でのSi表面状態を分析した。始めに測定装置内でArイオンスパツタ(4kV, 1μA)と直接通電加熱(〜1000℃)を繰り返してSi試料表面を清浄化した。その清浄表面を室温で酸素雰囲気に曝した後、XPSを測定し表面状態の変化をin-situで調べた。なお、酸素分圧1.3x10-4Paの一定の下で試料を酸素雰囲気に曝した。
XPS測定では、最初にSi2p内殻準位(フエルミ準位基準の結合エネルギー:〜100eV)からの光電子が表面状態に鋭敏となる様に入射エネルギーhνを130eVに選んだ。このhνが変化すると、光電子の脱出深さが変わるので深さ方向の状態変化を調べた。酸素雰囲気に曝した後のSi(111)面(図3)と(100)面からのSi2pXPSを見ると、基板Siに比べて高い結合エネルギーをもつ数本のピーク即ちSi酸化状態の成分が形成される。
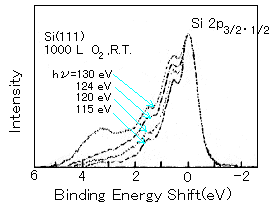
図3 室温で1000Lの酸素雰囲気にさらしたSi(111)面からのSi2p光電子スペクトル:115eV〜130eVの入射エネルギ-hνで測定(1L=1.3×10-4Pa・秒) (原論文3より引用)
これらの酸化状態は、SiO2即ちSi4+の他にSi1+,Si2+とSi3+の成分から成る。最表面からバルクへの深さ方向でのSi酸化状態の変化を差分スペクトルから調べた。初期酸化状態は面方位により相違があり、Si(111)とSi(100)清浄面に特有の表面再配列構造の違いに起因する。以上の結果からSi(111)とSi(100)面の酸化機構モデルを提案した。
コメント :
放射光を用いる高エネルギーXPSは、従来の低エネルギーXPSと異なり、標準試料等の用意なしにSi薄膜の厚さ測定、深さ分布測定を可能にさせた。今後、本邦で新たに稼動する大型放射光施設が表面科学等の発展に貢献することを期待したい。
原論文1 Data source 1:
Application of high-energy synchrotron-radiation XPS to determine the thickness of SiO2 thin films on Si(100)
H.Yamamoto, Y.Baba, T.A.Sasaki
Advanced Science Research Center, Japan Atomic Energy Research Institute, Tokai-mura, Ibaraki-ken 319-11, Japan
Surface Science, 349 (1996) L133-L137
原論文2 Data source 2:
放射光を用いた高エネルギーX線光電子分光法によるSi(100)酸化薄膜の深さ方向分析山本 博之、馬場 祐治、佐々木 貞吉
日本原子力研究所先端基礎研究センター:319-11 茨城県那珂郡東海村
Bunseki Kagaku, Vol.45, No.2, 169-174 (1996)
原論文3 Data source 3:
Si表面とXPS
中沢 正敏
(株)日立製作所 中央研究所
SR Science and Technology Information (SR科学技術情報), Vol.3, No.8 (1993) pp.8-15
キーワード:放射光、X線光電子分光、Si、 SiO2薄膜、深さ方向分布、エネルギー可変励起源、薄膜厚さ測定
Synchrotron radiation, X-ray photoelectron spectroscopy, Si, Silicon dioxide thin film, Depth profile, Variable energy source, Thickness determination of thin films
分類コード:040501, 040403, 040503
放射線利用技術データベースのメインページへ