放射線利用技術データベースのメインページへ
作成: 1997/11/11 日下部 俊男
データ番号 :040104
オージェ電子分光法による深さ分析
目的 :オージェ電子分光法による固体表面層の元素・組成深さ分析の実際と応用
放射線の種別 :エックス線,電子
放射線源 :電子銃、Al K-X線源、イオン源(Ar,2keV,10μAcm-2)、シンクロトロン軌道放射光
利用施設名 :LURE-オルセー軌道放射光、フラスカティ-アドネ蓄積リング、他
照射条件 :真空中
応用分野 :固体物性、材料科学、表面科学
概要 :
表面分析法として多用されるオージェ電子分光(AES)やX線光電子分光(XPS)における試料表面層の深さ分析は、アルゴンなどの重イオンビームを用いたスパッタリングで、試料表面を削り出しながら表面分析を繰り返すという方法が従来良く行われてきた。しかし、最近では角度分解法による非破壊分析法が広まりつつある。またその変形も検討されている。
詳細説明 :
一般にオージェ電子分光(AES)やX線光電子分光(XPS)というと、試料物質表面(数原子層程度)の元素・組成分析がまず思い起こされるが、keVエネルギーの重イオンビーム照射によるスパッタリングを利用して試料の表面層を削り出しながら(イオンエッチング)電子分光分析を繰り返すことにより、深さ分析も行なわれてきている。しかし選択スパッタリング(ある特定の元素が選択的にエッチングされること)の可能性、入射イオンによる表面損傷(アモルファス化、ミキシング等)の影響、表面層のマクロスケールな凹凸の生成など問題点も多い。
そこで、最近角度分解法(AR)による深さ分析が、主にXPSやシンクロトロン軌道放射光(SR)による光電子放出分光法で行われている。これは電子のエネルギー分析器を選べばAESでも可能である。試料面と電子のエネルギー分析器の角度を変化させて深さ方向に関する情報を得ようとするものである。
図1にその原理図を示す。
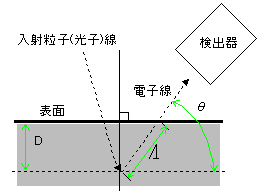
図1 固体内での電子の平均自由行程(Λ)と脱出深さ(D)との関係。
電子の実効的脱出深さDと平均自由行程Λとの間には、D=Λsinθの関係が成立する。ここでθは、試料の水平表面から測った電子の放出角度である。Λは電子のエネルギーでほぼ定まるから、θが小さいほどより表面層からの寄与が強くなる。この方法はアルゴンイオンスパッタ法とは対照的に、標的試料を非破壊で測定できるのが大きな特徴である。
イオンエッチングとは逆に、ある物質層の表面に別の物質を成長させて行く過程で界面付近の物質の状態変化を観測することもできる。例えば図2にSi(111)上にエピタキシャル成長させた鉄層の厚さに対するAESエネルギースペクトルの形状変化を示す。ただし、清浄なシリコン結晶表面からのAESスペクトルの成分を差し引いてある。鉄層が厚くなるにつれて当然のことながら、45eV付近の鉄のオージェ電子のピークが増大する。しかし、より高エネルギーの鉄のオージェやシリコンの酸化物からのオージェの弱い寄与を考慮しても、なお86及び93eV付近に、特に鉄層の薄いときに明確なピークがある。これはシリサイドが鉄とシリコンとの界面に生成し、そのことによってその付近の局所的な電子エネルギーバンド構造が変化したことによる影響と考えられる。なぜならAESスペクトルはオージェ電子が飛び出す局所的エネルギーの変化に敏感で、そのスペクトルの形状を変えるからである。
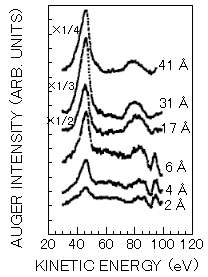
図2 Difference curves between the Fe/Si spectra in Fig.6 and the clean Si one. New silicide features are observed at 〜 81-86 eV and 〜 93 eV.(原論文2より引用。 Reproduced from Physica Scripta, Vol.T35, 251 (1991), Figure 7 (Data source 2, pp.256), with permission from The Royal Swedish Academy of Science.)
この研究を行ったDerrienらのグループは、SRを用いた角度分解光電子放出分光法(AR-PS)によるCoSi2のエネルギーバンド構造を紹介し、異なる温度条件でSi結晶上にCoをエピタキシャル成長させてそれらの界面に出来たCoSi2のバンド構造の違いを議論している。
また、Paparazzoらのイタリアのグループは、シリカ(SiO2)表面をアルゴンイオンエッチングするときにSiOx(0<x<2)が生成することを、通常の電子線励起のAESの他に、X線励起のAES(XAES)、AR-XPS、SRを駆使して示している。その中で例えば、図3に示すようなシリカ中の電子エネルギーに対するΛとDの値について議論している。
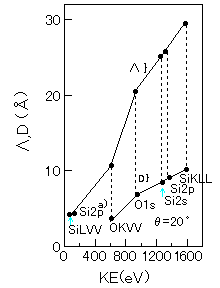
図3 Electron attenuation length Λ and electron escap depth D of photoelectrons and Auger electrons ejected from silica. The Al Kα-induced Λ values were taken from the following sources: Ref. 15(Si KLL, O KVV); Ref. 18(Si 2p, O 1s). The Λ value for Si 2s electrons emitted in SR experiments (KE〜100 eV) was evaluated to be 〜4Å by analogy with the value proposed for Si LVV electrons in Ref. 13 and 15. The D values were derived from the relationship: D = Λ sin 20゜.(原論文1より引用。 Reproduced, with permission of the copyrighter and the authors, from J. Vac. Sci. Technol., A8(3), 2231(1990), Figure 2 (Data source 1, pp.2233), Copyright (1990) by American Vacuum Society, USA.)
さらに、ドイツのGriesは、AR法の変形法として、解析する2次放射線の強度をθの関数として測定することによって深さの情報を得るという、「self-ratio」法について解説している。この方法は、2次電子を検出するAESやXPSのみならず、2次光子を検出する電子線局所分析(EPMA)、蛍光X線分析法(XFS)、荷電粒子線励起X線放出(PIXE)にも適用が可能だとしている。
コメント :
シンクロトロン軌道放射光や角度分解法を用いる分析法は、オージェ電子分光法(AES)よりも光電子分光法(PS)においてよく見られるが、今後PSと共に併用されると思われる.
原論文1 Data source 1:
Evidence of SiOx suboxides at Ar ion etched silica surfaces
E.Paparazzo, M.Fanfoni, C.Quaresima and P.Perfetti
Istituto di Struttura della Materia del CNR, Via E. Fermi 38, 00044 Frascati, Italy, Istituto di Teoria e Struttura Elettronica del CNR, Via Salaria km 29.500, CP10, 00016 Monterotondo, Italy, Dipartimento di Fisica, Universita di Roma- Tor Vergata, 00100 Roma, Italy
J. Vac. Sci. Technol., A8(3), p.2231 (1990)
原論文2 Data source 2:
Structure and Electronic Properties of Epitaxially Grown Silicides
J.Derrien, J.Chevrier, A.Younsi, V.Le Thanh, J.P.Dussaulcy and N.Cherief
Centre de Recherche sur les Mecanismes de la Croissance Cristslline, CRMC2-CNRS, Campus de Luminy, Case 913, 13288 Marseille Cedex 9, France, Laboratoire d'etudes des Proprietes Electoniques des Solides, CNRS, BP 166, 38042 Grenoble Cedex, France
Physica Scripta, Vol. T35, p.251 (1991)
原論文3 Data source 3:
The Angle-Resolved Self-Ratio Technique for Surface Depth Profile Investigations by XFS, EMA, XPS and AES
W.H.Gries
Research Institute of the Deutsche Bundespost TELEKOM, P. O. Box 10 00 03, D-W-6100 Darmstadt, Federal Republic of Germany
Mikrochimica Acta, vol. 107, p.117 (1992)
参考資料1 Reference 1:
深さ方向分析
山科 俊郎、福田 伸
北海道大学工学部原子工学科
表面分析の基礎と応用、東京大学出版会、p.171 (1991)
キーワード:オージェ電子分光、深さ分析、イオンスパッタリング、角度分解測定、
Auger electron spectroscopy (AES), depth analysis, ion sputtering, angle resolved technique
分類コード:040403, 040501, 040502
放射線利用技術データベースのメインページへ