放射線利用技術データベースのメインページへ
作成: 1997/12/15 前田 裕司
データ番号 :040100
X線回折法によるイオン照射欠陥歪みの解析
目的 :シリコン中のイオン注入における損傷の評価
放射線の種別 :重イオン
放射線源 :高エネルギ−イオン発生装置等(Bイオン:50keV,1MeV Siイオン:50keV,0.7MeV Niイオン:3MeV,4MeV)
フルエンス(率):2x1012-3x1015/cm2
利用施設名 :応用力学研究所高エネルギ−イオン発生装置等
照射条件 :室温、液体窒素温度
応用分野 :半導体工業
概要 :
半導体デバイスの開発で代表される機能材料の開発において、イオン注入による異種元素導入法は、様々なパラメータ(元素、深度、量、面積)を制御できる優れた物質処理法である。しかしながら注入と同時に表面近傍の領域に結晶欠陥及びそれに伴う巨視的歪みを生じてデバイスの劣化を誘起するため、照射効果に関する結晶学的考察が必要になる。
そこで、照射効果として生ずる格子欠陥の原子尺度での形状、及びサイズ、濃度などの定量的な評価や巨視的な歪みやその深さ分布決定が重要になる。
ここでは、イオン注入したシリコン単結晶に誘起された局所歪みを、X線回折のロッキング曲線より測定して、歪み分布や照射量依存性、非晶質状態形成過程及び回復過程を調べている。
詳細説明 :
半導体デバイス用新材料の開発において、熱拡散法による異種元素導入は限界があり、イオン注入法はそれに代わる非平衡物質処理法として期待されてきた。しかしイオン注入時に必然的に導入される照射欠陥は多くの場合、デバイスの特性劣化を引き起こす。これらの効果をなるべく低減するため、欠陥の形成過程や成長・消滅過程を定量的に評価・予測する必要がある。これらの点から、シリコン等の半導体デバイスの素材に関して、照射効果の結晶学的な非破壊評価の研究が多く実施されてきた。
これらの評価研究の中で、典型的には、イオン注入により形成された格子歪みの深さ分布及び照射欠陥の原子的尺度での構造の知見を必要としている。ここでは、X線回折によるブラッグ反射のロッキング曲線の測定により、照射により形成された歪み及びその深さ分布を評価する。一般に共有結合結晶は少量のイオン照射により、容易に非晶質化する。これらの欠陥は高温での熱焼鈍により消滅して、試料は結晶性を回復する。
シリコン単結晶は結晶の完全性が高いので、X線回折過程の解釈では、動力学理論を適用する必要がある。X線解析測定は平行2結晶配置で行い、ロッキング曲線を測定する。X線の波長としてはCuKα1を用い、004反射を測定した。歪み分布の初期値としては、TRIMコードによる損傷深さ分布と格子歪が比例するものとして計算する。実験で測定したロッキング曲線から、歪み分布と歪み総量(照射領域での歪みの積分値)とを最小自乗法により最適化して求める。ブラッグ角近傍のロッキング曲線を測定すると、照射量に対応してそのプロファイルが変化する。
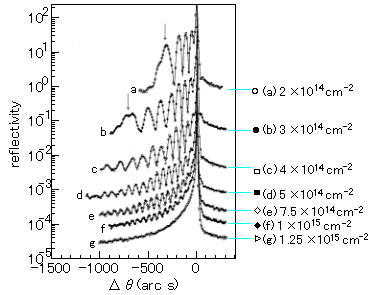
図1 Exprimental (symbols) and best-fitted (lines) RCs of silicon samples implanted with Si ions at 180 keV energy. The substrate peak are located at the Bragg angle corrected for refraction. The arrows indicate diffraction peaks from regions of maximum strain. The reflectivity scale is for the RC relative to the highest dose [curve g]. The other RCs are displaced upwards for clarity.(原論文1より引用。 Reproduced from J. Appl. Phys., 79 (1996) 8278-8284, S.Milita, M.Servidori, Figure 5 (Data source 1, pp.281), Copyright (1996) by American Institute of Physics, Woodbury, NY, USA, and with kind permission of the copyrighter and the authors.)
図1は、室温でSiイオンを注入したシリコン単結晶の構造変化をX線回折法により調べた結果である。低照射量(4 x 1014 Si/cm2以下)では、X線反射ロッキング曲線は被照射領域(完全結晶)からの鋭いピークと歪みによる強度変調を持つフリンジパターン(変調構造)と最大歪みに起因するサブピークからなる。これらのデータを解析して歪みや結晶格子変位の深さ分布を求めたものが、図2に示されている。その結果、照射により結晶格子の乱れが増すとともに、非晶質層は表面へ広がって行くことが理解される。

図2 Strain (ε⊥,full line) and static disorder (LH, dashed line) profiles in silicon implanted at 180 keV with Si doses larger than in Fig.6.(原論文1より引用。 Reproduced from J. Appl. Phys., 79 (1996) 8278-8284, S.Milita, M.Servidori, Figure 7 (Data source 1, pp.282), Copyright (1996) by American Institute of Physics, Woodbury, NY, USA, and with kind permission of the copyrighter and the author.)
例えば、1.25x1015 Si/cm2で非晶質層は表面に達するとともに、フリンジパターンは消失する。反射ピークの強度の現象はDebye因子の変化を反映しており、これを解析することにより、非晶質領域の知見、例えば照射により形成された表面からの非晶質領域の深さ分布が求められる。
低照射量領域ではカスケードの重なりが少ないが、高照射量(2x1014B/cm2, 3x1013 Si/cm2以上)ではカスケードの重なりによる欠陥の消滅を考える必要がある。更に照射量を増加させると、イオン・トラックの重なりが生ずる。550-600℃の焼鈍により、非晶質領域はほぼ完全結晶に固相条件で再成長する。
Niイオンをシリコンに130Kで照射して、低温状態で測定装置に取り付けてX線回折によるロッキング曲線を測定した場合には、また異なった結果を与える。測定は、この場合77Kで行っている。照射量が1014/cm2の少ない場合には、完全結晶からの回折によるメインピーク位置を中心にしてブロードニングが観測された。それ以上の照射量では、低角度側に新たなフリンジパターン(変調構造)を持つピークが現れる。熱処理温度を上げて行くに従い、この変調構造はメインピークへ向かって移動した。1073Kでの焼鈍により、照射効果は完全に回復する。室温以下でも回復は起こるが、顕著な回復のステージは形成しない。
コメント :
半導体デバイスの新材料の開発として、熱的拡散による異種元素のドーピングには限界があり、イオン注入手段はそれに変わる重要な方法である。しかし、イオン照射により必然的に避けられない損傷及び格子欠陥の形成等は、デバイスの特性にとっては障害物となる。
この効果をなくするには欠陥の形成過程、成長消滅等のプロセスを明確に知り、また予測する必要がある。これらの点からシリコン等半導体デバイスの素材料に関して照射損傷の研究が多くなされてきた。この研究もその一つである。構造に敏感な格子歪みに伴うロッキング曲線の測定から照射により形成された歪み、深さ分布等を測定した。しかしこの方法では試料中の歪み分布は平均の値を検出している結果となり、必要とする欠陥の構造、形状やそのサイズ等の損傷過程の原子サイズに関する情報は得られていない。原子サイズでの欠陥に関する情報が必要である。それは電子顕微鏡では観測が困難なサイズではあるが、それを観測する手段の一つとして散漫散乱法による測定方法がある。
原論文1 Data source 1:
Damage in Ion Implanted Silicon Measured by X-ra Diffraction
S.Milita and M.Servidori
CNR -Insuititute, LAMEL, Via Gobetti 101,1-40129 Bologna,Italy
J. Appl. Phys., vol.79 (1996) 8278-8284.
原論文2 Data source 2:
低温イオン注入されたシリコンのX線回折 -損傷構造とその回復挙動-
中園 英孝、田中 琴子、佃 昇*)、蔵元 英一*)
九州大学大学院総合理工学研究科、*)九州大学応用力学研究所
九州大学応用力学研究所所報, 第78号 平成7年 p.135-142.
参考資料1 Reference 1:
イオン打ち込みで生じるガーネット膜の歪みの解析 -X線回折を用いた手法-
竹内 輝明、杉田 宣(ゆたか)
日立製作所中央研究所
固体物理, vol.19 (1984) 315-323.
キーワード:イオン注入、照射損傷、シリコン、X線回折
ion implantation, irradiation damage, silicon, X-ray diffraction
分類コード:010205,040503
放射線利用技術データベースのメインページへ