放射線利用技術データベースのメインページへ
作成: 1997/11/30 川面 澄
データ番号 :040094
高エネルギーイオンビーム励起オージェ電子分光法による深さ分析
目的 :高エネルギーイオンビームを利用したオージェ電子分光の分析への応用
放射線の種別 :陽子,軽イオン
放射線源 :ヴァン・デ・グラーフ静電加速器(3.75 MV)
フルエンス(率):2-5 nA/0.2 mm2
利用施設名 :名古屋大学工学部ヴァン・デ・グラーフ静電加速器
照射条件 :真空中
応用分野 :分析化学、材料分析、
概要 :
高エネルギーイオン照射によるオージェ電子分光法を表面元素分析に応用し、カーボン薄膜の深さ分析に適用することを試みた。HやHeイオンを照射して、C、OおよびFeのオージェ電子を測定して、その深さ分布を得た。ただし、Heイオン照射の場合にはバックグラウンドの連続スペクトルが現れたので、これを取り除く方法を考える必要がある。
詳細説明 :
MeV領域のHやその他のイオンを固体に照射すると内殻電子が励起・電離され、特性X線やオージェ電子が放出される。MeV領域のイオンを照射して、固体標的からのX線放出を研究することについては多くの研究成果がある。例えば、PIXE法(粒子線励起X線放出、particle induced X-ray emission)は微量元素分析の分野では既に確立された方法であり、広く利用されている。しかし、PIXE法も万能ではない。低X線エネルギーの領域では、Si(Li)検出器の検出効率が低下するほか、低原子番号の元素では蛍光収率が極端に減少するので、PIXE分析では炭素や酸素のような軽元素を分析するのは非常に困難である。逆に、オージェ電子放出は低原子番号の元素において大きい断面積を示すので、オージェ電子分光分析を利用すると低原子番号の元素が容易に検出可能となる。しかもオージェ電子は表面層からのみ放出されるので、高エネルギーイオン照射により、オージェ電子分析による表面層の元素分析とその他のイオンビーム分析法(RBS、PIXE等)による試料全体の分析とを同時に行うことができる。
本研究では3.75MVヴァンデグラフ加速器を利用して、超高真空下において高エネルギーイオン励起オージェ電子スペクトルを測定した。図1に、この実験に用いた超高真空槽内の装置の配置を示す。
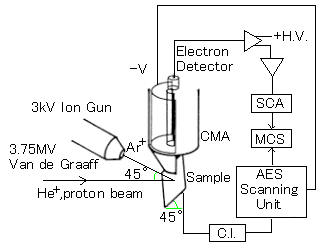
図1 Schematic view of the apparatus used in this experiment.(原論文1より引用)
このオージェ電子分光用の超高真空槽は、2段の差動排気システムにより、6x10-7 Paの真空度になっている。励起イオンとしては2.5 MeV H、または3.0 MeV Heイオンが用いられ、ビーム径は直径が0.5 mm、ビーム電流は2-5 nAである。高エネルギーイオン励起によるオージェ電子はCMA( cylindrical mirror analyzer、円筒鏡型電子分光器 )によりエネルギー分析された。この装置の仕様性能を調べるために、銀の標的を用いて、2.5 MeV Hイオンを照射して、Ag MNNオージェ電子を測定した。エネルギー分解能は0.7 %となり、実用的な分析に十分な分解能を示した。
実際の応用例として、ステンレス鋼の上の炭素薄膜のなかの元素の深さ分布の測定が試みられた。2.5 MeV Hイオン照射によるオージェ電子分光と3.0 keV Arイオンによるエッチングが交互に行われた。オージェ電子スペクトルではC KLL, O KLL, Fe LMMのピークが観測された。これらの3元素のオージェ電子ピーク強度をエッチング時間の関数として、図2に示した。

図2 Depth profile of the carbon film. The vertical scale is Auger intensities in arbitrary units.(原論文1より引用)
横軸のエッチング時間は試料の深さに対応するものである。このように、高エネルギーイオン照射により放出されるオージェ電子分析から軽元素の深さ分析ができることが示された。
Hイオン以外に、Heイオンを照射したオージェ電子分光も試みた。3.0 MeV Heイオン照射によるオージェ電子スペクトルには、幅広い連続スペクトルが現れ、S/N比が悪くなった。Heイオンを用いるには、この連続スペクトルを減少させるような工夫が必要である。
一方、比較的低エネルギー(1-200 keV)のイオンビームを利用するオージェ電子分析は数多く見られる。この場合には、低エネルギーイオンと固体との衝突過程やスパッタリング過程の研究を通して、表面の状態を研究しようとしている。参考資料1にいくつかの例が示されている。
コメント :
軽元素の分析に関して、原理的には非常に有効な方法と考えられる。しかしながら、現実的には、通常の電子励起によるオージェ電子分析法が十分な感度を示しており、高エネルギーイオンビームを利用するメリットを示す必要があり、それがまだ十分ではない。
原論文1 Data source 1:
Analyrical Application of High Energy Ion Induced Auger Electron
S.Amemiya, T.Yamada, T.Masuda, Y.Tsurita, A.Mogami*)and T.Katoh
Department of Nuclear Engineering, Nagoya University, Nagoya. *)JEOL Ltd., Akishima, Tokyo.
Proc. 11th Symposium on ISIAT 87, Tokyo (1987), p.541-544.
参考資料1 Reference 1:
Auger electron emission by ion impact on solid surfaces
S.Valeri
Dipartimento di Fisica and INFM Unita di Modena, Via Campi 213/a, 41100 Modena, Italy
Surf. Sci. Rep., 17 (1993) 85-150.
キーワード:イオン励起、オージェ電子、元素分析、深さ分析、深さ分布
ion bombardment, Auger electron, element analysis, depth analysis, depth profile
分類コード:040403, 010103, 010205
放射線利用技術データベースのメインページへ