放射線利用技術データベースのメインページへ
作成: 1997/12/19 井上 信
データ番号 :040071
イオン注入用イオン源技術
目的 :イオン注入用の実用的イオン源の開発
放射線の種別 :軽イオン,重イオン
放射線源 :イオン注入器(400keV,10mAなど)
フルエンス(率):10mA/cm2
利用施設名 :東海大学-日本真空、日新電機、日立製作所、のイオン注入装置
照射条件 :真空中
応用分野 :イオン注入、表面加工
概要 :
イオン注入は半導体製造や材料の表面加工に使われる。実用的には長時間大電流が得られる装置が望ましく、各種のイオン源が開発されている。日新電機ではよく使われるフリーマン型での実績があり、日本真空では長寿命化するためにプラズマフィラメント型を改良した。また日立製作所では最近多価重イオン源としてよく使われるECR型を1価大電流用に改良したマイクロ波イオン源を開発した。
詳細説明 :
半導体の製造や、イオンビームによる材料の表面改質にイオン注入器が使われる。通常ビームは大強度で広い面積に一様に照射される。最近はMeV級のエネルギーのイオンビームも使われるようになってきたが、多くは百keV級のイオンビームが使われる。イオン源と高電圧装置からなる装置が多い。その強度はmAないし数十mAのものが多い。
図1に、日新電機のフリーマン型のイオン源の構造を示す。

図1 Ion source for high current ion implantation machine(原論文1より引用)
ここではビームはアークチェンバーから幅2mm、高さ60mmのスリットを通して出てくる。固体からガスを蒸発させる温度は摂氏600度まで上げられる。引き出し電圧が80kVの時ホウ素の1価のイオンは5mA、ヒ素の1価のイオンは20mA引き出された。
これとは別に、4インチのウエファーに一様にイオン注入をするために出口の広いカスプフィールド型のイオン源も作っている。これは核融合研究におけるイオンビーム注入によく使われるタイプのイオン源でアークチェンバーの周りに永久磁石をおいて電子を閉じこめこれによってイオンを電離するものである。BF3のガスを使い60mAのホウ素イオンビームを得ており、またPH3のガスを使い100mAのリンのイオンビームを得ている。
フリーマン型のものも、カスプ型のものも高温のフィラメントを使うのでその寿命が問題である。実用機では長時間自動運転をするので、高温のフィラメントを使わない方式のイオン源が望ましい。名古屋大学のTP-D装置で考えられた原理を使って東海大学と日本真空ではプラズマフィラメント型のイオン源を開発した。
図2にその原理図を示す。
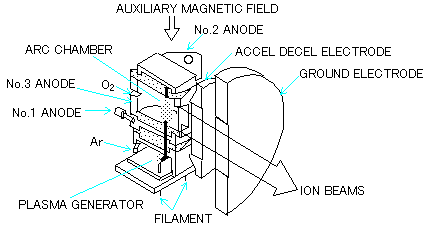
図2 Schematic diagram of a plasma filament type ion source.(原論文2より引用)
プラズマを作る部分と、アークチェンバーとに分かれていて、アークチェンバーはフリーマン型と同様の働きをするが、プラズマ発生部とアークチェンバーは小さな穴で繋がっていて全体に100G程度の磁場がかかっているので、プラズマはフィラメント状になってアークチェンバーの方に流れていってフリーマン型のフィラメントの役割を果たすというわけである。なおアノードのNo.2は電気的に絶縁されていてプラズマフィラメントの温度測定にも使われる。プラズマ発生用とイオンビーム発生用のガスをそれぞれアルゴンと酸素にしたとき、幅1mm、高さ10mmのスリットから引き出されたビーム中のアルゴンイオンは1mA/cm2、酸素イオンは3mA/cm2であった。なおともにアルゴンガスにしたときは10mA/cm2のアルゴンイオンを得ている。この結果は長寿命の酸素イオン源の可能性を示している。
一方、最近マイクロ波を使うイオン源として実用化が進んできているのが電子サイクロトロン共鳴(ECR)イオン源であるが、このタイプのイオン源はもともと多価重イオンの製造のために開発された。その場合は圧力の低い状態で使うが、日立製作所のものは、1価で大電流のイオンビームを得るのが目的なので、ガス圧もやや高く、磁場もECRの条件よりも強くして電子の密度と温度を上げている。電子密度はECRの条件での運転にくらべ一桁大きい。その結果アルゴンイオンが引き出し電圧5kVの時200mAに達している。このイオン源の構成を図3に示す。

図3 Off resonance microwave ion source.(原論文3より引用)
このマイクロ波イオン源をイオン注入用に改造して、幅2mm、高さ4mmのスリットからP+イオンを10mA、B+イオンを4mA引き出している。また金属イオン用にも改造して1mA程度のGa+イオンビームを得ている。
コメント :
実用的観点から各種のイオン源が開発されているが、それぞれの特徴がある。フィラメントのないECRないしその変形であるマイクロ波型イオン源がやや将来有望といえるかもしれない。なお、カスプフィールド型にも最近はフィラメントを使わず高周波で電子を発生するものが開発されている。
原論文1 Data source 1:
Ion source for ion implantation
K.Matsuda and M.Aoki
Nissin Electric Co., Ltd. 47, Umezu Takase-cho, Ukyo-ku Kyoto, Japan
Proc. 9th Symp. on ISIAT'85, p.9-21 (1985)
原論文2 Data source 2:
Plasma filament type ion source
E.Yabe, A.Tonegawa, D.Satoh, N.Ishizaka, K.Takayama, R.Fukui, K.Takagi, K.Okamoto and S.Komiya
Research & Development Institute, Dept. of Physics, Tokay Univ. and R & D Div. ULVAC Corp., 2500 Hagisono, Chigasaki, Kanagawa
Proc. 9th Symp. on ISIAT'85, p.51-54 (1985)
原論文3 Data source 3:
Microwave Ion Source
N.Sakudo
Central Research Laboratory, Hitachi Ltd., Kokubunji, Tokyo 185
Proc. 9th Symp. on ISIAT'85, p.1-8 (1985)
キーワード:イオン注入、プラズマフィラメント型イオン源、フリーマン型イオン源、マイクロ波型イオン源、ion-implantation, plasma filament ion source, Freeman ion source, microwave ion source
分類コード:040101,010205,040106
放射線利用技術データベースのメインページへ