放射線利用技術データベースのメインページへ
作成: 1996/11/26 山本 春也
データ番号 :040046
低・中速イオン後方散乱を用いた表面・界面の結晶構造解析
目的 :イオンビ-ムを用いた固体表面・界面の構造解析
放射線の種別 :軽イオン,重イオン
放射線源 :イオン加速器(400keV)
フルエンス(率):170nA/cm2 He+
利用施設名 :大阪電気通信大学、早稲田大学理工学研究所
照射条件 :超高真空(10-11Torr)
応用分野 :半導体工業、触媒
概要 :
keV領域のイオンビ-ムを用いたイオン散乱分光法では、表面から数原子層に対して高い深さ分解能で高感度に組成が調べることができる。また、チャネリング効果を用いることにより表面・界面の原子位置を高精度で決定が可能である。この手法は、薄膜の成長過程のその場観察、吸着による表面緩和、再配列構造、表面における触媒反応等の研究に用いられている。
詳細説明 :
イオン散乱法では、解析イオンビ-ムのエネルギ-領域により、(1)数keV領域:低速イオン散乱分光法(Ion Scattering Spectroscopy:ISS)、(2)数100keV領域:中速イオン散乱分光法(Medium Energy Ion Scattering Spectroscopy: MEIS)、(3)MeV領域:高速イオン散乱分光法(High Energy Ion Scattering Spectroscopy: HEIS)に分類される。いずれの場合も散乱されたイオン、中性粒子のエネルギ-分析により表面層の情報が得られる。散乱イオンの運動は古典力学を用いて解析ができ、実空間の固体表面の直接的な情報が得られる。
ISSの実験では、解析ビ-ムとしてH+、He+、Ne+、Ar+等の不活性ガスイオンを入射し、散乱イオンを静電型アナライザ-、飛行時間(TOF)型アナライザ-等を用いてエネルギ-分析を行う。解析ビ-ムが数keVの場合、表面で散乱する際の中性化確率が高いため、イオン、中性粒子が同時に測定可能なTOF型アナライザ-が有効である。特に散乱角180°で直衝突して散乱してくる粒子のみを測定する手法を同軸型直衝突イオン散乱分光法(CAICISS)とよび、より詳細な表面の原子配列の解析が可能である。MEISの実験では位置敏感型検出器を使ったトロイダル静電型アナライザ-を用いた測定系が開発されている。この手法では広範囲な散乱角分布を同時に測定するため、より少ないビ-ム量で実験が行える。単結晶試料のとき、入射イオン方向を低次の晶帯軸方向より入射させると(チャネリング入射)、第1層原子により生じるシャド-コ-ンのため第2原子以下が隠されてしまい(ブロッキング効果)、後方散乱収率はランダム方向の入射に比べて著しく減少する。チャネリング方位及びランダム方位での後方散乱収率の比及び入射イオン量で規格化した収量の角度変化を測定することにより、表面の原子配列の情報が得られる。
実験装置は、イオン加速器またはイオン銃、分析マグネット、パルス化のためのチョッピング偏向器、エネルギ-減速管、スリット系、試料用ゴニオメ-タ-、エネルギ-分析器を含んだ超高真空分析チェンバ-から構成される。さらに薄膜成長過程を調べるために、成膜のための蒸発源、表面洗浄のためのスパッタ-イオン銃、試料の加熱および冷却機構、オ-ジェ電子分光、反射高速電子線回折(RHEED)などの分析系が加えられる。
ISSを用いた応用として主に半導体工学に関する分野で研究が進んでいる。単結晶Si基板上のCaF2, Ag, Au, Cuなどの成長過程が研究されている。吸着による表面構造の変化に関する研究では、Si上のAgが水素吸着によりエピタキシャルクラスタ-を形成することがCAICISSにより見出されている。また、表面溶解過程に関する研究では、Pb(110)表面付近が融点よりかなり低い温度で結晶が乱れはじめ、表面より溶解が進むことが実験的に示された。図1はPb(110)にチャネリング条件でHイオンを入射したときの後方散乱エネルギ-スペクトルの試料温度よる変化を示している。Pbの融点(600.7K)以下の温度で表面付近の結晶が乱れてきていることがわかる。
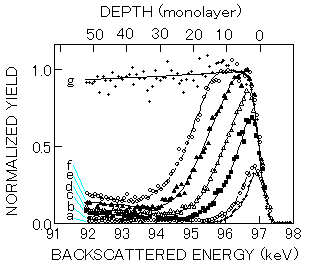
図1 Change of scattered ion energy spectra of Pb (110) for various sample temperatures.
a: 295 K, b: 452 K, c: 581 K, d: 597 K, e: 599.7 K, f: 600.5 K, g: 600.8 K, Melting temperature: 600.7 K(原論文2より引用)
ISS、MEIS法は、高感度に単原子層の構造解析が可能であるため、触媒反応機構、腐食機構、吸着・脱離過程に関する研究が可能となる。しかし精度の高い定量的な分析を行うために中性化の確率、散乱断面積に関する情報が必要とされている。さらに散乱した中性粒子にはその中性化過程における固体表面の電子状態の情報が含まれているため、表面の化学結合状態を調べる実験手法としての利用が期待されている。
コメント :
低速イオン散乱分光法は、イオンと表面原子との2体衝突近似で解析ができるため、直接的な固体表面・界面の構造解析が可能となる。本分析法は半導体表面、表面における触媒反応機構、吸着、拡散などの基礎研究に成果が期待されている。
原論文1 Data source 1:
Quantitative Surface Atomic Analysis by Low-Energy Ion Scattering Spectroscopy (ISS)
M.Aono and R.Souda
National Institute for Research in Inorganic Materials, 1-1 Namiki, Sakura, Niiharai, Ibaraki 305
Jpn. J. Appl. Phys. vol.24, 1249 (1985).
原論文2 Data source 2:
中速イオン散乱法を用いた表面・界面解析
越川 孝範
大阪電気通信大学応用電子工学科・エレクトロニクス基礎センタ-、寝屋川市初町18-8
表面科学, 第10巻, 第7号, (1989).
原論文3 Data source 3:
イオン後方散乱法による表面結晶構造の解析
市ノ川 竹男
早稲田大学理工学部応用物理学科
早稲田大学理工学研究所報告, 第98 (1982) p.105.
キーワード:低速イオン散乱分光、表面・界面、チャネリング効果、ブロッキング効果
Low energy ion scattering spectroscopy, Surface/Interface, Channeling effect, Blocking effect
分類コード:040501, 040502
放射線利用技術データベースのメインページへ