放射線利用技術データベースのメインページへ
作成: 1996/11/20 井上 信
データ番号 :040021
大強度イオン注入器の開発
目的 :半導体工業用の大強度イオン注入器の技術
放射線の種別 :軽イオン
放射線源 :高電圧直流加速器(80kV-4MV,10mA)
フルエンス(率):1016ions/cm2
利用施設名 :イートン、日新電機、日立製作所、NECのイオン注入器
照射条件 :真空中
応用分野 :半導体工業、表面処理
概要 :
半導体工業や表面処理にイオン注入法が利用される。このために各種のイオン加速器が開発されている。イオンのエネルギーは100keVから最近は数MeVにまでなっており、直流高電圧発生装置や静電加速器等が用いられる。イートン社、日新電機、日立製作所などでは特に半導体工業用にイオン注入器を開発してきた。ここでは1980年代の中ごろまでの状況の紹介をする。
詳細説明 :
エレクトロニクス用の半導体は純粋なシリコンにわずかな不純物としてホウ素や燐などを入れる。かつては、このような元素を含む高圧のガス中にシリコンを置き、表面から染み込ませる方法を取った。しかしこれらの元素をイオンにして加速し表面に注入すれば注入量を制御しやすいので最近はイオン注入器として加速器とビームの注入部の機構をセットにしたものが製作販売されている。なおこの抄録では1980年代半ばまでのものが主であるのでエネルギーとしては、100keV程度のものが主として紹介されている。最近はエネルギーを上げると、イオンが半導体のより深いところまで注入され、プロセスが従来よりさらに改善されることが注目されている。そこで、高いエネルギーの加速器として静電加速器についても触れる。さらにこの抄録では省いたが、最近では高いエネルギー用に高周波加速による線形加速器も利用されている。この抄録では従来のエネルギーでイオンビームの強度を大きくする開発と従来の強度でエネルギーを高くすることについて紹介する。
イートン/ノバのモデルNV10-160というイオン注入器が開発された。これはこれは図1のようになっている。

図1 Machine schematic of NV-10-160(原論文1より引用。 Reproduced from Nucl. Instr. Meth. Phys. Res., B6,27-34(1985), P. H. Rose, R. Faretra, G. Ryding: A high-energy, high-current ion implantation system, Figure 1 (Data source 1, pp.29), Copyright (1985), with permission from Elsevier Science NL, Amsterdam, The Netherlands.)
イオンを発生し分析する部分は100kVの高電圧ターミナルに乗っており、このターミナルの上でイオン源からビームが80kVの電源で引き出される。したがってイオンのエネルギーは180keV近くまでになる。製品としては160keVを仕様としている。ホウ素、燐、砒素等のイオンの電流は数mAから10mAである。一方、半導体のウエハーは自動化した制御システムに取り付けられ自動的に照射注入できるようになっている。図2にこのハンドラーの様子を示す。
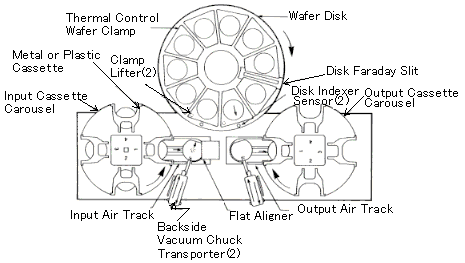
図2 Schematic of the automatic wafer handler(原論文1より引用。 Reproduced from Nucl. Instr.Meth. Phys. Res., B6,27-34 (1985),P. H. Rose, R. Faretra, G. Ryding: A high-energy,high-current ion implantation system, Figure 9 (Data source 1, pp.33), Copyright(1985), with permission from Elsevier Science NL, Amsterdam, The Netherlands.)
これにより1x1016ions/cm2 の照射量のウエハーを1時間に300枚生産できる。
日新電機が開発したPR200もほぼ同様な構成になっている。これは200keVに加速できるもので、イオンの電流は燐で10mA、砒素で7mA、ホウ素で4.5mAである。このイオン源としてはPIG型のものを使っている。また大電流のイオンビームがウエハーに当たって発熱するのでこれを冷却するためにフレオンを使っている。このようにして1x1016ions/cm2 で1kWの発熱にたいして120度以下の温度にしている。日立製作所でも同様なイオン注入器を製作している。ここでは大電流を得るためにイオン源として、2.45GHzのマグネトロンによるマイクロウエーブを利用している。これにより、イオンのもとになるガスの消費量が少なく長寿命のイオン源となっている。
一方、ビームをウエハーに一様に当てるにはビームをスキャンする方法とウエハーを機械的に動かす方法がある。日本真空のIPX-7000では静電デフレクターで上下左右にビームを振る方法を取っており、その様子を図3に示す。
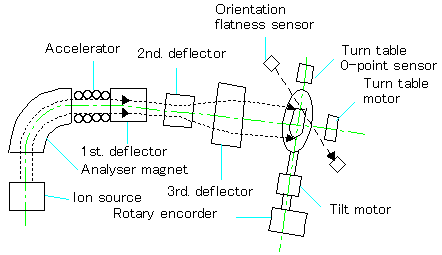
図3 Parallel electrostatic/mechanical hybrid scanning(from ref.6)(原論文4より引用。 Reproduced from Vacuum, 39(11/12), 1025-1029 (1989), D. Aitken: The development of ion implanter technology, Figure 1 (Data source 4, pp.1026), Copyright(1989), with permission from Elsevier Science, Oxford, England.)
この他に、静電デフレクターと磁石を組み合わせたものもある。磁石は非常に早くは磁場を変化させられないのでスキャンは遅くなる。機械的にウエハーを動かす方法も各種ある。回転、並進、回転と並進の組み合わせ等である。
最初に述べたように、最近、MeV領域のエネルギーがイオン注入にとって注目されている。これまでのものは注入とはいえ、ほとんど表面に付着する程度の注入であるが、MeV領域になると半導体表面から数ミクロン程度イオンが侵入する。このため深いところにイオンを埋め込むことができるが、さらにイオンビームはその停止点の近傍で周囲にダメージを与えるので、ウエハーの欠陥層は表面付近には形成されない。したがってアニーリングが楽になる。このようなことに注目してNational Electrostatics Corp. (NEC) では1983年に同社の静電加速器ペレトロンをエンドステーションと組み合わせてMeVイオン注入器を製作した。
コメント :
その後、イートン/ノバと住友重機械との合弁会社で線形加速器によるMeVイオン注入器が製作販売されている。また日新電機などでは高周波四重極(RFQ)型線形加速器でMeVイオン注入器を開発した。これら高周波を使うものは静電型と異なりMV級の高電圧を発生しないのでX線の発生が少ないという利点がある。一方静電型はエネルギー可変が容易である。
原論文1 Data source 1:
A high-energy, high-current ion implantation system
Peter H. Rose, Ronald Faretra and Geoffery Ryding
Eaton Corporation, Semiconductor Equipment Operations, Ion Beam Systems Division, Beverly, Massachusetts 01915, USA
Nuclear Instruments and Methods in Physics Research, B6, p.27-34 (1985)
原論文2 Data source 2:
A high current ion implantater machine
K. Matsuda, T. Kawai, M. Naitoh and M. Aoki
Nissin Electric Co., Ltd., 47 Umezu-cho, Ukyo-ku, Kyoto, Japan
Nuclear Instruments and Methods in Physics Research, B6, p.35-38 (1985)
原論文3 Data source 3:
High-current ion implanter using a microwave ion source
Noriyuki Sakudo, KatsumiTokiguchi, Hidemi Koike, and Ichiro Kanomata
Central Research Laboratory, Hitachi Ltd., Kokubunji, Tokyo 185, Japan
Rev. Sci. Instrum., 54 (6), p.681-684 (1983)
原論文4 Data source 4:
The development of ion implanter technology
D Aitken
Superion, 10 St Leonard's Road, Surbiton, Surrey KT6 4DE, UK
Vacuum, 39 (11/12) p.1025-1029 (1989)
原論文5 Data source 5:
National Electrostatics Corp. のペレトロン
斉藤 嗣夫
伯東株式会社応用科学事業部
Pros. 11th Symp. on ISIAT87. Tokyo, p.733-740 (1987)
キーワード:イオン注入、半導体、加速器
ion implantation, semiconductor, accelerator
分類コード:040101,010205
放射線利用技術データベースのメインページへ