放射線利用技術データベースのメインページへ
作成: 2000/03/31 高井 幹夫
データ番号 :018015
リソグラフィー技術
目的 :実用化例と将来の実用化の可能性としての紹介
半導体集積回路の微細パタン転写技術
放射線の種別 :エックス線,電子,陽子,軽イオン
利用原理 :フォトレジスト(光感光剤)への放射線照射によるレジスト内原子結合切断による露光と溶媒による現像を用いたパターン転写複刻
概要 :
半導体集積回路の超微細回路パターンの次世代転写複刻技術としての放射線応用技術を、電子ビーム、イオンビームおよびX線を用いた方法について要約
詳細説明 :
半導体集積回路の素子回路パターンの転写には、シリコン基板上に塗布されたフォトレジストにフォトマスクのパターンを光により縮小投影し、転写複刻するリソグラフィー技術が用いられている。素子の最小加工線幅・デザインルールと、これに対応するリソグラフィー技術は、180nm(KrFエキシマーレーザー)、130nm(ArFエキシマーレーザー)、100nm(未定)、70nm、50nm、35nmと回路素子の超高集積化・高密度化に伴い、その最小加工線幅が利用する光源の波長と同等か、それ以下になり、これまでの光を用いた技術に代わって、電子ビーム、イオンビームおよびX線等の放射線を用いる技術が次世代技術として必要とされている。現行の180nmデザインルールから、130nmまでは、KrF(248nm)やArFエキシマーレーザー光源(193nm)が利用されるが、100nm以下のデザインルールでは、VUV(真空紫外線)やEUV(極紫外線)光源を用いるか、放射線による露光法を導入する必要がある。VUVやEUVの光源は、実用化のめどが立っていないため、放射線による露光法が注目されている。
特徴
等倍X線リソグラフィー技術は、焦点震度が大きく、解像度に優れているが、等倍の高アスペクト比マスク作製が難しく、放射光やプラズマX線発生装置等のX線源コストが大きいことが問題点である。
電子ビーム直接描画リソグラフィー技術は、高い解像度・重ね合わせ精度でマスクが不要であるが、スループットが低く、ビームの近接効果補正を必要とする。この方式は、フォトマスクの製造にこれまで用いられている。
SCALPEL(Scattering with Angular Limitation in Projection Electron-Beam Lithography) 露光方式(図1)は、電子ビームをソースとした縮小転写方式で、マスクの散乱体で散乱電子ビームと非散乱電子ビームを発生させ、SCALPELアパチャアフィルターにより露光コントラストを向上させる方式で、4倍の縮小率を得る。このSCALPELシステムは、100keVの電子ビーム照射システムとマスクを挟んで透過電子ビームのシリコンウェーハ上への投影システムからなる。電子源には、LaB6カソードを用い、ソースサイズは60ミクロンで、260 A/cm2srの輝度のとき、ブランキングアパチャ上でクロスオーバー点を持たせ、マスク上で1x1mm2のビームサイズとなっている。投影システムは、0.25倍の倍率でウェーハー上にステップアンドスキャン方式で縮小投影する。この時、散乱角を制限するアパチャを用いて露光コントラストを向上させるのが特徴となっている。マスクとしては、シリコンの窒化膜メンブラン上にCr/Wをパタン化したものを用いている。このシステムで、80nmの分解能と75umの焦点深度を達成している。この方式では、大電流電子密度と処理能力のトレードオフや、アラインメントやつなぎ精度などのマスク上の課題がある。

図1 SCALPELリソグラフィ検証システムの電子軌道ダイアグラム. (参考資料1より引用。 Reproduced with permission from J. Vac. Technol. B14, 3825-3828 (1996), Fig.2(p.3826), L.R. Harriott et al., Preliminary results from a prototype projection electron-beam stepper-scattering with angular limitation projection electron beam lithography roof-of-concept system.)
イオンプロジェクションリソグラフィー技術(図2)は、イオンをソースとして、ステンシルマスクとイオン光学系により4倍の縮小転写が可能となっている。イオンソースには、エネルギー幅が1eV以下のマルチカスプイオン源を用い、水素またはヘリウムガスをイオン化、300keVまでの加速エネルギーを用いる。ヘリウムイオンを用いた場合には、露光フィールドが15x15mm2から22x22mm2でイオンビーム電流密度1.2uA/cm2の時、100nmの分解能と3umの焦点深度を得ることが出来る。問題点としては、ステンシルマスクの発熱の影響があることである。
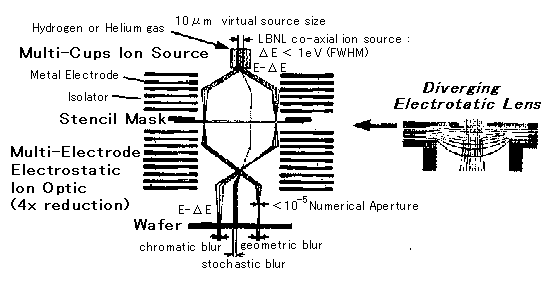
図2 マルチ電極イオン投影リソグラフィシステムの概念図. (参考資料2より引用。 Reproduced with permission from J. Vac. Sci. Technol. B16, 3150-3153 (1998), Fig.2(p.3151), G. Gross, R. Kaesmaier, H. Loeschner, and G. Stengl, Ion projection lithography: Status of the MEDEA project and United States/European cooperation.)
用途
デザインルール100nm以下の半導体超微細回路パターン転写
参考資料1 Reference 1:
Preliminary results from a prototype projection electron-beam stepper-scattering with angular limitation projection electron beam lithography roof-of-concept system
L.R. Harriott et al.
Lucent Technologies
J. Vac. Technol. B14, 3825 (1996)
参考資料2 Reference 2:
Ion projection lithography:Status of the MEDEA project and United States/European cooperation
G. Gross, R. Kaesmaier, H. Loeschner, and G. Stengl
Siemens AG and IMS
J. Vac. Sci. Technol. B16, 3150 (1998)
キーワード:リソグラフィ,lithography,フォトレジスト,photo resist,半導体集積回路,IC,デザインルール,design rule,回路パターン,circuit pattern,X線リソグラフィー,X-ray lithography,電子ビームリソグラフィー,electron beam lithography,スカルペル,SCALPEL,イオン投影リソグラフィー,ion projection lithography
分類コード:010305,010205,010304
放射線利用技術データベースのメインページへ