放射線利用技術データベースのメインページへ
作成: 2000/03/31 高井 幹夫
データ番号 :018014
半導体へのイオン注入
目的 :実用化例としての紹介
半導体への不純物添加による素子構造作成
放射線の種別 :軽イオン,重イオン,陽子
放射線源 :イオン注入装置
フルエンス(率):1011/cm2 - 1017/cm2
照射条件 :真空中、室温、摂氏750度
利用原理 :イオン注入(イオンと個体との相互作用)と注入不純物原子の熱拡散と活性化
概要 :
半導体への不純物原子のイオン注入による添加法と、これによる伝導型制御からp-n接合、CMOS・FET形成、およびメモリー素子やマイクロプロセッサー素子への製造プロセスへの応用
詳細説明 :
シリコンを中心とした半導体に数10keVから数100keVのエネルギーで周期律表のIII族およびV族の元素をイオン注入し、摂氏800度以上の熱処理により注入不純物を活性化させることにより、pおよびn型の不純物原子分布・導電性を制御する。不純物原子の深さ分布は、注入イオンの質量、注入エネルギー、および熱処理温度により決まる。素子構造を作るためには、レジストなどの注入マスクを用いて、面内分布を設計する。この技術により、pn接合、npnおよびpnpバイポーラトランジスタ、nチャネルおよびpチャネルMOS型電界効果トランジスタ(MOS-FET)、さらには、これらの素子を集積化したLSI(大規模集積回路)であるメモリーICやロジックICを製造する。
図1に、CMOS構造の集積回路製造の要素技術を示す。要素イオン注入技術としては、トランジスタの基本構造であるソース・ドレイン形成(A,F)、サブミクロンゲート長でのホットキャリア抑制のためのソース・ドレイン拡張部(LDD)注入(C,K,L,H)、動作点を決定するチャネル注入(B,G)、分離層のチャネルストップ注入(E,J)、特性改善のためのゲートポリシリコンへの注入(M)、同一基板内にnおよびpチャネルFET構造を分離作製するためのウェルまたはタブ注入(D,I)がある。さらに、最近では、高エネルギーイオン注入によるイオンの深い分布を利用したレトログレードウェルが、メモリー素子の放射線耐性であるソフトエラー耐性の向上のために利用されたり、ホットキャリアによる寄生バイポーラ特性であるラッチアップに対する耐性の向上のために用いられている。
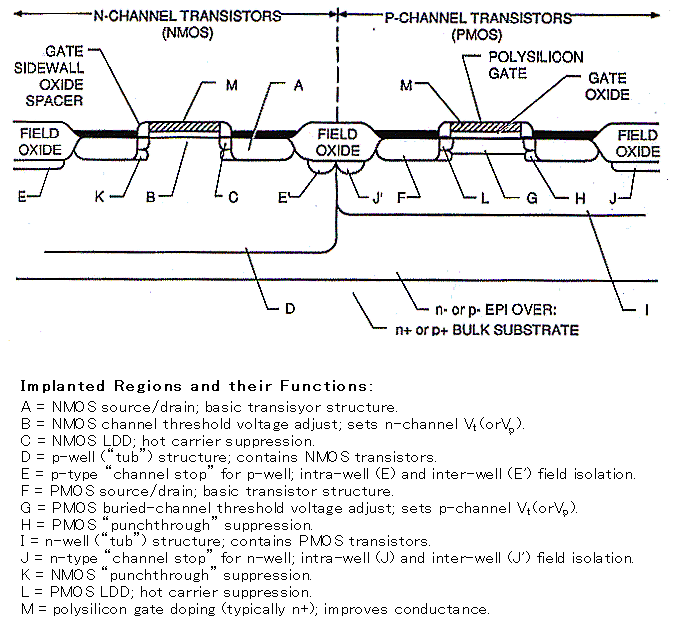
図1 イオン注入技術の標準CMOSプロセスへの応用. (Reproduced from R. Simonton and F. Sinclair, Handbook of Ion Implantation Technology, ed. J.F. Ziegler, (North Holland, Amsterdam, 1992), p. 277, Ion Implatation Applications in CMOS Process Technology, Copyright(1992), with permission from Esevier Science.)(参考資料1より引用)
図2に、集積回路素子製造に用いられる要素技術のイオン注入エネルギーとドーズ量の関係を示す。ソースドレイン形成や動作特性を決めるスレシュホールド電圧制御(Vth)には、200keV程度までの中エネルギーイオン注入装置が用いられ、比較的新しい応用である埋め込みコレクタ注入やゲッタリングおよびレトログレードウェル注入には、MeV域までの高エネルギーイオン注入装置が利用される。
大電流イオン注入装置は、200keVの中エネルギーまでの装置が、プロセスの高速化のために利用される。新しい応用としては、バルクシリコン基板へ酸素イオンを高温度(摂氏750度以上)で高濃度(>1018/cm2)注入し、注入後の熱処理により埋め込み酸化層を形成するSIMOX技術で、SOI(絶縁膜上単結晶シリコン)構造の基板を形成できる。この構造により、素子の浮遊容量を低減し、高速・低消費電力でソフトエラー耐性の向上した素子が製造できる。
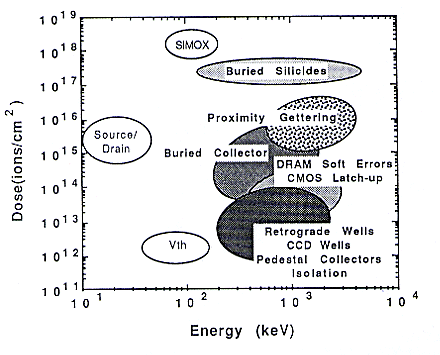
図2 CMOSおよびBi-CMOS集積回路素子への高エネルギーイオン注入の応用(要素技術のイオンエネルギーとドーズ量の関係). (Reproduced from M. I. Current, I. Yamada, N. W. Cheung, P. L.F. Hemment and K. J. Reeson, Handbook of Ion Implantation Technology, ed. J.F. Ziegler, (North Holland, Amsterdam, 1992),p.385, New Technologies for Ion Implantation, Copyright(1992), with permission from Esevier Science.)(参考資料2より引用)
III族およびV族の元素によるイオン注入以外に、プロトンの高エネルギー注入によるパワーデバイスの少数キャリアの寿命制御や、薄膜SOI基板製造プロセスとして、酸化基板を張り合わせ、あらかじめ水素イオン高濃度注入した部分の熱処理による剥離を利用して製造する技術(スマートカット技術)も実用化されている。
現在では、集積回路素子のデザインルールの縮小化による超高密度化・超高速化に伴い、MOSデバイスのゲート長が100nm以下となろうとしている。これを実現するイオン注入技術として、ソースドレインの極浅接合を可能とする注入不純物の極浅分布が必要とされている。このため、低エネルギーイオン注入としてのプラズマドーピングや、減速電界による低エネルギーイオン注入が研究開発されている。
処理効果の特徴 :
デザインルールが100nmまでの微細加工プロセス。低温短時間プロセス。非熱平衡プロセス。
用途(応用分野) :
半導体素子全般、大規模集積回路、MOSデバイス、メモリー、マイクロプロセッサー、CCD(電荷結合型受光素子)
展開の可能性 :
ディジタルTV用集積回路や携帯電話用集積回路などのSOC(システムオンチップ:組み込みマイクロプロセッサーと特定機能集積回路)
実施している企業:
NEC、日立、東芝、三菱、富士通をはじめとする国内11社、インテル、モトローラ、AMD、テキサス等の米国社、インフィニオン、フィリップス等のヨーロッパ社、Samsung、Hyundai等の韓国4社とTMSC等の台湾数社。
参考資料1 Reference 1:
Ion Implantation Applications in CMOS Process Technology
Robert Simonton and Frank Sinclair
Eaton Corporation, Semiconductor Equipment Division, 2433 Rutland Drive, Austin, TX 78758, USA
Handbook of Ion Implantation Technology, ed. J.F. Ziegler, (North Holland, Amsterdam, 1992)
参考資料2 Reference 2:
New Technologies for Ion Implantation
Michael I. Current, Isao Yamada, Nathan W. Cheung, Peter L.F. Hemment and Karen J. Reeson
Applied Materials, 3050 Bowers Avenue, Santa Clara, CA 95054, USA
Handbook of Ion Implantation Technology, ed. J.F. Ziegler, (North Holland, Amsterdam, 1992)
キーワード:注入不純物, implanted impurity, 熱拡散, thermal diffusion, 活性化, activation, 半導体, semiconductor, CMOS, CMOS, メモリー, memory, マイクロプロセッサー, microprocessor, 集積回路, integrated circuit, チャネル注入, channel implant, ソースドレイン注入, source drain implnat, 中エネルギー注入, medium energy implant, レトログレードウェル, retrograde well, ソフトエラー, soft error, 耐放射線, radiation hardness,高エネルギー注入, high energy implnat, 絶縁膜上単結晶シリコン, SOI, サイモックス, SIMOX, スマートカット,smart cut, 少数キャリアの寿命, minority carrier lifetime, 極浅接合, shallow junction, 低エネルギーイオン注入, low energy implant, プラズマドーピング, plasma doping
分類コード:010205,010305
放射線利用技術データベースのメインページへ