放射線利用技術データベースのメインページへ
作成: 2011/2/25 古澤 孝弘
データ番号 :010315
パルスラジオリシスを用いたEUVレジスト反応機構の解明
目的 :微細加工材料の放射線誘起反応機構の解明
放射線の種別 :極端紫外光EUV(軟エックス線),電子
放射線源 :電子加速器(28MeV,300A)
フルエンス(率):3-5×1022/(cm2・s)
線量(率) :30-50Gy
利用施設名 :大阪大学産業科学研究所Lバンドライナック
照射条件 :アルゴンバブリングによる脱気、真空脱気
応用分野 :半導体製造
概要 :
パルスラジオリシス法により化学増幅型極端紫外光(EUV)レジスト中での酸発生機構を解明した。EUV照射時、酸のカウンターアニオンはレジスト中に生成する熱化電子と酸発生剤の電子付着解離によって生成し、酸のプロトンはレジスト高分子のラジカルカチオンの脱プロトン反応により生成する。本研究は、次世代レジスト開発の学術的基礎を与えるものである。
詳細説明 :
現在の半導体産業はリソグラフィと呼ばれる超微細加工技術に支えられている。現在の50nm近傍の大量生産は光(ArFエキシマレーザー、波長193nm)を露光源として加工が行われているが、近い将来、光による加工は限界に達することが予想され、代わって波長13.5nmの極端紫外光(EUV)や電子ビームといった電離放射線領域にある量子ビームが次期露光源として期待されている。特に、EUVを用いた超微細加工は半導体製造用の次世代リソグラフィの最有力候補として期待され(参考資料1)、実現されれば、半導体大量生産の主プロセスに電離放射線が初めて用いられ、量子ビームの産業利用は大きな新展開を迎えることとなる。電離放射線領域にある量子ビームは波長が短い分、光よりも微細な領域にエネルギーを付与し、化学反応を起こさせることが可能であるが、露光源のエネルギーが一般的な材料のイオン化エネルギーを超えるため、材料設計上は、感光分子の励起状態を利用した像形成から、材料マトリクスのイオン化を利用した像形成への転換を意味し、抜本的な材料設計の変更が必要となる。しかし、EUVリソグラフィ開発が本格化した当初、このような変革に産業界が対応するための学術基盤の整備は不十分なままであった。
このような背景の下、EUVリソグラフィに用いられる化学増幅型レジストの反応機構解明をパルスラジオリシス法を用い行った。化学増幅型レジストは照射により生成する酸による触媒反応を利用することにより高感度化を達成している(参考資料2)。従来の光リソグラフィで用いられる紫外光領域では酸発生剤は主に入射光による直接励起で分解し、酸のプロトンは主に酸発生剤から生成する。一方、電離放射線領域では、酸発生剤は主に熱化電子との解離性電子付着で分解し、酸のアニオンを生成するのみである。レジストフィルム中での熱化電子と酸発生剤の反応は、溶媒和電子と酸発生剤の反応に関する研究を基に推定されたが(参考資料3)、酸発生剤と溶媒和電子の速度乗数とレジストフィルムでの酸発生効率は完全には対応しないことが指摘されていた(参考資料4)。図1にTHF溶液中における酸発生剤のC37(電子捕捉剤添加時に溶媒和電子の初期収量が1/eになる捕捉剤濃度で規定される定数で、溶媒和前電子と捕捉剤の反応性を表す指標)とPHSフィルム中での電子線による酸発生効率の関係を示す(図1、原論文1)。酸発生効率とC37が相関することがわかる。THF中ではC37が熱化電子の反応を反映し、かつ、酸発生剤と熱化電子の反応のような速い反応は分子運動の影響を受けにくいため、溶液中での測定値であっても固体中でおこる現象とうまく対応することを示している。
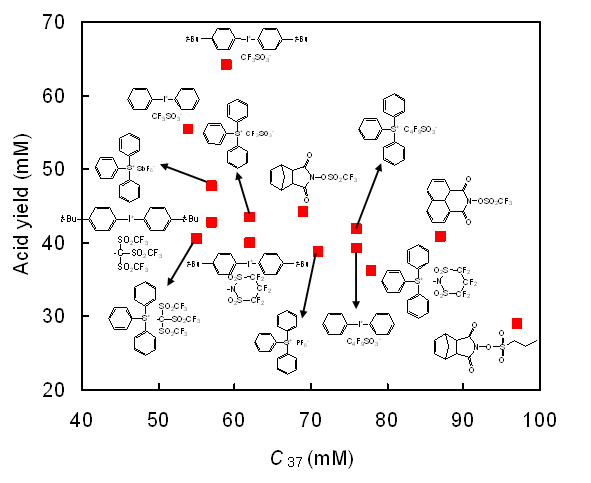
図1 THF溶液中でのC37と電子線照射によるPHSフィルム中での酸収量の関係
酸のカウンターアニオンは電子と酸発生剤の反応で生成するが、酸が生成するためには、アニオンだけではなくプロトンが必要である。紫外光による露光で、酸発生剤が励起状態から分解する場合は、酸発生剤の分解過程でプロトンが発生する(一部は高分子に由来する)が、電離放射線領域では高分子にプロトン発生機構を付加する必要がある。図2にベンゾニトリル中で測定されたpoly(4-hydroxystyrene) (PHS)の過渡吸収スペクトルを示す(図2、原論文2)。400nm近傍の吸収がフェノキシラジカルによる吸収で、430nm近傍の速い減衰がPHSラジカルカチオンの吸収である。PHSラジカルカチオンの脱プロトン反応によりフェノキシラジカルが生成する。図2は溶液中で行われた実験であり、脱プロトン反応のようなイオン分子反応は溶液系と固体系で大きく違うのではないかという疑いがあるが、実際はPHSで薄膜を作製した場合、その大部分のフェノール性水酸基は近くにある水酸基と分子間あるいは分子内水素結合を形成することが知られており、PHSラジカルカチオンは固体状態においても容易に脱プロトン化されると考えられる。パルスラジオリス法により解明された反応機構に基づいたシミュレーションによる酸生成量の計算値と実際のEUV照射による量子収率はよく一致することが示されている(図3、原論文3)。
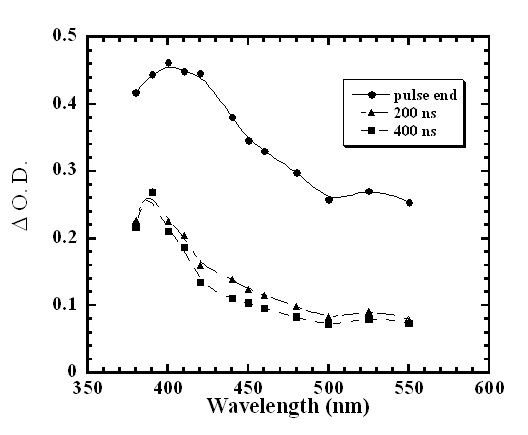
図2 100mM PHS-ベンゾニトリル溶液の過渡吸収スペクトル
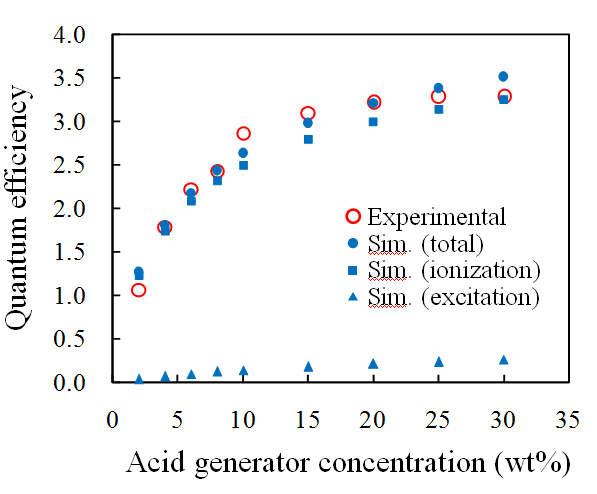
図3 EUV照射時の酸の量子収率と酸発生剤濃度の関係
コメント :
半導体製造業界ではこれまで材料のイオン化エネルギー以下の光を使って、デバイス製造を行っていたが、次世代リソグラフィであるEUVリソグラフィでは、半導体製造の主プロセスの露光源が初めて電離放射線領域に入るため、材料及びプロセス開発者に電離放射線と物質の相互作用に関する知識が強く求められている。
原論文1 Data source 1:
Study of the Reaction of Acid Generators with Epithermal and Thermalized Electrons
K.Natsuda,T.Kozawa,A.Saeki,S.Tagawa,T.Kai and T.Shimokawa
Osaka University,JSR Corp.
Jpn.J.Appl.Phys.47:4932-4935(2008)
原論文2 Data source 2:
Acid Generation Mechanism of Poly(4-hydroxystyrene)-Based Chemically Amplified Resists for Post-Optical Lithography:Acid Yield and Deprotonation Behavior of Poly(4-hydroxystyrene)and Poly(4-methoxystyrene)
A.Nakano,T.Kozawa,K.Okamoto,S.Tagawa,T.Kai and T.Shimokawa
Osaka University,JSR Corp.
Jpn.J.Appl.Phys.45:6866-6871(2006)
原論文3 Data source 3:
Thermalization Distance of Electrons Generated in Poly(4-hydroxystyrene) Film Containing Acid Generator upon Exposure to Extreme Ultraviolet Radiation,
T.Kozawa and S.Tagawa
Osaka University,JSR Corp.
Jpn.J.Appl.Phys.50:in press(2011)
参考資料1 Reference 1:
Extreme Ultraviolet Lithography Development in the United States
S.Wurm
Sematech
Jpn.J.Appl.Phys.46:6105-6112(2007)
参考資料2 Reference 2:
Chemical amplification resists for microlithography
H.Ito
IBM Corp.
Adv.Polym.Sci.172:37-245(2005)
参考資料3 Reference 3:
Radiation-Induced Acid Generation Reactions in Chemically Amplified Resists for Electron Beam and X-Ray Lithography
T.Kozawa,Y.Yoshida,M.Uesaka and S.Tagawa
The University of Tokyo
Jpn.J.Appl.Phys.31:4301-4306(1992)
参考資料4 Reference 4:
Dependence of Acid Generation Efficiency on Molecular Structures of Acid Generators upon Exposure to Extreme Ultraviolet Radiation
R.Hirose,T.Kozawa,S.Tagawa,T.Kai,and T.Shimokawa
Osaka University
Appl.Phys.Express 1:027004(2008)
キーワード:パルスラジオリシス、極端紫外光、レジスト、リソグラフィ、放射線誘起反応、ラジカルカチオン、熱化電子、二次電子、電子付着解離
pulse radiolysis,extreme ultraviolet radiation,resist, lithography,radiation-induced reaction,radical cation,thermalized electron,secondary electron,dissociative electron attachment
分類コード:010101,010205,010305
放射線利用技術データベースのメインページへ