放射線利用技術データベースのメインページへ
作成: 2007/09/28 若原 昭浩、岡田 浩
データ番号 :010309
希土類添加窒化物半導体による光・電子デバイス
目的 :放射線環境下での耐放射線性に優れた発光デバイス材料の開発
放射線の種別 :電子,陽子
放射線源 :電子加速器(3MeV)、陽子線源(380keV)
線量(率) :3x1013 e/cm2/s、3x1011 p/cm2/s
利用施設名 :日本原子力研究開発機構高崎研究所2号加速器、およびイオン照射施設(TIARA)
照射条件 :大気中(電子線照射)および真空中(陽子線)、室温
応用分野 :ディスプレイ、発光素子、光通信、光増幅器
概要 :
窒化物半導体であるGaNに添加した希土類元素(ユウロピウム)からの発光について、その電子線および陽子線照射に対する効果を調べ、電子線・陽子線照射量に対する発光強度の依存性から、希土類元素からの発光は、GaNのバンド端発光に比べて非常に高い耐放射線性を有していることを示した。
詳細説明 :
窒化物半導体であるGaNに添加した希土類元素(ユウロピウム)からの発光について、その電子線および陽子線照射に対する効果を調べ、希土類元素からの発光が、半導体結晶のバンド端発光に比べて耐放射線性に優れていることを示し、耐放射線性に優れた発光デバイス材料として有用であることを示した。
評価に用いた材料は、有機金属気層成長法によってサファイア基板上にエピタキシャル成長した窒化ガリウム(GaN)の母材薄膜に、イオン注入法によってEuを添加したものを用いた。窒化ガリウムの膜厚はおよそ2ミクロンであり、イオン注入エネルギー200keV、1~5x1014cm-2の注入量でEuをイオン注入した。この照射条件により、EuはGaN表面から100nmの深さの領域に、最大3x1019cm-3程度の濃度で注入されていると予測される。Euのイオン注入後に結晶欠陥回復のため、窒素およびアンモニア混合ガス雰囲気中で、1050℃、30分のアニール処理を行った。
3MeVの電子線照射は室温、大気雰囲気にて1x1016cm-2から3x1017cm-2の照射量で照射を行った。なお、照射による試料温度の上昇を避けるため、試料台の水冷を行った。また、380keVの陽子線照射は真空チャンバーに試料をセットし、10-6Torr程度の真空中で室温にて1x1013cm-2から1x1016cm-2の照射量で照射を行った。なお、この照射エネルギーは、電子線・陽子線のいずれもEu注入層はもちろん、2ミクロンのGaN薄膜を通過するエネルギーである。
照射効果の評価はHe-Cdレーザ(波長325nm)を励起光とする室温におけるホトルミネセンス(PL)法により行った。まず、3MeVの電子線照射に対する効果をPL法により評価した結果を示す(図1)。Euを添加していない試料では、365nm付近にバンド端近傍からの発光と考えられるピークが確認でき、この発光スペクトル形状は3x1017cm-2の電子線照射後においても変化が見られなかったものの、バンド端発光ピークの強度は大幅に減少した。一方、Eu添加試料では620nm付近にEu3+からの発光に由来するピークが観測され、このスペクトル形状は、強度を含め、同じ電子線照射に対して大きな変化はみられなかった。
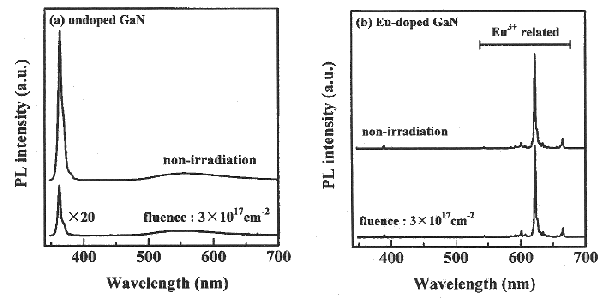
図1 Room-temperature PL spectra of electron-irradiated (a) undoped and (b) Eu-doped GaN compared with nonirradiation samples. The Eu dose is 5x1014 cm-2 and the electron fluence is 3x1017cm-2.(原論文1より引用)
電子線照射量に対する発光強度の関係を調べたものを図2に示す。ここでは電子線照射前の発光強度で規格化を行ったデータをプロットしている。Euを添加していない試料のバンド端発光は、1016cm-2の電子線照射に対して半分、3x1017cm-2の照射に対して1/50の発光強度になっているのに対し、Eu3+からの発光ピークは殆ど減少しないか、10~20%程度の減少に留まっている。また、モールディング前の(所謂、ベアチップの状態の)商用されているGaN系LEDに対しても電子線照射を行い、駆動電流一定の条件で測定した発光輝度の変化を星印で示した。LEDに対する結果は、GaN薄膜のバンド端発光とよく似た振舞いを示した。ここから、希土類イオンを添加した窒化ガリウムでは、耐放射線性の優れた発光素子材料として有望であることがわかる。
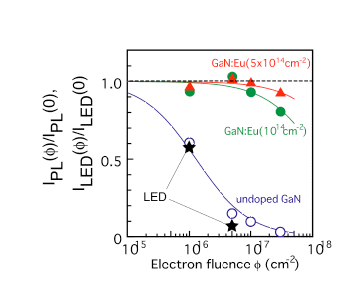
図2 Dependence of integrated PL intensity on electron fluence, where the PL intensities are normalized to that of the nonirradiated samples. Open circles indicate the near band-edge (NBE) emission of undoped GaN, and closed triangles and closed circles indicate 5D0-->7F2 transition of Eu3+ with the dose of 5x1014 and 1x1014 cm-2, respectively. Dependence of GaN-based LED is given by stars.
陽子線照射に対する結果を図3に示す。380keVの陽子線照射に対しても、電子線照射亜に対する結果と同様、スペクトル形状に明らかな変化は見られなかった。しかし、Euを添加していないGaNのバンド端発光は、陽子線照射に対して著しい減少が認められ、1x1013cm-2の照射後には発光強度は1/5程度に、1x1015cm-2の照射後には1/1000にまで減少した。これに対し、GaNに添加したEu3+からの発光は1x1014cm-2の照射に対しても殆ど劣化が見られず、5x1015cm-2まで照射量を増加しても発光強度は1/5程度までしか減少していないことが分かった。
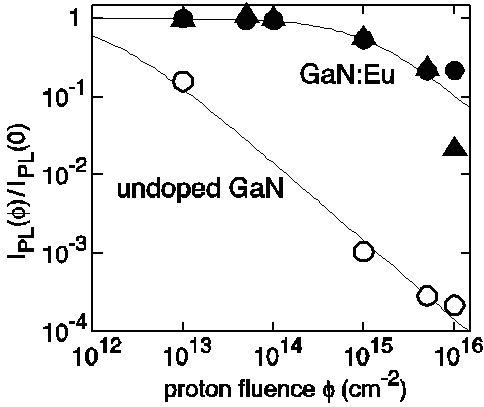
図3 Dependence of PL intensity on 380keV proton fluence for undoped GaN (○) and Eu-doped GaN (Eu: 1x1014cm-2 and 5x1015cm-2 for ● and ▲, respectively).(原論文2より引用)
バンド端発光が光励起された電子-正孔の再結合過程であるのに対し、GaNに添加した希土類イオンからの発光は、母材からのエネルギー移送を受けた希土類元素の内殻遷移に基づいた、全く異なる過程であり、この相違が放射線照射に対する振る舞いの差異に現れていると考えられる。また、窒化ガリウムがイオン注入による希土類イオン添加に対して、高濃度の注入を許容することも高い耐放射線性の要因の1つと考えられる。GaNにイオン注入により添加した希土類イオンからの発光は、希土類イオンの添加量ともに増大し、添加量1019cm-3程度で最大になることが分かっている。希土類イオンからの発光への放射線照射効果は、放射線照射による非発光再結合中心の濃度が添加した希土類イオンの濃度と同等になったときに発光の劣化が見られていると見積もられており、母材である窒化ガリウムと希土類元素を組み合わせが、高い耐放射線性の要因になっていると考えられる。
コメント :
宇宙空間利用において、小型、軽量かつ低消費電力で動作する半導体発光素子は、ディスプレーや衛星間通信の光源として多くの重要性を持つ。宇宙空間利用において、耐放射線性の優れた半導体素子の開発は重要な課題であり、本報告で述べた希土類イオンを添加した窒化ガリウム系材料は、高い放射線照射耐性を有する新しい発光素子の材料として有望であり、将来の衛星間通信用や、宇宙空間での長距離光通信用の光源や、衛星に搭載する長寿命ディスプレーへの応用が期待できる技術であると言える。
原論文1 Data source 1:
Effect of 3 MeV electron irradiation on the photoluminescence properties of Eu-doped GaN
Y. Nakanishi, A. Wakahara, H. Okada, A. Yoshida, *T. Ohshima and *H. Itoh
Toyohashi University of Technology, *Japan Atomic Energy Research Institute
Applied Physics Letters, Vol.81, number.11, 9 september (2002), pp1943-1945
原論文2 Data source 2:
希土類元素を添加した窒化ガリウムの放射線照射効果の検討
岡田浩、中西康夫、若原昭浩、吉田明、*佐藤真一郎、*大島武
豊橋技術科学大学、*日本原子力研究開発機構
第68回応用物理学会学術講演会講演予稿集
キーワード:電子線、陽子線、耐放射線特性、光デバイス、希土類元素、窒化物半導体
Electron beam, proton beam, radiation hardness, optical devices, rare-earth materials, nitride semiconductors
分類コード:010206, 0106
放射線利用技術データベースのメインページへ