放射線利用技術データベースのメインページへ
作成: 2006/10/01 中嶋堅志郎
データ番号 :010300
半導体デバイス用埋め込み絶縁膜へのDLC薄膜の応用
目的 :シリコン基板への埋め込み絶縁膜DLCの作製
放射線の種別 :軽イオン
照射条件 :減圧プロセスガス中
応用分野 :MOSFET
概要 :
埋め込み型シリコン酸化膜構造(SOI)はトランジスタ特性改善など電力用集積回路への応用が期待されるが、SiO2膜の熱伝導率が小さいことに起因した自己発熱の懸念から、SOI構造の応用が制限されている。ダイヤモンドライクカーボン(DLC)膜は熱伝導率が大きく、又抵抗率も大きいことから、SiO2膜の代替として有望視されている。シリコン基板上へのDLC膜の作製、イオン・カット法によるSOD構造の作製、絶縁層を(SiO2/DLC)2層構造とした特性改善について紹介する。
詳細説明 :
埋め込み型SiO2構造(Si/SiO2/Si)は浮遊容量の低下、トランジスタ特性改善等により大電力用集積回路への応用が考えられるが、SiO2膜の熱伝導率が小さいことに起因する自己発熱のためデバイスへの応用が制限されている。SiO2膜の代替絶縁膜としてダイヤモンド薄膜が熱伝導率や抵抗率の大きさから理想的と考えられるが、ダイヤモンド表面が粗いためSi基板との直接接合のためには表面の平滑化を必要とし、良好な接合作製が困難である。
ダイヤモンドライクカーボン(DLC)は表面の平滑性が優れている他、熱伝導率、抵抗率も大きいため埋め込み絶縁膜(SOD)として応用が期待される。ここでは、Siウェーハ上へのFCA(Filtered Cathode Arc)によるテトラヘドラル・アモルファスDLC(ta-DLC)製膜、RFプラズマによるDLC製膜とイオン・カット法によるSOD(Si on Diamond)構造作製、絶縁層をSiO2/DLC 2層構造とした熱的安定性の向上について紹介する。
炭素固体源(C)とカソード・アークによって発生させたイオン、ラジカル、中性粒子をフィルターによってエネルギーのそろったイオンのみとしたプラズマ源(FCA)を用いると、膜中のC-C結合したsp3結合成分が60〜80%と多くなり、高硬度のta-DLC膜を作製できる。P型Si(100)基板に-200Vのバイアスを加えて製膜したDLC薄膜をRBS(ラザフォード後方散乱)、IR-reflection(赤外反射)により解析すると、sp3-C濃度の成分87%(膜厚117nm)と評価された。膜の平坦度Rrms<0.5nm、絶縁破壊強度4.7MV/cmが得られている。SOI構造の絶縁膜として平坦度、抵抗率共に充分使用可能な膜であると考えられる(原論文1)(図1)。
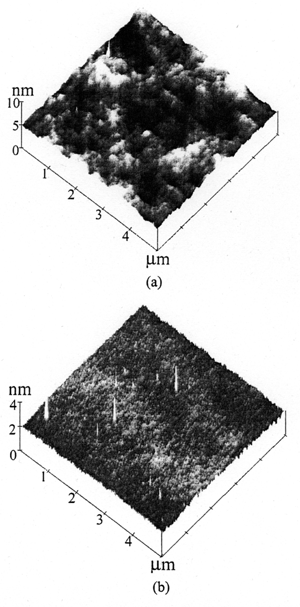
図1 AFM images of ta-C thin films deposited by the FAD method on p-type Si(100) substrates with different substrate bias: (a) sample 1, -200V and (b) sample 2, -300V; scanning area of the images were both 5x5 μm.異なったバイアスでFAD法によりp-type Si(100)基板上に堆積したta-C薄膜のAFM像:(a) 試料1、-200V, (b) 試料2、-300V;二つの像のスキャン領域は5x5μm. Reused with permission from C. Baker, I. S. Gregory, W. R. Tribe, I. V. Bradley, M. J. Evans, M. Withers, P. F. Taday, V. P. Wallace, E. H. Linfield, A. G. Davies, and M. Missous, Applied Physics Letters, 83, 4113 (2003). Copyright 2003, American Institute of Physics.The following credit line must appear with your reuse of this material:
Reused with permission from Z. R. Song, Y. H. Yu, C. L. Li, S. C. Zou, F. M. Zhang, X. Wang, D. S. Shen, E. Z. Luo, B. Sundaravel, S. P. Wong, and I. H. Wilson, Applied Physics Letters, 80, 743 (2002). Copyright 2002, American Institute of Physics.(原論文1より引用)
アセチレンとArの混合ガス(20sccm/5sccm)を用い、PIII&D(Plasma immersion ion implantation & deposition)法(製膜圧力8x10-4 Torr (0.1066 Pa))、rfプラズマ(パワー500W)、基板印加電圧-20kV)で作製したDLC薄膜は表面平滑度Rrms=0.381nmと極めて平坦な膜であり、絶縁破壊強度4.2MV/cmは900℃までの炉アニール、高速アニール(RTA)(N2ガス中)では変化しない。1000℃を超えた炉アニールではDLC膜の黒鉛化反応により絶縁破壊強度は約2MV/cmまで急減する。あらかじめH+イオン注入(6x1016 cm-2, 60keV)しておいたn-Siウェーハの注入面とDLC薄膜面(p-Si基板)とをスペーサーを挟んで固定し、空気中(室温)でウェーハ中央部を加圧しながらスペーサーを除去するとSOD直接ボンドが形成される。接合の後、120℃〜300℃のアニールを窒素ガス中で行い、450℃(10〜15min)の熱処理によりウェーハのスプリットが完成する。TEM(透過型電子顕微鏡)観察によると、Si面に構造欠陥は無く、DLCはアモルファス状となっていて、急峻な界面の接合であることが確認された。赤外透過観察によると界面に数個のバブルが認められる。これは界面の炭化水素が核形成の原因として作用したと考えられる(原論文2)(図2)。
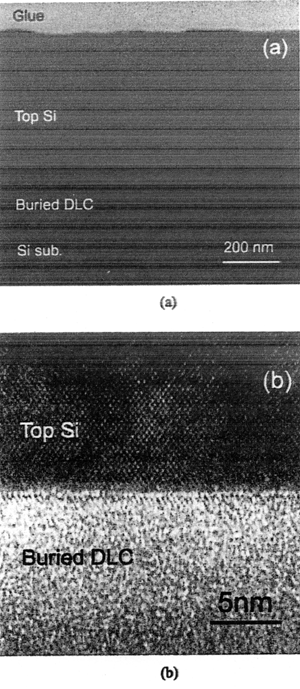
図2 (a) TEM micrograph of the SOD structure formed using direct wafer bonding and hydrogen-induced layer transfer. (b) HRTEM micrograph of the interfacial region between the top Si layer and buried DLC layer, indicating a defect-free and single crystal Si layer as well as an abrupt bonded interface. (a) 直接ウェーハー接合と水素誘起による層の転移を用いて作製したSOD構造のTEM顕微鏡写真 (b) 上部Si層と埋め込みDLC層との境界領域のHRTEM顕微鏡写真。急峻な接合境界と共に欠陥の無い単結晶Si層が示されている。Reused with permission from Ming Zhu, Paul K Chu, Xuejie Shi, Man Wong, Weili Liu, and Chenglu Lin, Applied Physics Letters, 85, 2532 (2004). Copyright 2004, American Institute of Physics.(原論文2より引用)
平滑なSi/DLC接合が得られるものの、SiとDLCの直接接合はSi/SiO2に比べて幾つかの欠点を持っている。界面の平坦度はSiO2に比べて劣っている、C-Siの相互拡散による界面の熱的安定性が不十分である、などが挙げられる。これらの欠点を改善するため、Si面とDLC面との間にSiO2薄膜を挿入する2層構造絶縁膜SiO2/DLCが提案されている(SODI)。PIII&Dにより上記と同じようにp-Si基板上にDLC(200nm)を作製する。別にSiO2薄膜(160nm)を形成したn-Siを準備し、H+イオン注入(140keV)しておく。表面をクリーニングするプロセスの後、空気中でDLC面とSiO2面とを接合させ、接合面の強化プロセス(120℃〜300℃のN2中アニール)を経て、450℃(10〜15min)で加熱してSiウェーハのへき開を行いSODI構造を得る。この構造により絶縁破壊電界は4.6±0.1MV/cmとなり、700〜1000℃まで安定であることが示された。絶縁破壊電界が1000℃まで安定になった理由として、SiO2膜が熱的に安定であること、DLCからのHの拡散を抑制していることを挙げている。DLCからのHの拡散はDLCのグラファイト化を促すと考えられている。SOIとSODIを用いたMOSFETによる数値解析により同じ基板温度300Kに対し、チャネル温度はSOIが510K、SODIは360Kとなり、自己発熱効果が抑制されることが明らかとなった(原論文3)(図3)。
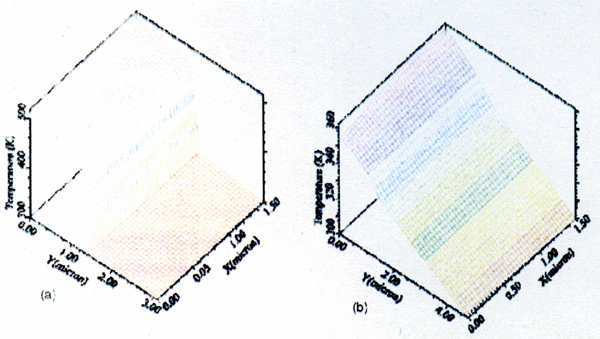
図3 (Color online) Simulated 3D temperature distributions of devices in (a) SiO2-based SOI and (b) SODI.(a)SiO2によるSOIと(b)SOIDにおけるデバイスの3D温度分布シミュレーション。Reused with permission from Zengfeng Di, Paul K. Chu, Ming Zhu, Ricky K. Y. Fu, Suhua Luo, Lin Shao, M. Nastasi, Peng Chen, T. L. Alford, J. W. Mayer, Miao Zhang, Weili Liu, Zhitang Song, and Chenglu Lin, Applied Physics Letters, 88, 142108 (2006). Copyright 2006, American Institute of Physics.(原論文3より引用)
コメント :
DLC膜はSiO2膜に比較すると1桁以上大きい熱伝導率を示すが、製法、使用するガス種等によって熱伝導率が変化する。DLCの特徴が期待通り発揮されるかはシミュレーションと共に実デバイスにより確認する必要があるが、現時点では未だその報告は無い。その他、この技術が実用されるにはDLC膜を採用することによるコスト変化についても検討する必要がある。
原論文1 Data source 1:
Tetrahedral amorphous-carbon thin films for silicon-on-insulator application
Z.R.Song, Y.H.Yu, C.L.Li, S.C.Zou, F.M.Zhang and X.Wanga)
D.S.Shenb), E.Z.Luo, B.Sundaravel, S.P.Wong, and H.Wilsonc)
a)Ion Beam Laboratory, Shanghai Institute of Metallurgy, Chinese Academy of Science, b)Department of Electrical and Computer Engineering, University of Alabama in Huntsville, c)Department of Electronic Engineering, Chinese University of Hong Kong
Appl. Phys. Lett. Vol.80, No.5, 743-745(2002)
原論文2 Data source 2:
Formation of silicon-on-diamond by direct bonding of plasma-synthesized diamond-like carbon to silicon
M.Zhu and P.K.Chua), X.Shi and M.Wongb), W.Li and C.Linc)
a)Department of Physics and Materials Science, City University of Hong Kong
b)Department of Electrical and Electronic Engineering, The Hong Kong University of Science and Technology, c)Research Center of Functional Semiconductor Film Engineering & Technology, Shanghai Institute of Microsystem and Information Technology, Chinese Academy of Science
Appl. Phys. Lett. Vol.85, No.13, 2532-2534(2004)
原論文3 Data source 3:
Fabrication of silicon-on-SiO2/diamondlike-carbon dual insulator using ion cutting and mitigation of self-heating effects
Z.Di, P.K.Chu, M.Zhu, R.K.Y.Fu, and S.Luoa), L.Shao and M.Nastasib), P.Chenc), T.L.Alford and J.W.Mayerd), M.Zhang, W.Liu, Z.Song, and C.Line)
a)Department of Physics and Materials Science, City University of Hong Kong,
b)Materials Science and Technology Division, Los Alamos National Laboratory,
c)Department of Electrical and Computer Engineering, University of California at San Diego,
d)Department of Chemical and Materials Engineering, Arizona State University
e)The Research Center of Semiconductor Functional Film Engineering Technology and State Key Laboratory of Functional Materials for Informatics, Shanghai Institute of Microsystem and Information Technology, Chinese Academy of Science
Appl. Phys. Lett. Vol.88, 142108-1-3(2006)
キーワード:ダイヤモンドライクカーボン、埋め込み薄膜、プラズマ・イオン注入・膜堆積、熱伝導率、抵抗率、高周波プラズマ、イオン・カット、表面粗さ
DLC, buried thin film, PBII&D, thermal conductivity, resistivity, rf plasma, ion cutting, surface roughness
分類コード:010205, 010304, 010103
放射線利用技術データベースのメインページへ