作成: 2005/10/1 早味 宏
データ番号 :010279
超低電圧EBキュアプロセスの半導体デバイス用低誘電率絶縁膜(Low-k膜)への応用
目的 :超低電圧EBキュアプロセスを応用した次世代半導体用低誘電率層間絶縁膜(Low-k膜)の開発
放射線の種別 :電子
放射線源 :ウシオ電機製Min-EB UEB-04型(Min-EB照射管19本のアセンブリ)、13kV
フルエンス(率):42μC/cm2
線量(率) :0.2-0.5mC/cm2
照射条件 :350℃、10Torr (1 Torr=133.32Pa)、アルゴン雰囲気
応用分野 :半導体デバイス、層間絶縁膜
概要 :
半導体デバイスは世代が進むごとに配線間隔の縮小と多層化が進んでおり、回路間の静電容量の増加が信号の伝搬速度を遅延させ性能低下をもたらす。このため、層間絶縁膜の低誘電率化が必要であり、配線幅45nm世代では比誘電率(k)=2.2以下の低誘電率層間絶縁膜(Low-k膜)が必要となる。比誘電率(k)=2.2以下を実現するには膜の多孔化が必須となるが、膜の強度やウエハとの密着力が低下する。そこで、多孔質Low-k膜の超低電圧EBキュアリングを検討した結果、k=2.25で、従来の熱キュア膜に比べ、膜強度が1.5倍、ウエハとの密着力も1.6倍に向上し、プロセス温度を500→350℃に低減でき、キュア時間も60分から3分に大幅短縮できることがわかり、次世代半導体デバイス用Low-k膜形成の有望な手段となることがわかった。
詳細説明 :
半導体デバイスは世代が進むごとに回路の配線幅や配線間隔の縮小化、配線層の多層化が進んでいる。配線間隔が縮小化し、配線層の多層化は回路間の静電容量の増加をもたらし、配線断面積の低下は導体抵抗が増加するため、信号の伝搬速度を遅延させ(RC遅延)、半導体デバイスの性能を低下させる。
この問題に対処するため、配線幅130nm世代以降は配線材料には従来のアルミニウムに替わって銅が採用され、導体抵抗が半減される一方、層間絶縁膜についても130nm世代まではSiO2が使用されていたが、90nm世代以降は比誘電率(k)が3.0以下のいわゆる低誘電率膜(Low-k膜)が採用されるようになった。
90nm世代のLow-k膜の代表例は図1(*)に示すk=2.9のシリコン酸化膜(SiOC膜)で、この膜はモノメチルシラン(SiH3CH3)等の有機シランとN2OまたはO2を原料ガスとするプラズマCVD法で形成され、無機材料と有機材料の中間的な性質を持ったポリシロキサン膜である。
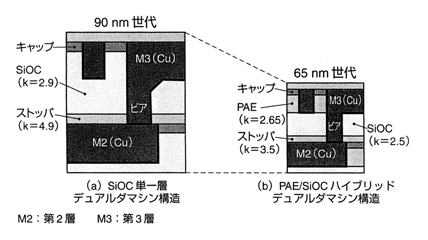
図1 90nm, 65nm世代における多層配線構造の概略 90nm世代では層間絶縁膜構造として単一層構造を、65nm世代では二種類のLow-k膜を積層した構造を採用。Schematic diagram of multilayered interconnection structure in 90nm and 65nm node generations.(株式会社東芝の許可を得て原論文2 東芝レビュー 59(8), 17-21 (2004)の図1を転載)(原論文2より引用)
(*)ダマシンプロセス:銅はRIE(リアクティブイオンエッチング)による加工が困難なため、ダマシンプロセスというあらたな配線加工プロセスが開発された。ダマシンプロセスはフォトリソグラフィー法を用いて、層間絶縁膜に溝を形成し、電解めっきで銅を溝全体に成長させ、上部の余分な銅を化学機械的研磨法(CMP:Chemical Mechanical Polishing、砥粒を含む薬液でCu表面を化学エッチングしながら研磨する方法)で除去し、表面の平坦化を行うプロセスである。配線と同時にVia部への銅の埋め込みも行うものをデュアルダマシン法と呼ばれている。
65nm世代では、配線幅と層間距離がさらに短くなるため、層間絶縁膜のさらなる低誘電率化が必要となり、SiOC膜の低誘電率化(k=2.9→2.5)、有機系のポリアリレンエーテル膜(PAE膜)が採用され、スピンコート等の塗布法で形成されている。
今後の45nm世代では層間絶縁膜にはk=2.2以下の新規材料が必要となり、膜のポーラス化(多孔化)が必須である。しかしながら、層間絶縁膜の多孔化は機械的強度の大幅な低下につながり、この問題を解決する手段として超低電圧EBキュアプロセスが検討されている。
多孔質Low-k膜の原料にはJSR㈱製のLKD(商品名)を用い、シリコンウエハ上に塗布、乾燥後、熱キュアを行った(膜厚500nm)。この膜へのEB照射は8インチのウエハを500℃まで加熱できるヒータとガス導入装置を付帯したウシオ電機製のMin-EB UEB-04型(Min-EB照射管19本のアセンブリ)を用いた。シリコンウエハ温度を350℃に保ち、加速電圧13kV、線量率42μC/cm2・minの電子線を10Torr(=1.333kPa)のアルゴン雰囲気下で照射した。
図2のように、膜の弾性率は照射線量とともに増加し、0.5mC/cm2の照射で9.1GPaに達し、これは熱硬化型の多孔質Low-k膜の1.5倍に相当する。比誘電率は線量範囲0.2〜0.5mC/cm2でほぼ一定で、0.5mC/cm2において2.25である。熱硬化型の多孔質low-k膜はシリコンウエハに対する密着力が低いという問題もあったが、図3のように、界面破壊エネルギー(4点曲げ試験による界面密着強度測定)は熱硬化膜の2.2J/m2に対し、EBキュア膜では3.5J/m2と1.6倍に改良できる。熱硬化膜とEBキュア膜の比較を表1に示す。プロセス温度が低減できるとともに、キュア時間も60分から3分に短縮でき、次世代半導体デバイスのLow-k膜の製造技術として実用化が期待される。
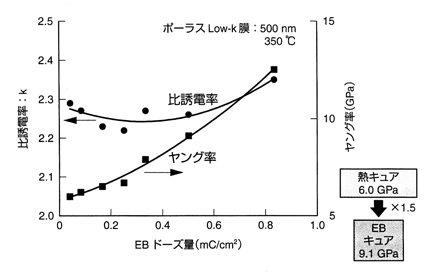
図2 EBキュアによるLow-k改質効果 0.5mC/cm2のEB照射により、比誘電率は上昇することなく、Low-k膜のヤング率が熱キュアの1.5倍に向上している。Dielectric constant and Young’s moldulus as function of total dose.(株式会社東芝の許可を得て原論文2 東芝レビュー 59(8), 17-21 (2004)の図8を転載)(原論文2より引用)
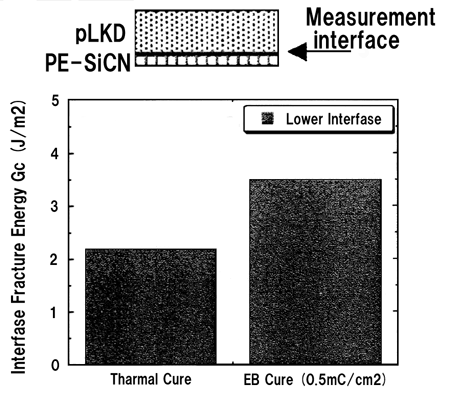
図3 熱硬化型p-LKD 膜、EB硬化型 p-LKD膜のPE-SiCN層に対する密着強度 Adhesion strength at lower interface of thermal cured p-LKD and EB-cured p-LKD.(原論文1より引用。 Reprinted from data source 1 with permission from IEEE (C)IEEE 2003 ||Reproduced from Proceeding of the IEEE 2003 International Interconnect Technology Conference. p.106-108 (2003).)
表1 フィルム特性 Film properties.(原論文1より引用。 Reprinted from data source 1 with permission from IEEE (C)IEEE 2003 ||Reproduced from Proceeding of the IEEE 2003 International Interconnect Technology Conference. p.106-108 (2003).)
| Cure Method |
Thermal |
EB |
| film thickness (nm) |
500 |
500 |
| Accelerating voltage (kV) |
- |
13 |
| Pressure (Torr) |
760 |
10 |
| Gas |
N2 |
Ar |
|
Total does (mC/cm2) |
- |
0.5 |
| Wafer temperature (℃) |
420 |
350 |
| Cure time (min) |
60 |
3 |
| Shrinkage (%) |
1 |
8 |
| k |
2.25 |
2.26 |
| Modulus (GPa) |
6.0 |
9.1 |
| Film density (g/cm3) |
0.88 |
0.97 |
| Adhesion Strength |
2.2 |
3.5 |
| H2O outgas by TDS (a.u. RT - 450℃) |
0.40 |
0.51 |
コメント :
加速電圧が50kV以下といった超低電圧のEBキュアプロセスは、基材にダメージを与えないという特長を活かし、紙に印刷したインクの高速キュアリングなどの用途で実用化されている。基材にダメージを与えないという本技術の特質を活かした技術開発は、本文献のように半導体デバイスの製造プロセスにおいても今後広く活用されていくものと考えられる。
原論文1 Data source 1:
Notable Improvement in Porous Low-k film Properties using Electron-Beam Cure Method
K. Fujita, H. Miyajima, R. Nakata, N. Miyashita
Semiconductor Company Toshiba Corporation
Proceeding of the IEEE 2003 International Interconnect Technology Conference. p.106-108 (2003)
原論文2 Data source 2:
高性能配線技術
依田 孝,蓮沼 正彦,宮島 秀史
東芝セミコンダクター社
東芝レビュー 59(8), 17-21 (2004)
キーワード:超低電圧、電子線照射、EBキュア、半導体デバイス、多層配線、層間絶縁膜、低誘電率、Low-k膜、ポーラスシリカ
Ultra low acceleration voltage, Electron beam irradiation, EB curing, Semiconductor device, multilevel interconnection, Interlayer dielectric, Low dielectric constant, Low-k film, porous silicon dioxide.
分類コード:010101,010205