曻幩慄棙梡媄弍僨乕僞儀乕僗偺儊僀儞儁乕僕傊
嶌惉丗 2004/09/30 嶳杮 弔栫
僨乕僞斣崋丂丂丂丗010272
僀僆儞徠幩偵傛傞僗儅乕僩僇僢僩媄弍
栚揑丂丂丂丂丂丂丗僀僆儞價乕儉傪梡偄偨旝嵶壛岺媄弍
曻幩慄偺庬暿丂丂丗寉僀僆儞
曻幩慄尮丂丂丂丂丗僀僆儞拲擖婍乮200keV, 10兪A乯
僼儖僄儞僗乮棪乯丗1016 ions/cm2
棙梡巤愝柤丂丂丂丗擔杮尨巕椡尋媶強撨壪尋媶強晧僀僆儞尮
徠幩忦審丂丂丂丂丗恀嬻拞
墳梡暘栰丂丂丂丂丗敿摫懱慺巕丄懢梲揹抮
奣梫丂丂丂丂丂丂丗
丂
丂僗儅乕僩僇僢僩媄弍偼丄僀僆儞拲擖朄偵傛傝敿摫懱扨寢徎僂僃僴乕偵悈慺尨巕傪悢儈僋儘儞偺怺偝偵崅擹搙偵摫擖偟丄偝傜偵擬張棟偵傛傝僔儕僐儞寢徎偺寢崌傪愗抐偟偰丄扨寢徎僂僃僴乕偺慡昞柺傪儈僋儘儞悺朄偺岤傒偱攳偑偡旝嵶壛岺媄弍偱偁傞丅SOI(Silicon on Insulator)慺巕丄師悽戙懢梲揹抮梡偺扨寢徎僔儕僐儞敄枌側偳偺嶌惢偵墳梡偑恑傔傜傟偰偄傞丅
徻嵶愢柧丂丂丂丂丗
丂
丂崅懍偐偮掅徚旓揹椡偱僨僶僀僗傪摦嶌偝偣傞偙偲偑壜擻側SOI(Silicon on Insulator-愨墢憌忋偺僔儕僐儞敄枌)慺巕偺嶌惢偵悈慺僀僆儞價乕儉傪棙梡偟偨愗抐庤朄偑棙梡偝傟偰偄傞丅悈慺惼壔尰徾傪棙梡偟偨偙偺悈慺愗抐朄偼丄乬僗儅乕僩僇僢僩乭傑偨偼乬僀僆儞僇僢僩乭偲屇偽傟丄僔儕僐儞丄俽倝俠丄俧倎俙倱側偳敿摫懱扨寢徎僂僃僴乕偺昞柺傪儈僋儘儞悺朄偺岤傒偱攳偑偡旝嵶壛岺媄弍偱偁傞丅偝傜偵丄偙偺僗儅乕僩僇僢僩媄弍偼丄僔乕僩忬扨寢徎俽倝懢梲揹抮丄僼僅僩僯僢僋寢徎側偳偺嶌惢偵墳梡偑恑傔傜傟偰偄傞丅

恾1丂 Principle of the Smart-Cut process 僗儅乕僩僇僢僩偺婎杮僾儘僙僗. This article was published in Nuclear Instruments and Methods in Physics Research, B 216, Michel Bruel, Comparison of thermally and mechanically induced Si layer transfer in hydrogen-implanted Si wafers, 313-319, Copyright Elsevier (2004).
乮尨榑暥1傛傝堷梡乯
丂
丂偼偠傔偵丄僗儅乕僩僇僢僩偺婎杮僾儘僙僗偵偮偄偰愢柧偡傞丅僗儅乕僩僇僢僩偼丄恾侾偵帵偡係偮偺岺掱偐傜峔惉偝傟傞丅僔儕僐儞僂僃僴乕偺僗儅乕僩僇僢僩傪椺偵愢柧偡傞丅丂
丂
丂僀僆儞拲擖婍傪梡偄偰3.5亊1016乣1亊1017 ions/cm2偺徠幩検偺斖埻偱僔儕僐儞僂僃僴乕偵悈慺僀僆儞偺拲擖傪峴偆乮僗僥僢僾侾乯丅SOI偺嶌惢偱偼丄僀僆儞拲擖慜偵僂僃僴乕昞柺偵擬巁壔偵傛傝SiO2愨墢憌偺宍惉傪峴偆丅師偵丄巁側偳偺壔妛栻昳偲弮悈傪梡偄偰僂僃僴乕昞柺偺愻忩傪峴偄丄偝傜偵恊悈壔張棟傪巤偟廳偹崌傢偣偰幒壏偱愙崌偡傞乮僗僥僢僾俀乯丅懕偄偰丄愙崌偝偣偨僂僃僴乕傪400乣600亷偱擬張棟傪峴偄丄悈慺僀僆儞拲擖偟偨僂僃僴乕偐傜悢儈僋儘儞岤偝偱攳棧傪偝偣傞乮僗僥僢僾俁乯丅僔儕僐儞僂僃僴乕俙偲俛偺奅柺傪1000亷埲忋偱擬張棟傪峴偆丅嵟屻偵丄攳棧偟偨僂僃僴乕昞柺偺惛枾尋杹傪峴偆乮僗僥僢僾係乯丅埲忋偑僗儅乕僩僇僢僩偺婎杮揑側岺掱偱偁傞丅

恾2丂TEM cross-section observation of a Smart-Cut SOI structure after final polishing 嵟廔尋杹偟偨僗儅乕僩僇僢僩SOI峔憿偺抐柺TEM娤嶡. This article was published in Nuclear Instruments and Methods in Physics Research, B 216, Michel Bruel, Comparison of thermally and mechanically induced Si layer transfer in hydrogen-implanted Si wafers, 313-319, Copyright Elsevier (2004).乮尨榑暥1傛傝堷梡乯
丂
丂恾俀偼丄僗儅乕僩僇僢僩偵傛傝嶌惢偟偨SOI峔憿偺摟夁宆揹巕尠旝嬀抐柺幨恀傪帵偟偰偄傞丅傑偨丄僂僃僴乕傪攳棧偡傞嵺偵丄掍搧偺恘傪憓擖偟偰婡夿揑偵攳棧偡傞曽朄傕奐敪偝傟偰偄傞丅偙偺曽朄偱偼擬張棟乮400乣600亷乯傪峴傢側偄偨傔丄僔儕僐儞僂僃僴乕偺巟帩婎斅偲偟偰棙梡偱偒傞嵽椏偺慖戰惈偑奼戝偟偨丅
丂
丂師偵丄僗儅乕僩僇僢僩偺暔棟尰徾偵偮偄偰愢柧偡傞丅婓僈僗僀僆儞拲擖偵傛傞嬥懏嵽椏傊偺塭嬁偵娭偟偰偼丄妀梈崌楩偵偍偗傞楩暻嵽椏偺徠幩懝彎偺娤揰偐傜丄僿儕僂儉僀僆儞拲擖偟偨偲偒偵惗偠傞嵽椏昞柺偺僽儕僗僞乕乮朿傟乯丄攳棧丄僼儗乕僉儞僌乮攳偑傟棊偪乯側偳偺尰徾偑庡偵尋媶偝傟偰偄偨丅偙傟偲摨條側尰徾偑敿摫懱扨寢徎偵偍偄偰傕尒弌偝傟丄僔儕僐儞傊偺悈慺僀僆儞偵傛傞僽儕僗僞乕宍惉丄暔棟揑塭嬁側偳偑挷傋傜傟偨丅
丂
丂僔儕僐儞扨寢徎僂僃僴乕偵悈慺僀僆儞拲擖偡傞偲丄悈慺僀僆儞偼擖幩僄僱儖僊乕偵墳偠偨怺偝傑偱摓払偟丄崅擹搙偵暘晍偡傞丅偝傜偵擬張棟偵傛傝拲擖偺嵺偵宍惉偝傟偨拲擖寚娮偵拲擖悈慺偑廤傑傝丄寢徎偺寢崌傪愗抐偡傞丅僗儅乕僩僇僢僩媄弍偼丄寢徎峔憿傪曐帩偟側偑傜攳棧偺婲偙傞柺愊傪100兪倣2偐傜100們倣2偵奼戝偡傞傛偆偵岺晇偟偨傕偺偱偁傞丅
丂
丂僗儅乕僩僇僢僩偵傛傝攳棧偝傟傞僂僃僴乕偺岤偝偼丄僀僆儞拲擖偡傞悈慺僀僆儞偺僄僱儖僊乕偵傛傝惂屼偱偒傞丅椺偊偽丄恾侾STEP侾偱Si(200 nm)憌/SiO2(400 nm)憌傪攳棧偝偣傞応崌偵偼丄65 keV丄 Si(200 nm)憌/SiO2(400 nm)憌偺応崌偵偼丄200 keV偺擖幩僄僱儖僊乕傪慖戰偡傞丅嵽椏拲擖偵僀僆儞拲擖偝傟偨悈慺偺拲擖暘晍丄寚娮暘晍偼寁嶼偵傛傝尒愊傕傞偙偲偑偱偒傞丅僗儅乕僩僇僢僩偱摼傜傟偨敄枌偺岤偝偼丄傎傏堦條偱偦偺偽傜偮偒偼4 nm埲壓偱偁傞丅傑偨丄寢徎惈偼攋抐椞堟傪彍偗偽椙岲偱丄摟夁揹巕尠旝嬀娤嶡偱傕寢徎寚娮偼娤嶡偱偒側偄傎偳偱偁傞丅
丂
丂悈慺僀僆儞拲擖媄弍偵娭偟偰丄戝柺愊偱崅僄僱儖僊乕偺悈慺晧僀僆儞價乕儉媄弍偑奐敪偝傟偰偄傞丅偙偺寢壥丄廬棃斾100乣1000攞偲偄偆旘桇揑側張棟懍搙丄偝傜偵丄壛懍僄僱儖僊乕傪1MeV傑偱崅傔偨偨傔悈慺僀僆儞傪傛傝怺偔懪偪崬傓偙偲偑偱偒丄恾俁偵帵偡傛偆偵10儈僋儘儞媺偺岤偄僔儕僐儞扨寢徎敄枌傪惢嶌偡傞偙傠偑壜擻偵側偭偨丅
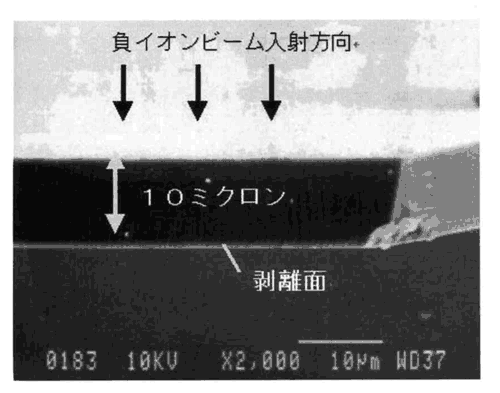
恾3丂愗抐偝傟偨僔儕僐儞敄斅偺抐柺恾乮尨榑暥3傛傝堷梡乯
丂
僐儊儞僩丂丂丂丂丗
丂
丂杮曬崘偱梡偄傜傟偰偄傞僗儅乕僩僇僢僩媄弍偼丄偙傟傑偱僀僆儞徠幩偵敽偆徠幩懝彎偲偟偰僨儊儕僢僩偲尒側偝傟偰偄偨攳棧側偳偺尰徾傪敿摫懱慺巕丄懢梲揹抮側偳傪戝検惢憿偡傞旝嵶壛岺媄弍偵墳梡偟偨傕偺偱丄崱屻偝傜偵棙梡斖埻偺奼戝偑尒崬傑傟傞媄弍偱偁傞偲尵偊傞丅
尨榑暥侾 Data source 1丗
Application of hydrogen ion beams to Silicon On Insulator material technology
Michel Bruel
LETI/CEA
Nuclear Instruments and Methods in Physics Research B 108 (1996) 313-319.
尨榑暥俀 Data source 2丗
Comparison of thermally and mechanically induced Si layer transfer in hydrogen-implanted Si wafers
T. Hochbauer, A. Misra, M,Nastasi, K.Henttinen, T. Suni, I. Suni, S.S. Lau, W. Ensinger
Los Alamos National Laboratory
Nuclear Instruments and Methods in Physics Research B 216 (2004) 257-263.
尨榑暥俁 Data source 3丗
晧僀僆儞價乕儉傪梡偄偨僔儕僐儞婎斅偺検嶻媄弍
墱懞媊榓
擔杮尨巕椡尋媶強
尨巕椡eye, Vol.46(9) (2000) p61-65.
嶲峫帒椏侾 Reference 1丗
悈慺僀僆儞拲擖偵傛傞敿摫懱寢徎偺敄枌攳棧偲偦偺墳梡
妬嶳寬擇
僀僆儞岺妛尋媶強
丂擔杮揝峾嫤夛乽戞137夞弔婜島墘戝夛乿乮1999乯
僉乕儚乕僪丗旝嵶壛岺媄弍丄僀僆儞拲擖丄悈慺丄悈慺惼壔丄僽儕僗僞乕丄攳棧丄僔儕僐儞丄SOI丄
micro-fabrication technology, ion implantation, hydrogen, hydrogen brittleness, blister, flaking, silicon, silicon on insulator,
暘椶僐乕僪丗040101, 040107
曻幩慄棙梡媄弍僨乕僞儀乕僗偺儊僀儞儁乕僕傊