放射線利用技術データベースのメインページへ
作成: 2002/09/06 日比野 豊
データ番号 :010240
レーザ同時照射による低損傷イオン注入技術
目的 :パワーデバイスの特性向上
放射線源 :イオンビーム照射装置
フルエンス(率):1×1014〜1015 ions cm-2
利用施設名 :(株)イオン工学センター200keVイオン注入装置
照射条件 :真空中
応用分野 :パワーデバイス、高周波デバイス
概要 :
炭化ケイ素(SiC)は絶縁耐圧や電子飽和速度が大きいことからパワーデバイスや高周波デバイスに適した次世代の半導体材料として注目されている。しかし、SiC素子作製プロセスにおいてSiC結晶中への不純物の拡散速度が極めて遅く、熱拡散によるドーピングが困難である。従って、通常イオン注入法が用いられるが、イオン注入に伴う結晶欠陥の回復及び不純物の活性化に1500℃以上の高温アニールが必要である。本研究ではSiCへのイオン注入プロセスの低温化を目的に、低損傷注入技術としてレーザ同時照射イオン注入法を開発し、その効果を確認した。
詳細説明 :
SiC半導体素子はパワー素子や高周波素子、更には耐環境素子材料として期待されおり、その素子作製プロセスにおいてプロセスの低温化が切望されている。不純物イオン注入に関しては、一般に高温イオン注入法が有効とされているが、活性化には1500℃以上の高温アニールが必要である。プロセスの低温化としてイオン注入後に短波長パルスレーザを照射するレーザアニール法を試み、結晶欠陥の回復に有効であることを確認している。
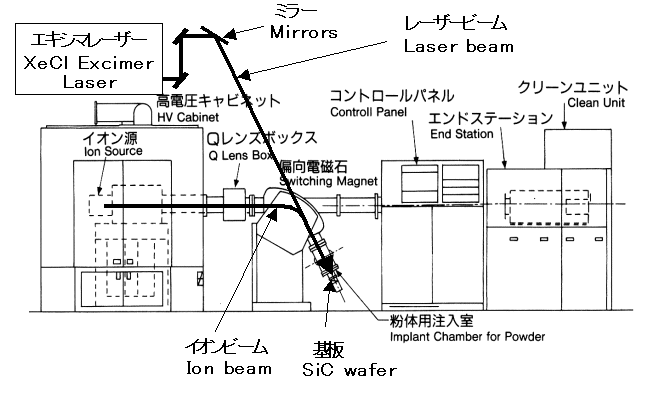
図1 Experimental setup for simultaneous short-wavelength pulsed laser annealing during ion implantation (SLII).
(原論文のFig.1)(原論文1より引用)
更に、本研究ではイオン注入時に生成する照射損傷を低減するため、エキシマレーザビームを真空チャンバー内に導入して、図1に示すイオン注入とレーザビームを同時に照射するレーザ同時照射イオン注入(simultaneous short-wavelength pulsed laser annealing during ion implantation; SLII)法を検討した。
レーザアニール効果の検証実験には、SiC基板として、Nイオン注入では6H-SiC基板上のp-6H-SiCエピ層を、Alイオン注入では6H-SiC基板上のn-6H-SiCエピ層を用いた。イオン注入済みのSiC基板を真空容器中に保持し石英製のビューポートからレーザ光を導入して行った。イオン注入SiCのレーザアニール効果はRBS(Rutherford Backscattering Spectrometry)測定法により評価した。

図2 Energy spectra of aligned and random backscattering yield of laser-annealed and as-implanted Al+ implanted SiC substrates. The scattering angle was 100o. The allows in the figure indicate the Si depth scale from the surface.
(原論文のFig.3)(原論文1より引用)
図2に30keV、3×1014ions・cm-2でAl+イオンを室温で注入した試料のレーザ照射前後のRBSスペクトルを示す。Alイオン注入に伴う照射損傷から反跳したHeイオン収量の増加している領域(1.34MeV〜1.43MeV)において、レーザアニール前(同図実線)約450カウントの収量であったものが、30000回及び300000回レーザパルスを照射した後の収量は約150カウント(○印)及び約100カウント(●印)に低減している。即ちレーザ照射により照射損傷がアニールされ結晶欠陥が回復されたことを示している。またレーザ照射回数を増加するとアニールが進行する事が判明した。
本実験においては、試料全体に対するレーザ照射強度の時間平均は約0.65Wで、実験中の試料の平均温度はほとんど上昇していない。イオン注入したSiCの結晶性回復アニールを熱的に行う場合には、通常1500℃以上まで加熱する必要があることと比較して、レーザ照射によるアニールプロセスの低温化が可能であることが明らかである。

図3 Energy spectra of the χ of the SLII and the reference samples, in which 180keV, 1.26×1015 cm-2 N+ ions were implanted. The scattering angle was 170o. The allows in the figure indicate the Si depth scale from the surface.
(原論文のFig.7)(原論文1より引用)
図3はSLII 法で180 keV、1.26×1015ions・cm-2でN+イオンの注入を行った試料と、リファレンスとしてレーザ照射無しでN+イオンを室温で注入した試料のRBSスペクトルを比較したものである。測定結果は反跳He2+イオン収量で規格化したχ値で表している。図中の矢印と数値は表面からの深さを表している。なお、この実験においては、レーザ出射強度は約110mJ/pulse、光学系によるロスが約50%、照射面積が約0.12cm2であることから、試料表面におけるレーザ光密度は約0.46J・cm-2と推定される。また、レーザのパルス幅は約17nsec、繰返し周波数は100Hzである。
図3に示された結果より通常の室温注入の場合には、イオン注入部のχは表面から深さ約200nm付近で最大値の65%となり、高密度の欠陥が生じていることが分かる。
一方、レーザ同時照射イオン注入法の場合は、表面から深さ約200nm付近でのχ値が5.7%程度と、通常のイオン注入法で注入した試料と比較して、極めて小さい値であった。未注入SiC基板の深さ200nmにおけるχ値は約3%であることから、レーザ同時照射法による試料のχ値5.7%は未注入SiC基板に近い値であり、低損傷イオン注入が実現されていることが確認された。
コメント :
次世代のワイドギャップ半導体として早くから注目されているが、デバイス化するための不純物のドーピングが大きな課題であった。物理的・化学的に安定である一方、一度格子欠陥が出来るとその修復には多くの困難を伴うためである。これまで高温でのイオン注入やイオン注入後の各種アニーリング処理が試みられてきたが、注入による損傷を皆無にすることは出来なかった。
今回のイオン注入とパルスレーザを同時に照射することにより、SiC材料の温度を上昇させることなく非常に低損傷な不純物ドーピングの可能性が確認されたことはSiCデバイスの実用化へと大きく近づいたと云える。しかし、効率面ではまだ多くの課題があり今後の開発に期待される。
原論文1 Data source 1:
イオン注入SiCのパルスレーザアニールとレーザ同時照射による低損傷イオン注入
菱田有二、工藤淳、渡辺正則
イオン工学研究所
真空, Vol. 44, No. 4, 451-455 (2001)
原論文2 Data source 2:
Suppression of implantation-induced damage in 6H-SiC by simultaneous excimer laser irradiation during ion implantation.
Y.Hishida, M.Watanabe, K.Sekine, K.Sugino, J.Kudo
イオン工学研究所
American Institute of Physics, Vol. 76, No. 26, 3867-3868 (2000)
原論文3 Data source 3:
レーザ同時照射イオン注入技術とその応用
渡辺正則、関根幸平、山本喜之
イオン工学研究所
イオン工学ニュース, Vol. 51, No. 7, 7-9 (2002)
キーワード:炭化ケイ素、半導体、イオン注入、レーザ照射、アニール、チャネリング、
Silicon carbide, Semiconductor, Ion implantation, Laser irradiation, Annealing, channeling,
分類コード:010103,010205,010603
放射線利用技術データベースのメインページへ