放射線利用技術データベースのメインページへ
作成: 1999/05/05 梨山 勇
データ番号 :010194
重イオンシングルイベント効果と陽子線シングルイベント効果の関係
目的 :宇宙用半導体のシングルイベント耐性評価試験の簡素化
放射線の種別 :陽子,重イオン
放射線源 :サイクロトロン(10-500MeV)、タンデム加速器(15MV)
フルエンス(率):1010/cm2,
利用施設名 :Brookhaven National Laboratory Tandem accelerator, Harvard Cyclotron Laboratory, Lawrence Berkeley Laboratory Cyclotron
照射条件 :大気中、真空中、室温
応用分野 :宇宙ステーション、人工衛星、ロケット、宇宙機、航空機
概要 :
重イオンSEE試験(Single-Event Effects)の結果から陽子線SEEを推定する方法が述べられている。Rollinsは陽子線SEEの飽和断面積は重イオンSEEの飽和断面積としきい値LET(飽和断面積の10%になるLETの値とする)の関数で表せることを示した。Petersenは、BendelのAパラメータ(陽子線SEEのしきい値エネルギーに相当する)と重イオンSEEのしきい値LETとの間には簡単な一次式の関係があることを導いた。これを用いると、宇宙における陽子線SEE発生確率を約1桁の精度で推定できることを示した。
詳細説明 :
半導体素子のシングルイベント効果(SEE:Single-Event Effects)は,重イオンの入射に起因するものと陽子線の入射に起因するものがある。後者は、陽子線と半導体の構成原子との核反応で生成される重イオンが原因となってSEEを生じるもので,内部線源SEEとも言える。図1に示すように、重イオンSEEはイオンのLETが素子固有の値(しきい値LET)を超えると発生し始め,発生頻度はLETの上昇と共に急速に増大して飽和する(飽和断面積)。LETの代りにエネルギーを使うと,陽子線SEEもこれと類似した傾向を示す(図2)。陽子線SEEの発生頻度(断面積)とエネルギーの関係は,概ねBendelの半経験式で表わすことができる。
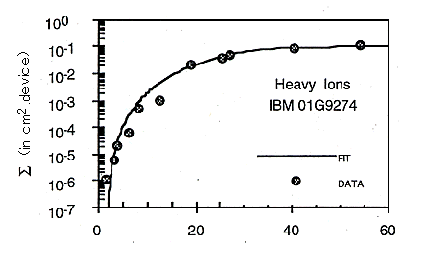
図1 Heavy ion data for IBM 01G9274 4Mbit DRAM(原論文4より引用)
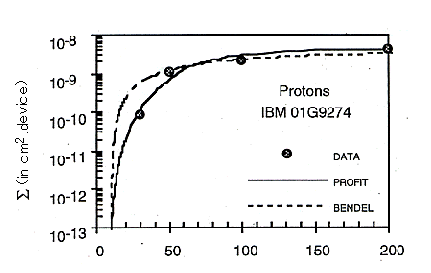
図2 Proton data for IBM 01G9274 4Mbit DRAM.(原論文4より引用)
宇宙で用いる半導体素子は高いエネルギーの重イオンと陽子線に曝される。そのため,宇宙での誤動作を正しく予測するには,重イオンSEEと同様に陽子線SEEについても地上試験を行う必要がある。しかし,両者の相関が分かれば,何れか一方の試験を行うことで他方を推定することが可能になり,地上試験のコストを大幅に低減できる。
陽子線SEEは核反応が関与しているので,理屈では重イオンSEEと単純な関係は無いが,現象とメカニズムの類似性を手掛かりにして,重イオンSEE試験の結果から陽子線SEEを推定する試みが1980年代から行われている。先ず,Rollinsは,陽子線SEEの飽和断面積をAp(cm2/bit),重イオンSEEの飽和断面積としきい値LETをAh(cm2/bit)とL0(MeV/(mg/cm2)),SEE感応領域の厚さをt(mm)とすると,Ap/(Ah・t)はL0の関数となることを示し(図3),以下の経験式を導いた。なお,L0としてSEE断面積がAhの10%となるLETの値を用い,tの典型的な値として5mm(MOS)と2.9mm(bipolar)を用いた。
Ap/(Ah・t)=1.27・10-5・exp(-0.383L01.41)
これを用いて,以下の結論を導いている。1)L0<3MeV/(mg/cm2)では陽子線SEEの発生頻度が一桁高くなる。2)L0>10 MeV/(mg/cm2)なら陽子線SEEは発生しない。3)L0<10 MeV/(mg/cm2)の素子を厳しい条件で使う場合は,陽子線SEE試験を行う必要がある。4)得られる陽子線SEE発生率はファクタ6程度の誤差があるが,大まかな予測には役立つ。
PetersenはRollinsの経験式を新たなデータを用いて再検討したところ,実験値は著しく発散し,重イオンSEEの実験値から陽子線SEE断面積を求めると一桁の不確実さがあること,並びに,放射線耐性強化素子と一般素子を同じ式で表わすことは困難であることを示した。この問題を解決するため, PetersenはL0をBendelのAパラメータ(陽子線SEEのしきい値エネルギーに相当する)としきい値LETを関係付けることを試みた。先ず,Rollinsの式を簡略化して,L0<4 MeV/(mg/cm2)でのみ成立つ関係(Ap/(Ah・t)= 3.0・10-5・exp(-L0))とし,これとBendelの式から,以下のようにAとL0との簡単な関係を導いた。
A=L0+15
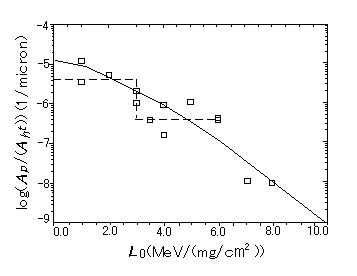
図3 Experimental proton/heavy ion cross section -vs- LET. Experimental points and fitted curves.(原論文2より引用)
この関係を用いて重イオンSEE試験データから陽子線SEE発生率を計算した結果、1)SEE発生率の誤差は約1桁であるが、陽子線SEE試験の必要性を判断する根拠として使用できる。2)L0>10 MeV/(mg/cm2)の素子では、陽子線SEEが発生する確率は低い。しかし、捕捉陽子線の多い軌道ではこれを無視できない。3)高集積度素子では陽子線SEEが相対的に大きくなり、L0>6 MeV/(mg/cm2)の素子に対して陽子線SEE試験は不要であるとする認識は成り立たない。
(参考) Bendelは陽子線SEEの発生断面積(σ)とエネルギー(E)の凡その関係を表わす半経験式を導いた。1012 p/cm2フルエンス,単位ビット当たりのSEE断面積は、
X = (24/A)14(1-exp(-0.18Y0.5))4, Y =(18/A)0.5(E-A)
単位フルエンス,単位ビット当たりのアップセットで表わすと、
σ = Ap(1-exp(-0.18Y0.5))4 = 2.1×107×A-14 (1-exp(-0.18Y0.5))4
ここで、A(MeV)はBendelのAパラメータと呼ばれ,陽子線SEEが発生し始めるしきい値エネルギーに相当する。
コメント :
安価で高性能の民生部品を宇宙用に転用する上で、最大の問題は放射線試験の費用である。そこで、重イオンSEE試験の結果から陽子線SEE耐性を推定できれば効率の良いスクリーニングが可能になる。
原論文1 Data source 1:
Approaches to Proton Single-Event rate Calculations
E.L.Petersen
Senior Member, IEEE
IEEE Trans. on Nucl. Sci. Vol.NS-43, No.2 (1996), pp.496-504
原論文2 Data source 2:
Estimation of Proton Upset Rates from Heavy Ion Test Data
J.G. Rollins
Technology Modeling Associates
IEEE Trans. on Nucl. Sci. Vol.37, No.6 (1990),1961-1965
原論文3 Data source 3:
The Relationship of Proton and Heavy Ion Upset Thresholds
E.L.Petersen
Naval Research Laboratory
IEEE Trans. on Nucl. Sci. Vol.NS-39, No.6 (1992), 1600-1604
原論文4 Data source 4:
An Empirical Model for Predicting Proton Induced Upset
P.Calvel, C. Barillot, P. Lamothe, R. Ecoffet, S. Dyzekkuer and D. Fakgyere
Alcatel Espace
IEEE Trans. on Nucl. Sci. Vol.NS-43, No.6 (1996), 2827-2832
キーワード:シングルイベント効果、重イオン、陽子線、宇宙用半導体、メモリー素子、人工衛星、しきい値LET、反転断面積
single event effect, heavy ion, proton beam, space electronics, memory devices, satellite, threshold LET, upset cross-section
分類コード:010205, 010202
放射線利用技術データベースのメインページへ