放射線利用技術データベースのメインページへ
作成: 1998/11/24 堀野 裕治
データ番号 :010140
負イオンビームのイオン注入・イオンビーム蒸着法への応用
目的 :炭素など負重イオン源の開発と負イオンビームの材料科学への応用
放射線の種別 :重イオン
放射線源 :RFプラズマスタッパー型負イオン源(20kV、数mA)
利用施設名 :京都大学工学部
照射条件 :真空中(10-4Paオーダー)
応用分野 :絶縁体へのイオン注入、炭素薄膜コーティング、TFT製作過程におけるイオン注入
概要 :
材料プロセスに応用するために、重イオン用の負イオン源を開発した。高周波プラズマスパッター方式で、ボロンや炭素など数mAのイオン電流を得ることができる。負イオンをイオン注入などに応用した場合、絶縁体などでチャージアップ電圧が数ボルトと非常に低く、絶縁破壊を起こしにくいなどの特長がある。また、低エネルギーの炭素負イオンで炭素膜を作製した場合、熱伝導率がダイヤモンドに匹敵するアモルファス状の膜を得ることができた。
詳細説明 :
負イオンは電荷のポラリティーが負で、電子親和力は1eVと低く、中性化する過程ではエネルギーを吸収する。電荷が正で、中性化の際エネルギーを放出する正イオンとは異なっている。負イオンでは絶縁材料へのイオン注入の際、表面でのチャージアップ電圧が数ボルトと電圧が低くなり、絶縁破壊を起こす心配がない。また、エネルギーを減速する際に、正のイオンを加速することもない。正イオンの場合は、減速過程で電子を加速することがあり、電圧降下等のために精密なエネルギーが決定できない場合がある。このように負イオンを用いた場合正イオンとは違ういくつかの特長がある。
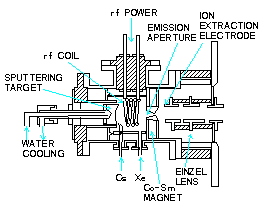
図1 Schematic diagram of r.f.-plasma-sputter-type heavy-negative-ion source.(原論文1より引用。 Reproduced from Surface and Coating Technology 65 (1994) 64-70, Fig.1(p.65), Junzo Ishikawa, Application of negative-ion beams; Copyright(1994), with permission from Elsevier Science.)
これまでに色々なタイプの負イオン源が開発されているが、著者らで開発された高周波プラズマスパッター型負重イオン源の概略図を図1に示す。数百Wの高周波(13.56MHz)によりプラズマ化されたゼノンイオンが数百ボルトの負電圧になっているターゲットの表面をスパッターする。表面にはセシウムが付着されているため、約10%の確率でスパッターされた原子が負イオンとなって放出される。プラズマ中は低い圧力のガスなのでほとんど電子を離すことなく負イオンは通り抜け、引き出し電極(15-20kV)で加速される。引き出し部では垂直に約480Gの弱い磁場をかけ、電子を取り除き負イオンと一緒に加速されないようにしている。これまでの実績(最大引き出し電流と標的材料)は、B2-(1.0mA、LaB6);C-(1.6mA、高純度グラファイト);C2-(2.3mA、高純度グラファイト);Si-(3.8mA、多結晶シリコン);Cu-(12.1mA、無酸素銅)等である。
負イオンビームを絶縁された金属あるいは絶縁体にイオン注入した場合、チャージアップ電圧は数ボルトと低いが、正イオンでは加速電圧まで上昇する。
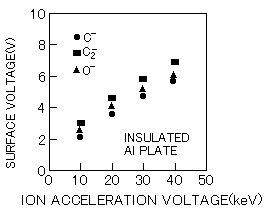
図2 Surface charge-up voltage of insulated aluminium plate as a function of acceleration voltage by C-, C2- and O- negative-ion implantaion.(原論文1より引用。 Reproduced from Surface and Coating Technology 65 (1994) 64-70, Fig.2(p.66), with permission from Elsevier Science.)
図2に絶縁したアルミニウムにC-、C2-、O-イオンを照射したときのチャージアップ電圧をイオンのエネルギーの関数として示す。チャージアップ電圧は正イオンの場合と比べて非常に低く、負イオンのエネルギーとともに少しづつ増加しているのが分かる。この傾向は絶縁されたシリコン基板でも同様である。イオン照射中のガス圧が高くなると衝突により負イオンの電子が剥ぎとられ中性化するものがある。中性原子自体電荷を運ばないが、照射して二次電子を放出する。そのためガス圧が増加すると中性原子の割合が増加し、チャージアップ電圧が増加する。この現象はアルゴンガス圧が1x10-2Pa以上で現れる。真空度が良い状態では、チャージアップ電圧は電流密度が大きくなるに従って徐々に低くなる。
低エネルギーの炭素負イオンビームを直接基板上に堆積させて炭素膜を形成することができる。エネルギーが25〜1015eVのC-、C2-イオンを室温、真空度1.3x10-4Paにて様々な基板に照射して炭素膜の形成を行った結果、滑らかな表面の膜が得られた。高速電子の反射像、光吸収スペクトル、ラマン散乱から形成された膜の構造は完全なアモルファスであった。また、XPSスペクトルからダングリングボンド(不飽和結合)の無いsp3構造を示すことから、ta-炭素膜であることが分かった。

図3 a)Atomic density and b)thermal conductivity of C- and C2- ion beam deposition films as a function of the kinetic energy per atom of incident carbon ion.(原論文1より引用。 Reproduced from Surface and Coating Technology 65 (1994) 64-70, Fig.9(p.69), with permission from Elsevier Science.)
図3にC-、C2-イオンをシリコン基板、ステンレススチール基板に照射して形成した炭素薄膜の原子密度と熱伝導率のイオンエネルギー依存性を示す。これら2つの物理量はダイヤモンドの値とグラファイトの値の間になり、用いたイオンの原子数と1原子当たりのエネルギーに強く依存しているのがわかる。エネルギーが50-100eVで最大になり、C2-で形成した膜の熱伝導率はダイヤモンドの値に同じなる。エネルギーがさらに増加するとこれらの特性は悪くなる。C2-によって形成した膜のほうがC-によって形成した膜よりも特性が良い傾向にあることがわかる。
コメント :
負イオンは核融合やタンデム型加速器などのイオン源として研究開発されてきた。近年、負イオンビームをイオン注入などに応用した場合、正イオンビームを用いた場合に比べいくつかの特長があることが明らかにされ、材料科学への応用が進みつつある。イオンビーム応用の新しい展開としてこれからの研究開発が期待できる。
原論文1 Data source 1:
Application of negative-ion beams
Junzo Ishikawa
Department of Electronics, Kyoto University
Surface and Coating Technology 65 (1994) 64-70.
キーワード:負イオン生成、負イオンビーム、イオン注入、イオンビーム蒸着、IBD、DLC、非晶質炭素、RFスパッター型負イオン源
negative ion formation, negative ion beam, ion implantation, ion beam deposition, amorphous carbon, r.f.-sputter type ion source
分類コード:010305、010206、010102
放射線利用技術データベースのメインページへ