放射線利用技術データベースのメインページへ
作成: 1999/01/15 茶谷原 昭義
データ番号 :010139
プラズマソースイオン注入法による配管コーティング
目的 :プラズマソースイオン注入法による硬質膜コーティング法と配管の内面処理への応用
放射線の種別 :重イオン
放射線源 :プラズマ源
利用施設名 :Wisconsin大学プラズマソースイオン注入装置
照射条件 :ガス中(Ar, N2等)、ガス圧2〜100mTorr
応用分野 :表面被覆、耐摩耗性コーティング、チューブ内面のコーティング、立体形状物の表面処理
概要 :
プラズマソースイオン注入(PSII)は、プラズマ中においた処理物に負の高電圧を加え、イオン注入を行う方法であり、従来のイオンビームを用いる方法とは異なる新しい技術である。この方法はイオン注入のみならずコーティングも行うことができ、広い応用が期待される。イオン照射を併用する成膜方法の特長である強い密着性が得られるとともに、複雑形状物を処理できることが特長である。また、電極配置により配管の内面処理を行うこともできる。
詳細説明 :
プラズマソースイオン注入(PSII)は、表面改質や半導体のドーピングに利用できる比較的新しい技術である。PSIIプロセスでは、プラズマを真空容器内に発生させ、プラズマ中においた処理物に負の高電圧パルスを加える。そうするとプラズマ中のイオンが処理物の表面に引きつけられ、高速となって処理材料の原子の並びの中に注入される。表層にイオン注入することによって、化学結合状態や微細構造を変化させ、これが処理物の表面特性の改善につながる。PSIIプロセスの最大の特長は、従来のイオンビームを用いた注入でないことであり、三次元形状物のイオン注入を低コストで行うことができる。加えて、コーティング層の形成が可能であり、界面でのミキシング効果によって強い密着性が期待できる。
この技術は1988年から世界的に注目され、PIII、PI,IONCLAD, PLADなどいろいろな名称で呼ばれている。

図1 A schematic illustration of the second generation PSII system.(原論文1より引用。 Reprinted with permission from data source 1, (C)1994, American Vacuum Society.)
図1にPSIIシステムの概略を示す。これは、真空容器、ターボ分子ポンプ、クライオポンプ、拡散ポンプ、ガスプロセスシステム、コンピュータによる制御パネルおよび高電圧パルスシステムからなる。
PSIIに基づいた堆積プロセスはEIAMAD(energetic ion assisted mixing and deposition)と呼ばれている。
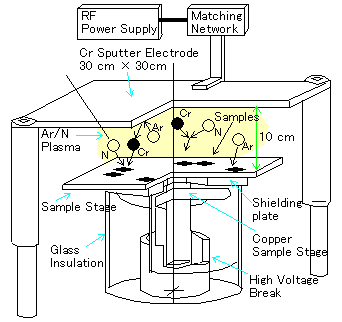
図2 Experimental setup used for producing PSII-EIAMAD coatings, e.g., TiNX, CrNX, and TaN on planar samples.(原論文2より引用。 Reprinted with permission from data source 2, (C)1997, American Vacuum Society.)
図2にPSII-EIAMADプロセスの装置図を示す。図において、スパッタカソード(ターゲット)は高周波電源によってRFが供給され、セルフバイアスが発生する。カソード(ターゲット)には直接直流DCバイアスを加えることができ、同時にRFとDCを加えることもできる。カソード(ターゲット)からスパッタされた元素は、パルス列が加えられている基板上に堆積する。ガスとして窒素・アルゴンが用いられる場合、これらのプラズマは、Ti,Cr,Ta等のスパッタされた元素とともに2つのはたらきをする。つまり、(i)カソードからのスパッタと(ii)基板上でのミキシングである。
PSII-EIAMADプロセスはTiN、CrN、DLC(ダイアモンドライクカーボン)薄膜などの硬質コーティングに用いられる。PSIIプロセスで基板表面の前処理:不純物や酸化膜の除去はアルゴンプラズマを用いたスパッタによって行う。このプラズマクリーニングは強い密着性を得るために効果的である。PSII-EIAMADによる化合物薄膜の合成は、望みの金属元素のスパッタカソード(ターゲット)と反応性ガスとアルゴンガスの混合プラズマを用いて行う。通常、希ガスとしてアルゴン、ネオン、クリプトンが、また、反応性ガスとして窒素、メタン、酸素が使われる。

図3 Experimental setup used for producing DLC films on the inner surface of a cylinder.(原論文2より引用。 Reprinted with permission from data source 2, (C)1997, American Vacuum Society.)
図3に円筒状基板つまりチューブの内面を処理する場合の装置を示す。円筒状基板はセラミック支持台に置かれ、中心電極はそれと独立してセラミックで支持されている。電気的には、RF電力用導入端子と基板に加える高電圧用導入端子を通して接続されている。円筒状基板の内面に薄膜を形成する時の要点は、同軸構成を用いることと、中心電極はRFバイアスが加えられるか、またはアース電位にすることである。中心スパッタカソード(ターゲット)としてチタン棒を用いると、PSII-EIAMADプロセスによってTiN薄膜を円筒内面に形成できる。DLC薄膜を形成する場合は、アセチレンガスを用い、窒化物コーティングの場合は、6%窒素-アルゴン混合ガスを使う。
本方法を用いて内径10cm、外形13cm、長さ50cmの中空円筒(パイプ)試料の内面にDLCをコーティングした場合の、長さ方向の膜厚分布を調べた結果、中心から±12cmでは数%以内で一様で、両端でも±30%内になってることが分かった。TiN薄膜を形成した場合でもほぼ同様の膜厚分布を得ることができた。
コメント :
PSIIプロセスは、イオン照射による表面改質を産業レベルで実用化できる有用な手段であり、今後の広範な応用が期待される。イオンビームによるイオン注入、イオンプレーティング法、イオンビームダイナミックミキシング法に続く技術である。
原論文1 Data source 1:
Overview of plasma source ion implantation research at University of Wisconsin-Madison
S.M. Malik, K.Sridharan, R.P. Fetherston, A. Chen, J.R. Conrad
Department of Nuclear Engineering & Engineering Physics, University of Wisconsin
J. Vac. Sci. Technol. , B12, 2(1994), 843-849
原論文2 Data source 2:
Development of an energetic ion assisted mixing and deposition process for TiNx and diamondlike carbon films, using a co-axial geometry in plasma source ion implantation
S.M. Malik, R.P. Frtherston, J.R. Conrad
Department of Nuclear Engineering & Engineering Physics, University of Wisconsin
J. Vac. Sci. Technol. , A15, 6(1997), 2875-2879
キーワード:イオン注入、プラズマ、表面改質、コーティング、
ion implantation、plasma、PBII、surface modifiction, coating
分類コード:010304、010302、010108
放射線利用技術データベースのメインページへ