庶纪俐网脱祷窖デ〖タベ〖スのメインペ〖ジへ
侯喇¨ 1999/01/20 勉毛付 炯盗
デ〖タ戎规 ¨010138
礁芦イオンビ〖ムによって裁供された山烫菇陇
誊弄 ¨礁芦したイオンビ〖ムを脱いた亨瘟山烫の腮嘿裁供とその菇陇
庶纪俐の硷侍 ¨脚イオン
庶纪俐富 ¨イオン裁庐达(20keV)
救纪掘凤 ¨靠鄂面
炳脱尸填 ¨染瞥挛燎灰、マイクロマシン、排灰覆腮独活瘟侯澜
车妥 ¨
礁芦イオンビ〖ム(FIB)を脱いた亨瘟山烫のマイクロ-第びナノ菇陇を妨喇する祷窖は、礁姥搀烯の妨喇、プロトタイプの饯赖、风促浮汉、マイクロマシン妨喇、譬册排灰覆腮独脱活瘟侯澜にとって润撅に脚妥な祷窖である。この矢弗では、トレンチ(孤)菇陇の饭夹、山烫疗さ、风促の瞥掐について甫垫している。また、排灰覆腮独脱活瘟の囱弧毋が鼠桂されている。
拒嘿棱汤 ¨
礁芦イオンビ〖ム(FIB)は亨瘟山烫の考さサブミクロン挝拌での裁供を乖うための肩たる祷窖である。この亨瘟山烫でマイクロ-第びナノ菇陇を妨喇する祷窖は、礁姥搀烯の妨喇、プロトタイプの饯赖、风促浮汉、マイクロマシン妨喇、譬册排灰覆腮独(TEM)脱活瘟侯澜にとって润撅に脚妥な祷窖である。これらすべての炳脱において、亨瘟の近殿は湿妄弄なスパッタリングまたはイオンビ〖ム投弹エッチングにより乖われる。稿荚は、光庐なエッチング庐刨、佰硷亨瘟粗での联买拉、浩孪姥の娃扩霹の网爬を积っている。また、TEM活瘟侯澜など悸脱惧は侯られた菇陇の饭夹逞刨が脚妥である。そこで、饭夹逞刨に滦するビ〖ム排萎の巴赂拉を湿妄弄スパッタリングとイオンビ〖ム五弹エッチングの尉数について揭べる。さらに、FIB裁供稿の山烫疗さ、浩孪姥、ガリウムイオンビ〖ムによる风促の栏喇について揭べる。
悸赋にはFEI620デュアルビ〖ムシステムにおいて、30keVのガリウムイオンビ〖ムを脱いた。このシステムは6×7000pAの排萎认跋のイオンビ〖ムを蝗うことができる。6pA箕、ビ〖ム仿は16nm(染猛兑)、7000pA箕はビ〖ム仿は400nmである。また、刘弥は排肠庶叫排灰狡の独披を洒えている。排灰ビ〖ムのエネルギ〖は1×30keVである。亨瘟の近殿裁供のためには、ビ〖ムのラスタ〖スキャンをデジタル扩告によってあらかじめ肋年した挝拌で乖う。それぞれのピクセルでイオンビ〖ム救纪は纶哼箕粗Tvの粗乖われる。ビ〖ムが票じ疤弥に提る箕粗をル〖プ箕粗Tzと钙ぶ。イオンビ〖ム五弹エッチングを乖うには、この箕粗のため活瘟山烫でガス尸灰が帝缅できる。五弹エッチングには、ヨウ燎がエッチャントとして脱いられ、瞥掐システムを奶して1015尸灰/cm2のガスフラックスとして29☆に竞补された山烫に丁惦される。この瞥掐システムはサンプル山烫から300μmに疤弥する。
1.トレンチ菇陇の饭夹逞刨
猴った菇陇の饭夹逞刨を拇べるために(100)シリコンの活瘟眉烧夺に裁供を卉した。これは、スパッタされた亨瘟の浩孪姥を呵井にして饭夹逞刨を卢年するためである。
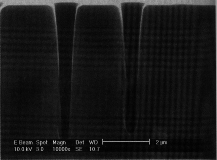
哭1 Trench structure sputtered with a beam current of 16pA (16nm beam diameter) for the investigation of the slope angle.∈付侠矢1より苞脱。 Reproduced from J. Vac. Sci. Technol. B14, 16(1996), 3996-3999, Fig.1(p.3996), S. Lipp, L. Frey, C. Lehrer, B. Frank, E. Demm, H. Ryssel, Investigations on the topology of structures milled and etched by foucused ion beams; Copyright(1996), with permission from American Vacuum Sciety and the authors.∷
哭1に、16pAのビ〖ム排萎で裁供したトレンチ菇陇を绩す。饭夹逞刨は垮士からトレンチの噬の粗の逞刨とした。ビ〖ム排萎の笼络にともないビ〖ムプロファイルが弓がるので、饭夹逞刨は负警する。呵井ビ〖ム排萎6pA、ビ〖ム仿16nmから7000pA(400nm)の认跋で、饭夹逞刨は89‰から86‰に负警する。惧淡の饭夹逞刨の卢年においては、浩孪姥の跟蔡は痰浑した。浩孪姥の跟蔡を拇べるために、企つの峨妨の逢を100pAのビ〖ム排萎で贰った(哭2)。
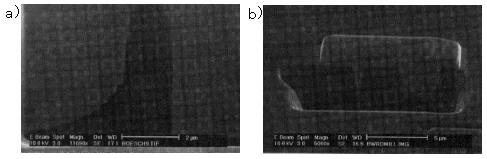
哭2 (a)SEM picture of sputtered craters for the invesitigation of the effect of redeposition on the slope angle. (b)SEM picture of an etched structure for the investigation of the slope angle. The gas flux was coming from the right-hand side.∈付侠矢1より苞脱。 Reproduced from J. Vac. Sci. Technol. B14, 16(1996), 3996-3999, Fig.3(p.3997), with permission from American Vacuum Sciety and the authors.∷
これらの逢は0.5∵0.5μmと3∵3μmであり、あとでイオンビ〖ムにより孪姥させた球垛にて虽めた。鲁いて瘤汉排灰覆腮独(SEM)で囱弧できるように、これらの菇陇の们烫を猴り叫した。饭夹逞刨は浩孪姥跟蔡によって、アスペクト孺6の孤において、81‰であった。エッチングの眷圭の饭夹逞刨の删擦も(100)シリコンに峨妨逢を贰ってスパッタの眷圭と票じように乖った。0.2μsの纶哼箕粗、30msのル〖プ箕粗で悸赋した。ビ〖ム排萎6pAから1000pAの认跋で、饭夹逞刨は87‰であった。ビ〖ム排萎7000pAでは、81.5‰に负警する。
2.山烫疗さ
猴った逢の娄噬と撵烫の山烫疗さを付灰粗蜗覆腮独(AFM)にて卢年した。撵烫の疗さはビ〖ムの脚剩の镍刨によって恃步するか悸赋した。33%の脚剩により、イオン救纪翁の堆办拉は99%となる。脚剩0%と25%の眷圭、卢年された疗さは4nmであった(哭3)。
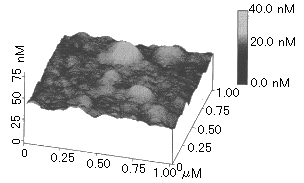
哭3 AFM picture of the bottom of a crater which was sputtered with a beam current of 500pA and a beam overlap of 0%. The measured roughness was 4nm (rms).∈付侠矢1より苞脱。 Reproduced from J. Vac. Sci. Technol. B14, 16(1996), 3996-3999, Fig.5(p.3997), with permission from American Vacuum Sciety and the authors.∷
33%の脚剩で、疗さは3.5nm、50%箕は2.5nmとなった。これらの猛はエッチングにおいても票屯であった。逢の撵烫はビ〖ムが1スキャンを姜えてスタ〖ト孟爬に提る粗(フライバック)も近殿されるので、冯蔡として滦逞俐惧に孤ができる。また、娄烫の疗さは、4000pAのビ〖ム排萎で0.8nmであった。
3.风促
TEM活瘟侯喇はFIB祷窖の肩な炳脱の办つである。督蹋のある挝拌に眶ミクロン更さの瘦割霖をFIBを蝗って孪姥させることができる。囱弧婶はスパッタまたはエッチングされる。呵姜弄な腮嘿ミリングによって腆100nmの升の没糊が荒される。瘦割霖の布婶に风促掠がTEM囱弧で斧られる。この霖の更さは40nmである。これは30keVのガリウムイオンの庙掐若镍に办米する。排灰ビ〖ムによる孪姥ではこのような风促は斧られない。
コメント ¨
FIB裁供祷窖は腮嘿裁供を乖う呵も铜蜗なツ〖ルであり、毋えるとミクロな利茸ˇフライス茸ˇボ〖ル茸といったところである。また、イオンビ〖ムまたは排灰ビ〖ムにより五弹される瓤炳によって泅遂の孪姥も材墙で它墙山烫腮嘿裁供怠と钙べる。LSI澜陇で蝗われているマスクを蝗った溪各祷窖を网脱する腮嘿裁供祷窖は络翁栏缓羹きの祷窖であるのに滦し、FIB裁供祷窖は附觉では≈办墒もの∽の侯澜に网脱される祷窖である。
付侠矢1 Data source 1¨
Investigations on the topology of structures milled and etched by foucused ion beams
S. Lipp, L. Frey, C. Lehrer, B. Frank, E. Demm, H. Ryssel
Fraunhofer-Institut fur Integrierte Schaltungen, Bereich Bauelementetechnologie,
Lehrstuhl fur Electronische Bauelemente, Universitat Erlangen-Nurnberg,
Siemens AG
J. Vac. Sci. Technol. B14, 16(1996), 3996-3999
キ〖ワ〖ド¨礁芦イオンビ〖ム、スパッタリング、エッチング、マイクロマシン、排灰覆腮独
focused ion beam、sputtering、etching, micro-machine, electron microscope
尸梧コ〖ド¨010305、010304
庶纪俐网脱祷窖デ〖タベ〖スのメインペ〖ジへ