作成: 1999/01/20 堀野 裕治
データ番号 :010137
半導体のアモルファス-結晶界面での高速イオンビーム照射によるアニーリング
目的 :半導体などのアモルファス-結晶界面での低温再結晶化技術の開発
放射線の種別 :重イオン
放射線源 :イオン加速器(200kV)、イオン加速器(1.5MeV)
フルエンス(率):1x1015/cm2〜1x1017/cm2
利用施設名 :オーストラリア国立大学理工学部電子材料工学科加速器
照射条件 :真空中、15℃〜400℃
応用分野 :低温半導体結晶成長、電子デバイス作製、照射損傷回復技術
概要 :
MeVの高速重イオンビームを照射して、アモルファス状のSi、GaAs、InPや金属シリサイド層の再単結晶化を行った。結晶化の機構と再結晶化した層の品質を炉による熱的に行ったもの場合とで比較した。イオンビームを用いた場合、低い温度で結晶化するなどの特長があるが、両者で最も際だった違いは、InPとInを多量にイオン注入したSiで観察され、イオンビームアニーリングの方が低い温度で、より高い品質の単結晶を得ることができた。
詳細説明 :
Si基板の表面にイオン照射により形成されたアモルファスSiが、150℃以下の温度で高エネルギーMeVイオンビーム照射により結晶整合性良く再結晶化する。この現象をイオン誘起結晶化プロセスあるいはイオンビームアニーリングといい、その再結晶化速度はアモルファス-結晶界面上に付与される核的エネルギー付与率(入射したイオンビームが単位長さ当たりに、主に格子原子の動きとして費やすエネルギーの量)に依存し、温度には大きくは依存しない。その場合の活性化エネルギーは約0.24eVである。さらにイオン誘起結晶化はアモルファス層中の不純物等に余り影響されない。そのため、通常、熱的に結晶化することが難しい高濃度の不純物を含む材料などに有効で、アモルファスSiだけでなく、高ドーズ注入Si、GaAs、InPなどの化合物半導体や金属シリサイドなどに応用できるのが特長である。

図1 Schematic illustration of epitaxial crystallization of (a) an initial surface amorphous layer, (b) by thermal annealing and (c) MeV ion-beam annealing.(原論文2より引用。 Reproduced from Nuclear Instruments and Methods in Physics Research B55 (1991) pp602-606, Fig.1(p.602), J.S. Williams, M.C. Ridgway, R.G. Elliman, J.A. Davies, S.T. Johnson, G.R. Palmer, MeV ion-beam annealing of semiconductor structures; Copyright(1991), with permission from Elsevier Science.)
図1に実験の概念図を示す。アモルファス層(20〜100nm)は低温で低エネルギー(15〜50keV)のSi、Pイオンビーム等を照射量〜1015/cm2程度照射して形成する。b)のように、熱的に結晶整合性良く再結晶化させる場合は高い温度が必要であるが、c)のようにMeVイオンビームを照射することにより、低い温度で結晶整合性良く再結晶化させることができる。
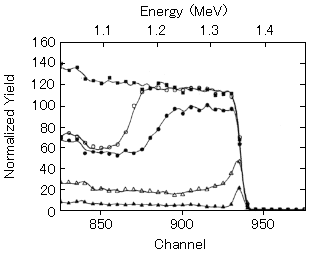
図2 RBS-C spectra illustrating the quality crystallization of a 〜100nm amprphous layer on (100) InP (○), during furnace annealing at 260℃ (●), compared with ion-beam annealing with 1.5 MeV Ar+ at 145℃ (△). A virgin InP spectrum is also shown (▲).(原論文2より引用。 Reproduced from Nuclear Instruments and Methods in Physics Research B55 (1991) pp602-606, Fig.4(p.605), with permission from Elsevier Science.)
図2にInPを用いた場合の結果を示す。InP基板に低速イオン照射により形成した約100nmのアモルファス層の初期状態(○)、その試料を260℃で炉で熱的にアニーリングした場合(●)、あるいは145℃で1.5MeV Ar+を照射した場合(△)のRBS-チャンネリングスペクトルを示す。(▲)はアモルファス層形成前のInP基板の初期状態である。チャンネリングでは結晶性が良いと散乱を起こさず、散乱収率が低くなるが、このスペクトルから加熱のみではあまり再結晶化が進んでいないが(収率が大きい)、低温での高エネルギーアルゴンイオンビームの照射により、ほぼInP基板の初期状態まで再結晶化が起こっていることが、○の収率が△まで低くなっていることから分かる。
表1 Comparison of the epitaxial growth kinetics and growth quality of a number of semiconductor structures annealed thermally and with MeV ion beams.(原論文2より引用。 Reproduced from Nuclear Instruments and Methods in Physics Research B55 (1991) pp602-606, Tab.1(p.605), with permission from Elsevier Science.)
--------------------------------------------------------------------------------------
sample Furnace annealing Ion-beam annealing Advantages of ion-beam annealing
------------------ -------------------
Temp. Eact Temp. Eact
[℃] [eV] [℃] [eV]
--------------------------------------------------------------------------------------
Si(100) ≧550 2.7 ≧200 0.2-0.3 Less sensitive to impurity effects
Ge(100) ≧330 2.0 ≧150 0.2-0.3 Similar to Si
Si-Ge 330-550 1.8-2.7 ≧200 0.2-0.3 Improved epitaxial growth for high
on Si(100) Ge content alloys on Si;
preserves strained layers
GaAs(100) ≧250 1.6 ≧ 75 〜0.17 Slightly improved growth but
dislocations introduced
InP(100) ≧200 1.6 ≧150 0.15 Greatly improved growth but
dislocations introduce
NiSi2 ≧ 80 1.1 ≧ 0 0.26 Can induce epitaxial growth but also
on Si(111) high levels of ion-beam-induced defects
CoSi2 ≧100 1.2 ≧ 40 0.21 Similar to NiSi2
on Si(111)
--------------------------------------------------------------------------------------
表1にイオン誘起結晶化プロセスについて、熱的なアニーリングの場合との比較とともにまとめている。各物質で、熱的に比べて低い温度で再結晶化する。この低温でのイオン誘起結晶化は熱アニールのみの場合と比べて、特に、多量注入された試料や化合物半導体の場合に結晶性に関して有利である。例えば、Geの量が20%を越える場合、イオン誘起結晶化ではシリコン基板から結晶整合性良く再結晶化が進むが、シリコンとSi-Ge(20%)合金とでは結晶化温度が大きく違うために、熱炉による加熱のみでは多結晶化するだけで再結晶化を実現することはできない。シリサイドの場合、NiSi2、CoSi2とも50℃以下の温度による高エネルギーイオン照射で再結晶化することができる。この際、基板のシリコン表層がアモルファス化され、結晶Si/アモルファスSi/結晶化シリサイドの構造になる。さらに、高エネルギーイオン照射により基板で誘起される欠陥等のために、再結晶化されたシリサイドの品質は熱炉による加熱のみで得られたもの程良くはない。
表1にはそれぞれの場合の活性化エネルギーもリストしている。ここでは、イオン誘起結晶化の活性化エネルギーが熱のみの場合と比べて1/5〜1/10になっているのが分かる。このことはイオンビームにより、熱に関係なく、アモルファス-結晶界面に成長核が導入されることを示しており、これが活性化エネルギーの高エネルギー成分を構成する。さらに興味あることは、金属的であるシリサイドでも、イオン誘起再結晶化の場合、半導体と同じような小さい活性化エネルギーを示しており、シリサイドの共有結合的な面を反映しているものと考えられる。
コメント :
実際の産業的プロセスに応用された例はまだ無いが、プロセスの低温化や化合物半導体にも応用が期待できることから、高速イオンビーム照射による再結晶化の研究は研究室レベルから応用へと拡がりを見せ始めている。イオンビームが発生する欠陥等の複雑な相互作用のため、統一されたモデルはまだ確立してないが、イオンと固体との相互作用を理解する上でも興味ある現象である。
原論文1 Data source 1:
Ion-beam-induced crystallization and amorphization of silicon
R.G. Elliman, J.S. Williams, W.L. Brown, A. Leiberich, D.M. Maher, R.V. Knoell
CSIRO Chemical Physics, Australia
Nuclear Instruments and Methods in Physics Research B19/20 (1987) pp435-442
原論文2 Data source 2:
MeV ion-beam annealing of semiconductor structures
J.S. Williams, M.C. Ridgway, R.G. Elliman, J.A. Davies, S.T. Johnson, G.R. Palmer
Research School of Physics, Australian National University
Nuclear Instruments and Methods in Physics Research B55 (1991) pp602-606
キーワード:MeVイオンビーム、イオンビームアニーリング、RBS-チャネリング、イオン照射、重イオン、IBIEC
MeV ion beam、ion beam annealing、RBS-channeling、ion beam irradiation, heavy ion, IBIEC
分類コード:010205、010304、010103