作成: 1997/12/23 堀野 裕治
データ番号 :010086
低エネルギー正・負イオンビーム同時照射による成膜装置
目的 :極低エネルギーのイオンビームを用いた薄膜形成のための新らしい装置開発
放射線の種別 :軽イオン,重イオン
放射線源 :正イオンビームライン(20keV、50μA)、負イオンビームライン(20keV、20μA)
フルエンス(率):1018/cm2
線量(率) :10μA
利用施設名 :大阪工業技術研究所正・負イオン物質合成装置
照射条件 :真空中、室温
応用分野 :表面コーティング、新物質合成、表面改質、高純度薄膜形成
概要 :
低エネルギーの正と負のイオンビームを同時に照射して材料を合成するイオンビーム蒸着法。エネルギー範囲は10eVから100eV程度である。両極性のイオンビームを同時、交互、あるいは独立に照射が可能である。本装置は超高純度材料や通常プロセスでは実現困難な材料(例えば、窒化炭素やダイヤモンド薄膜等)の合成など広い可能性を持っている。また、イオンビーム成膜過程や固体とイオンとの相互作用など基礎的な研究にも有用である。
詳細説明 :
本方法は10-100eV程度と低いエネルギーを持つイオンビームを用いた物質合成法(Ion Beam Deposition、IBDと呼ばれる)で、低エネルギーのイオンビームを基板に照射し、直接成膜を行うものである。低いといっても、化学反応のエネルギー(数eV)に比較して高く、120eVの炭素イオンビームによるダイヤモンド薄膜の合成など、通常のプロセスでは実現が難しい物質の合成ができる。さらに、磁場等により高い分解能で質量分離することが可能で、超高真空技術と組み合わせると同位体レベルでの高純度物質の合成ができる。ほとんど正の電荷のみが用いられてきたが、本方法は質量分離した正と負イオンとを用いる新しいイオンビーム直接成膜法である。従来のIBD法が持つ特長に加え、2元系化合物の直接合成ができ、新材料合成が期待できる。また、絶縁物基板上へのチャ-ジアップ・フリ-な成膜ができる。実際、絶縁物基板上に成膜するときにはチャ-ジ・アップが生じ、膜質を損なう場合があった。表1(a)に装置の特長をまとめた。
表1 (a)正・負イオンビームを用いた物質合成法のチャームポイント、(b)装置の仕様
--------------------------------------------------------------
(a)
1) 全てイオンビームによる物質合成
2) チャージアップの低減
3) 同位体レベルでの高純度化
4) パラメーターの精密制御(組成、構造の制御)
5) イオンビーム合成の基礎研究
6) イオンと固体との相互作用の基礎研究
--------------------------------------------------------------
(b)
正イオン C+、N+、O+、等
負イオン H-、C-、C2-、CN-、O-、Si-、Ni-、Au-、等
エネルギー範囲 10eV 〜 20keV
電流値 10μA以上(10eV C± ion)
ビームサイズ 10mmφ以上
到達真空度 6.7x10-8Pa以下 (Oil free)
基板温度 〜1000℃
--------------------------------------------------------------
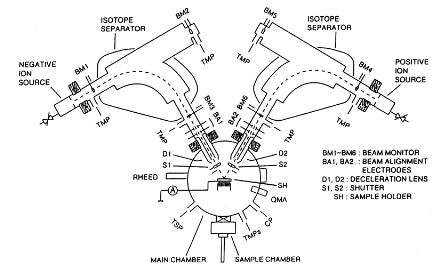
図1 Schematic view of the positive and negative-ions deposition apparatus(原論文1より引用)
両ビ-ムラインに電磁石による質量分離器を採用した。正及び負イオンビームの同時照射や交互照射、独立照射による成膜を行うことができる。正・負イオン物質合成装置の全体構成図を図1に示す。装置は正イオンビームライン、負イオンビ-ムライン及び成膜室等から成っている。また両ビ-ムラインはイオン源、イオンビーム輸送系(質量分離部を含む)及び減速系から成る。両ビ-ムの試料面への入射角度は、それぞれ試料法線に対して30度である。
正イオン源には一般に用いられているマイクロ波放電型イオン源を用いた。プラズマ生成室内に導入されたガスは、このマイクロ波による電子加熱と同軸磁界による閉じ込め効果によってプラズマ化する。フィラメントを使用していないので酸素やハロゲン元素などの活性ガスも長時間安定して放電できる。負イオン源には炭素やシリコン等の負イオンを発生できるようにプラズマスパッタ型のイオン源を開発した。目的とするイオンの標的(直径27mmの円板。例えば、炭素ならグラファイト板)を円筒型のマルチカスププラズマ室内に設置し、アルゴンプラズマでスパッタして負イオンを得る方式である。プラズマ放電はカソードであるフィラメントとアノードであるプラズマ容器の間で定常的に維持される。標的にはアノードに対して負の電圧を印加し、アルゴンを加速する。また、この電圧が最終的な負イオンビームのエネルギーを決定する。標的表面の仕事関数を低くし、負イオンの生成効率を向上させるために、イオン源内にはセシウム蒸気を導入するようになっている。
低エネルギーのイオンビームを得る方法は、加速によって引き出して減速する方法である(参考資料1)。本装置では正、負両イオンビームを用いるため、試料基板をア-ス電位とし、それに対して、イオン源に希望の電圧を印加し、それで最終的なイオンのエネルギーを決定する。イオン源で発生したイオンは引き出し電極系によって約20keVまで加速されて質量分離用電磁石に導かれ、質量分離された特定の同位体イオンのみが減速レンズ系に入り、試料基板直前で減速されて、最終エネルギーになり、基板に照射される。照射イオンのエネルギーと質量はエネルギー分析器と四重極質量分析器の組み合わせにより成膜の前後で精度良く確認されている。

図2 (a)Mass spectrum of positive nitrogen ion beam extracted from N2 gas discharge and (b)Mass spectrum of negative carbon ion beam extracted from graphite target.(原論文1より引用)
図2に窒素正イオン、炭素負イオンの質量スペクトルを示す。各々10μA程度以上の電流値があるのが分かる。シリコンの場合、質量数28、29、30の同位体が分離されており、同位体的にも純度の高い成膜ができる。これまでに実績のあるイオン種は正イオンでC+、N+、O+等、負イオンでC-、O-、Si-、Ni-、Au-等である。本装置の仕様を表1(b)にまとめた。本装置を用いて、負炭素イオンと正窒素イオンとの同時照射を行い、最大の組成比が約0.9で非晶質構造を持つ窒化炭素膜の合成に成功した。また、ダイヤモンドライクカーボン(DLC)によるコーティングや超高純度を持つ金属薄膜、新しいAu-N化合物の合成の研究が進んでいる。
コメント :
低エネルギーイオンビームデポジションは、非熱平衡でダイヤモンド薄膜や超高純度金属膜形成などで最近話題の技術である。正・負の両イオンを用いる当該技術はその最先端の一つの技術であり、今後の研究開発により色々な話題を提供できると思われる。
原論文1 Data source 1:
正負イオンビーム同時照射による成膜
堀野 裕治
大阪工業技術研究所
表面科学,,Volume 18, Number 12 (1997), pp.775-779
参考資料1 Reference 1:
Simultaneous Mass-Analyzed Positive and Negative Low-Energy Ion Beam Deposition Apparatus
Y. Horino, N. Tsubouchi, K. Fujii, *T. Nakata and *T. Takagi
Osaka National Research Institute, *Ion Engineering Research Institute Corporation
Nuclear Instruments & Methods, B106(1995), pp.657-661.
キーワード:イオンビーム堆積、負イオン、デュアルイオン同時照射、低エネルギーイオン、イオン固体相互作用、窒化炭素、表面改質
ion beam deposition, negative ions, dual ion beam irradiation, low energy ion beam, ion solid interactions, carbon nitride, DLC, surface modification
分類コード:010305, 010302