放射線利用技術データベースのメインページへ
作成: 1997/12/18 堀野 裕治
データ番号 :010085
高エネルギー炭素イオン注入法によるSiC埋め込み層の形成
目的 :高エネルギーイオン注入法を用いた埋め込み層形成法の開発
放射線の種別 :重イオン
放射線源 :イオン加速器(3MeV、100μA)
フルエンス(率):1.5x1018 ions/cm2 (10 - 30 μA)
利用施設名 :大阪工業技術研究所タンデム型加速器(NT-1500)
照射条件 :真空中、室温及び880℃
応用分野 :SiCウェハー作製、セラミックス加工、半導体素子、材料微細加工
概要 :
高いエネルギーの炭素イオンを室温又は高温でシリコン基板に注入し、形成した埋め込みSiC層の構造を評価した。イオンのエネルギーが1.5MeVの場合、シリコン基板中に表面から約1.9μmの深さに最大炭素濃度を持つ3C-SiC層(β型SiC)が形成された。形成したSiC層は多結晶から成り、室温注入後アニールしたものが任意の結晶方位を持つのに対して、880℃での高温注入では基板の結晶方位を保っていることがわかった。
詳細説明 :
MeV程度の高いエネルギーのイオン注入では材料表層改質が表面からミクロンオーダーの深さにわたって起こるのが特長である。あるエネルギー以上ではエネルギーの増加とともにスパッタ率が減少するので、イオン注入に伴うスパッタリングによる表面のエッチングは少なくなる。シリコンに炭素イオンを照射した場合のスパッタ率は計算値により、40keVでは0.5であるのに対して、1.5MeVでは6×10-3と非常に小さくなる。従って、多量にイオン注入しても表面は後退せず、注入飛程近傍で化合物が埋め込み層として、一種の固相成長する。ここではシリコン基板に高エネルギー炭素イオンを注入して形成した埋め込みSiC層の特性について、室温注入した後アニール処理した場合と、高温で注入して形成した場合とを比較した。
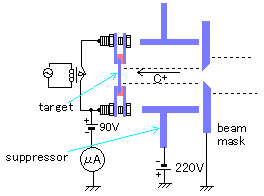
図1 The arrangement of the target, secondary electron suppressor and beam mask.(原論文1より引用)
注入に用いたイオンは1.5MeV C+イオンで、シリコン基板表面に対して垂直に照射した。照射時の真空度は10-4Pa以下である。シリコン基板の加熱はそれ自体に直接通電する方法により行った(図1)。試料温度は赤外放射温度計を用いて計測し、注入中一定に保った。室温で注入する場合は、イオン照射に伴う昇温を避けるため、試料はアルミニウム製の水冷ホルダー上に銀ペーストを用いて接着した。室温注入した試料は窒素雰囲気中でアニールした。以降、880℃で注入した試料を高温注入試料と称する。
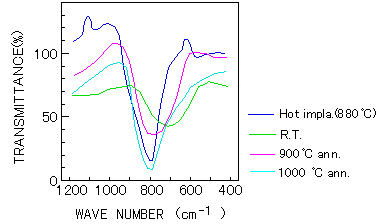
図2 Infrared absorption spectra of SiC synthesized by MeV implantation.(原論文1より引用)
図2に試料の赤外吸収スペクトルを示す。室温注入したものは700cm-1にブロードな吸収があり、これはアモルファスSiC中のSi-C伸縮振動による吸収と考えられる。この吸収ピークはアニールによって高波数側へ約800cm-1までシフトする。このシフトの様子は低エネルギーイオン照射によって合成されたSiCでも観察されている。高温注入の場合も800cm-1に吸収を示す。これらの800cm-1付近の吸収はバルクのSiC結晶のTOフォノンによる吸収に対応するので、アニールまたは高温注入によってSiC結晶が形成されていると考えられる。いくつかのSiCの形態、(a)シリコンの核を持ったもの、および(b)中空のSiC微粒子、(c)シリコン中のグラニュラ状SiC、(d)SiC薄膜、の4形態の場合の赤外吸収スペクトルを文献より引用して比較した結果、(d)に非常に近いことから、本方法で形成したSiCは層状になっていると推測される。
注入された炭素の深さ分布を調べるためRBS法(Rutherford backscattering)で測定した結果、室温注入試料では、注入された炭素は最大濃度66%、半値幅0.41μmのほぼガウス分布で埋め込み層が形成されていることがわかった。高温注入の場合は炭素の最大濃度および半値幅は各々46%、0.55μmであった。また、高エネルギーイオン注入の特徴として、イオンが通過した表面層での結晶損傷が少ないことが挙げられるが、室温注入した場合でも表面近くのシリコン層ではチャネリング(イオンビームの進行方向と結晶の軸が平行になるとイオンと結晶構成原子との散乱収率が極端に減少する現象)が起こっており、結晶性が保たれていることが分かった(参考文献1)。
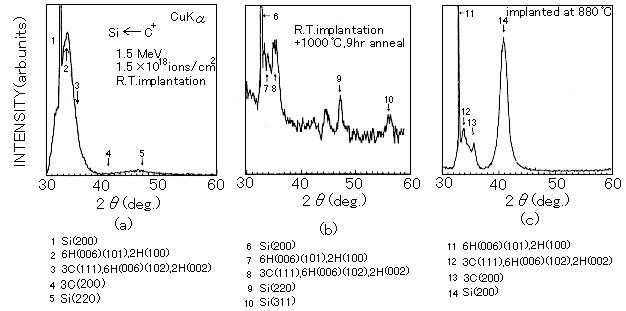
図3 X-ray diffraction spectra: (a)implanted at room temperature, (b)annealed at 1000℃ after R. T. implantation, (c)implanted at 880℃.(原論文1より引用)
X線回折スペクトルを図3(a)〜(c)に示す。室温注入した場合は、図3(a)のように幅広い回折ピークを示し、赤外吸収スペクトルから予想されたようにアモルファス構造のSiCが形成されていることがわかる。アニール後は図3(b)のように種々のSiC多結晶形からの回折が見られるとともに、シリコン基板自体の(220)、(311)面からの回折も見られ、多結晶として再結晶化したシリコンの存在を示している。図3(c)に示す高温注入した場合は、3C-SiC(200)の回折ピークが際だっていることから、シリコン基板(100)面と平行にSiC(100)面が成長していると考えられる。このSiC(200)ピークの半値幅から歪みなどを考慮せずに単純にScherrerの式から粒径を求めると6nmであった。SiC(100)配向の程度はロッキングカーブによって確かめられる。シリコン基板からの(200)禁制反射を示したものであり、(100)面が基板表面に平行する場合に現れる位置θ=33/2から3.7度だけ、つまりオフ角だけシフトしている。Fig.8(b)のSiC(200)からの回折も同様のシフトを示していることから、基板Si(100)//SiC(100)の関係にあることが分かる(参考文献2)。
コメント :
従来のエネルギーによるイオン注入より深く、表層の乱れが少ないのが、高エネルギーイオン注入法の特長で、ミクロン程度の埋め込み層を形成するには良い方法である。結晶方位の揃った微粒子が成長しており、半導体への応用には単結晶層が形成できる条件を見い出すことが必要となる。
原論文1 Data source 1:
高温高ドーズMeVイオン注入によるSiC埋め込み層の形成
茶谷原 昭義、木内 正人、木野村 淳、杢野 由明、堀野 裕治、藤井 兼榮
大阪工業技術研究所 材料物理部 量子ビーム研究室
真空、第36巻, 第11号 (1993), 856-861頁
参考資料1 Reference 1:
High-Dose Implantation of MeV Carbon Ion into Silicon
A. Chayahara, M. Kiuchi, Y. Horino, K. Fujii and M. Satou
Government Industrial Research Institute, Osaka (now:Osaka National Research Institute)
Jpn. Journal of Applied Physics, Vol. 31 (1992), pp.139-140
参考資料2 Reference 2:
Formation of Crystalline SiC Buried Layer by High-Dose Implantation of MeV Carbon Ions at High Temperature
A. Chayahara, M. Kiuchi, A. Kinomura, Y. Mokuno, Y. Horino and K. Fujii
Government Industrial Research Institute, Osaka (now:Osaka National Research Institute)
Jpn. Journal of Applied Physics, Vol. 32 (1993), pp.L1286-L1288
キーワード:高エネルギーイオン注入、高温イオン注入、炭化珪素、赤外吸収
high energy ion implantation, high-temperature ion implantation, SiC, IR absorption
分類コード:010205, 010103, 040501
放射線利用技術データベースのメインページへ