放射線利用技術データベースのメインページへ
作成: 97/12/01 堀野 裕治
データ番号 :010084
イオンビームアシスト法を用いたc-BN膜の合成と結晶構造制御
目的 :立方晶BN薄膜の合成法の開発とガス混合比Ar/N2の効果及び表面コーティングへの応用
放射線の種別 :重イオン
放射線源 :イオンビーム加速器(20keV)
フルエンス(率):0〜110μA/cm2
利用施設名 :(株)東芝
照射条件 :真空中、350〜400℃(イオン照射による温度上昇)
応用分野 :表面コーティング、表面改質、薄膜形成
概要 :
ホウ素を蒸着しながらアルゴンと窒素イオンの混合イオンビームを同時に照射することによって立方晶窒化ホウ素(c-BN)膜の合成法についての研究。イオン種及び密度を精確に測定し、イオンビームのエネルギー、電流密度及びガス混合比Ar/N2を制御することにより、合成する膜の結晶構造(立方晶と六方晶との比)及びイオン照射効果を制御することができる。
詳細説明 :
c-BN膜形成法にはいろいろあるが、ここでは発生する光を検出して反応場での窒素イオン、アルゴンイオンを定量し、薄膜形成の条件を決定している。
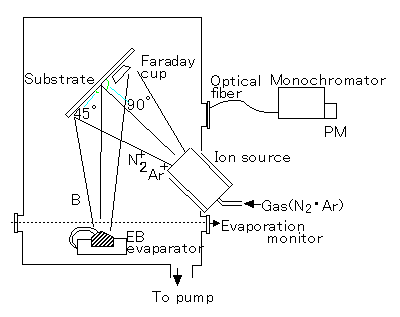
図1 Schematic diagram of ion-beam-assisted vapor deposition apparatus(原論文1より引用)
図1に使用した装置の概略を示す。イオン源はバケットタイプのECR型で、純度5Nの窒素ガスとアルゴンガスを使用する。ガス流量はそれぞれ独立した流量制御装置で制御する。イオン源は基板に対して垂直の位置にある。ボロンは装置の底にある電子線で加熱して蒸着する。この蒸着源は基板に対して45度の位置にある。イオン種はシリカガラス製の光ファイバーで光を分光器に導き、光電子増倍管で増幅してスペクトルを測定して決定する。各イオン種の電流密度は蒸着前に分析電磁石を用いて行い、蒸着時には分析電磁石を取り除いた。
窒化ボロン膜形成の実験条件は、ボロン蒸着速度4nm/min、全ガス流速3sccm、イオン加速エネルギー0.25-1.0keV、用いた基板; n-type Si(100)、蒸着時間90minである。
発光分析の結果、Ar-N2混合ガスを用いた場合、主なイオン種はAr+、N2+及びN+であることが分かった。その他Ar++及びN++などが観測されたが、存在比は1%以下と非常に小さな割合である。窒素の成分はアルゴンガスの割合が多くなるに従って徐々に減少する。Ar+の主な発光は811.5nm、N2+の主な発光は391.4nmで、イオンビーム電流と両者の発光強度とは比例関係にあることが確認されている。本方法でシリコン基板上に形成された立方晶と六方晶とが混合した場合のBN膜は鏡面で、空気中では安定しており、数ヶ月間放置しても膜が剥がれることはない。
試料基板はヒーターで加熱することはしていないが、イオンビーム照射により350-400℃まで温度は上昇している。アルゴンガスを使用せず、ボロン蒸着と窒素イオンビームのみで形成した場合、ほぼ1対1の割合でB-N結合を形成することがXPS分光法で分かった。しかし、赤外吸収法で結晶構造を調べた結果、六方晶(h-BN)のみが形成され、立方晶(c-BN)は形成されない。
アルゴンガスを10%導入した場合では、イオンのエネルギーを0.25-1.0keVの範囲、イオン電流密度を60-110mzμA/cm2の範囲で変化させてても、六方晶のみか六方晶とボロンの混合膜しか形成されない。
アルゴンガスを30%導入した場合は結晶構造と膜の厚さがイオンビームのエネルギーや電流密度によって変わることが分かった。その結果を示すため、イオンビームのエネルギーを0.25keVから1.0keVに変化させた際の赤外吸収スペクトルの変化を図2に示す。
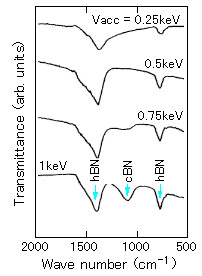
図2 Infrared absorption spectra of BN films deposited at various ion energies from 0.25 to 1.0 keV, with Ar+ 30% at gas flow of Ar:N2=0.5:2.5(sccm). Film thickness is from 250 to 150nm at ion energies from 0.25 to 1.0keV. (原論文1より引用)
イオンビームのエネルギーが0.5keV以下の時には六方晶BNしか観察されないが、イオンビームのエネルギーが0.75keVの時、立方晶BNの弱い吸収(1080cm-1)が観察され、エネルギーが1.0keVになると非常にはっきりしたスペクトルが観察される。その際、同時に六方晶による吸収も観察され、立方晶と六方晶の混合層が形成されていることが分かる。その割合がイオンビームのエネルギーに依存しており、BN膜の構造が形成条件に強く依存することが分かる。
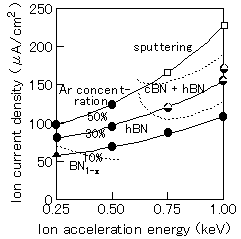
図3 Effects of ion acceleration energy, ion current density and Ar+ concentration on BN crystal structure. □:completely sputtered deposited film, ○:c-BN and h-BN mixture, ●: h-BN and ▲:mixture of B and h-BN.(原論文1より引用)
図3に形成されるBN膜の構造とイオンビームのエネルギー、電流密度、アルゴンガスの混合比の関係依存性を示す。アルゴンガスの割合が10%では、六方晶か六方晶とボロンの混合膜、50%では六方晶かスパッタリングで膜が成長しないことが分かる。アルゴンガスの割合が30%の場合でも立方晶単一膜は形成されず、六方晶との混合層しか得られてないが、これまでの他の色々な実験結果では、基板とBN膜との界面に六方晶BN層が存在し、その上にほぼ100%の立方晶BN膜が形成していることが明らかになっている(参考文献1)。
コメント :
c-BNは非常に硬く、高い熱伝導率を持っているためコーティング材として有望視されているが、六方晶が作りやすく立方晶を形成するのは条件を揃えなければならない。アシストイオンビーム法のようにある条件下でのイオン照射による運動量付与が立方晶を形成するという説明もある。いずれにせよ、本方法ではイオンビーム技術が持つ非熱的過程が重要である。
原論文1 Data source 1:
Effect of Mixed Argon and Nitrogen Ion Beam on Cubic Boron Nitride Film Formation in Ion-Beam-Assisted Deposition
H. Kawashima and N. Shibata
Toshiba Co.
Japan Journal of Applied Physics, Vol. 34 (1995), 5758-5762
参考資料1 Reference 1:
Phase control of cubic boron nitride thin films
D. J. Kester and R. Messier
Pennsylvania State University
Journal of Applied Physics, Vol. 72 (1992), 504-513
キーワード:イオンビームアシスト、c-BN膜、薄膜形成、IBAD、イオンビーム、放射線効果
ion beam asist, c-BN films, thin film formation, IBAD, ion beam, radiation effects
分類コード:010304, 010302
放射線利用技術データベースのメインページへ