放射線利用技術データベースのメインページへ
作成: 1997/10/20 堀野 裕治
データ番号 :010078
酸素イオンビームによるダイヤモンドの加工
目的 :ECRイオン源から発生する酸素イオンビームを用いたダイヤモンド加工の基本特性
放射線の種別 :重イオン
放射線源 :ECR型イオン源(20kV)
利用施設名 :東京理科大学基礎工学部イオンビーム加工装置
照射条件 :真空中、室温
応用分野 :ダイヤモンド加工、精密加工、セラミックスの加工
概要 :
酸素イオンビームを用いたリアクティブイオンビーム加工法によりダイヤモンドの表面加工について、比加工速度のビームエネルギー依存性などの基本特性及び処理後の試料の表面粗さについて調べた。化学的効果などにより、比加工速度はアルゴンの場合と比べ約10倍大きく、ビームエネルギーが300eV前後で最大となる。また、ビームエネルギーが大きくイオンの入射角度が小さい方が表面粗さが小さくなる。
詳細説明 :
従来、熱フィラメントを用いるタイプのイオン源により発生した酸素イオンビームを用いて加工に応用していたが(参考資料1)、フィラメントの短時間での劣化やそれからの不純物汚染などの問題があっため、無フィラメントのECR型のイオン源を用いたリアクティブ(反応性)イオンビーム加工法を開発し、ダイヤモンド加工の場合について基本的な特性を調べた。
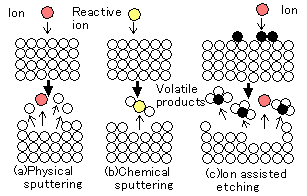
図1 Model of etching mechanism by means of reactive ion beam (原論文2より引用)
図1にリアクティブイオンビーム加工の考えられている反応機構についての概念図を示す。(a)はアルゴン等の希ガスイオンを用いた場合などの通常の物理的衝突過程によるエッチングを示す。(b)は活性イオンが試料構成元素と反応して、揮発性生成物を形成して真空中に放出される化学スパッタリングを示す。(c)はイオンの運動エネルギーによって試料表面の吸着粒子を活性化し、このため試料上に存在する元素との化学反応が大きく促進され、反応生成物が脱離するイオンアシストエッチング反応である。このように本方法のようなリアクティブイオンビーム加工は(a)の物理的過程のみではなく、(b)、(c)などの化学的作用が加わるため加工速度や選択性を高めることができる。従って、ダイヤモンドの加工には酸素ビームを用いることにより、また、その他の材料でも材料に合わせてイオン種を選ぶことにより同様の効果を得ることができる。

図2 Schematic diagram of the ion beam etching apparatus with an ERC-type ion source(原論文2より引用)
図2にECRイオン源を備えたイオンビーム加工装置の概略図を示す。マイクロ波(2.45GHz、200W)とECR条件を満たす磁場(875G)との相互作用により酸素などの活性化ガスの高イオン化率プラズマを得る。プラズマを1000eV以下で引き出し、試料に照射し加工する。均一照射のために試料台は回転速度5rpm程度の回転機構を備えている。
リアクティブイオンビーム加工ではエネルギー、イオンビームの入射角、入力パワー度等のパラメーターがあり、加工対象材料により最適化する必要がある。
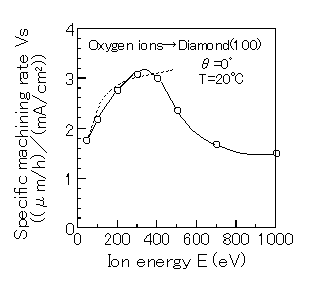
図3 Specific etching rate of diamond(100) by means of reactive ion beam as a function of the ion energy.(原論文1より引用。 Reproduced from Nanotechnology, 7 (1996), 270-274, Fig.3(p.271),S. Kiyohara and I. Miyamoto, Reactive ion beam machining of diamond using an ECR-type oxygen source; Copyright(1996), with permission from IOP Publishing Limited. and the authors.)
図3に比加工速度Vs(加工速度をイオン電流密度で規格化したもの)のイオンエネルギー依存性を示す。比加工速度はイオンエネルギーが増加するに従って増加し、300eV前後で最大となり、その後、エネルギーの増加とともに減少するのが分かる。はじめはエネルギーの増加により反応生成物の脱離が促進されるが、300eV近傍以上では、物理的スパッタリングの効果が大きくなり、表面の吸着分子を取り除くようになるため、揮発性反応物を作る反応が起こりにくくなり、比加工速度が減少すると考えられる。300eVでは揮発生成物を作る反応と反応生成物の脱離がもっとも促進される。
イオンビームの入射角度依存性では、イオンのエネルギーが低いときは化学的反応が支配的で、実質的なイオン電流が余弦曲線に従って減少するため、比加工速度はイオンの入射角度に従って徐々に減少する。エネルギーが1000eV程度と高い場合は、物理的作用も加工に強く影響し、入射角度40度近傍で最大となり、その後急激に減少するなどの挙動を示す。
比加工速度はイオン源内のガス圧の増加とともに増加する。これはガス圧の増加とともに、イオン源で生成される酸素ラジカルが増加することや試料表面に吸着する粒子が増加することで揮発性生成物を作る化学反応が促進されるためと考えられる。
ここでのダイヤモンド加工の場合、比加工速度はイオン源のマイクロ波の入力パワーには依存しないことが明らかになっている。マイクロ波のパワーによりイオン源でのO+とO2+のイオン生成比が変わることが知られているが、ここでの結果は、O+とO2+のイオンの量の違いは比加工速度に影響を及ぼさないことを示している。
コメント :
イオンビームの持つ物理的衝突過程による精密加工性に化学反応の効果を加えることで、加工速度を速くし、加工対象物の選択性を増すことができる。最適条件を見つける必要など、まだ実用な段階とは言えないが、ダイヤモンドなど難加工性材など加工対象材料によっては将来、有望な加工技術である。
原論文1 Data source 1:
Reactive ion beam machining of diamond using an ECR-type oxygen source
S. Kiyohara and I. Miyamoto
Science University of Tokyo
Nanotechnology, 7 (1996), 270-274
原論文2 Data source 2:
ECR型イオン源を用いた単結晶ダイヤモンドの酸素イオンビーム加工
清原 修二、宮本 岩男
東京理科大学基礎工学部
精密工学会誌, 62巻, No.10(1996),1459-1463
参考資料1 Reference 1:
リアクティブイオンビーム加工による超精密加工
宮本 岩男、清原 修二
東京理科大学基礎工学部
砥粒加工学会誌, 38巻、No.5(1994), 262
キーワード:ダイヤモンド、酸素イオンビーム、ECRイオン源、表面粗さ、リアクティブイオンビーム加工、原子間力顕微鏡
diamond, oxygen ion beam, ECR-type ion source, surface roughness, reactive ion beam processiong, atomic force microscope
分類コード:010103, 010305, 040106
放射線利用技術データベースのメインページへ