放射線利用技術データベースのメインページへ
作成: 1996/02/08 堀野 祐治
データ番号 :010002
集束MeV重イオンビームを用いた電気的接触部のマスクレス形成
目的 :収束(数ミクロン)重イオンビームを用いた局所電気接触部の形成
放射線の種別 :重イオン
放射線源 :タンデム加速器(1.5MeV)
フルエンス(率):5x1016〜1x1018 ions/cm2
利用施設名 :大阪工業技術研究所
照射条件 :真空中、室温
応用分野 :材料創製、集積回路
概要 :
数 μmに集束した高エネルギーのニッケルイオンビームを注入し、絶縁体層を挟んだ2層の電極間に電気的な接触を局所的に形成する技術。イオンのエネルギーを選ぶことで注入したニッケルの分布をコントロールする。注入後、2つ電極間の電流-電圧特性と注入量との関係を調べて、注入量に応じて電気伝導率が大きく変化することを示している。
詳細説明 :
目的はイオンビームの局所注入技術の応用で、集積回路における直接描画や、既存の集積回路の修復や改良したりする上でマスクを用いず、直接、集束したビームでプロセスを行う技術に高エネルギーの重イオンマイクロビームを応用することを目的としている。イオンのエネルギーをMeVと非常に高くすることにより、材料の深い領域の加工が可能になり、また、立体的なデバイス開発への応用も将来の目標に据えている。
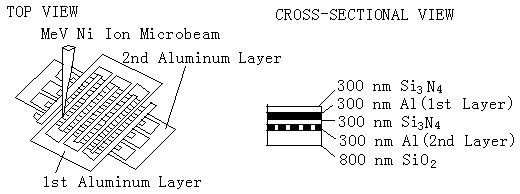
図1 試料の模式図。(原論文1より引用。 Reprinted from Nuclear Instruments and Methods in Physics Research, B80/81, p. 1292-1295(1993), Fig. 1 (p.1292), Mokuno Y, Horino Y, Kinomura A, Chayahara A, Kiuchi M, Tamura S, Fujii K, Takai M, Maskless Fabrication of Contact Vias by Focused MeV Heavy Ion Beam;Copyright(1993), with kind permission of Elsevier Science-NL, Sara Burgerhartstraat 25, 1055 KV Amsterdama, The Netherlands.)
実験条件は次の通りである。試料の模式図を図1に示す。試料は酸化珪素(SiO2)基板上に300nmの窒化珪素(Si3N4)の絶縁膜で挟んだ厚さ300nmのアルミニウムの2つの電極(第1層及び第2層)を蒸着して作製する。各層の電極はそれぞれ、約50μmの巾の櫛状のものを互い違いに設置している。試料の最表面にも300nmの窒化珪素膜を形成する。この試料に約3μm角に集束した1.4又は2MeVのエネルギーのニッケルイオンビームを照射する。ビーム電流は1〜16pAで、照射時間は360〜13800秒。照射は真空中で行い、その真空度は5x10-7Torrであった。ビームの照射位置は集束ビームを約130μm×130μmの範囲で走査し、発生する2次電子により表面像を観察して決定する。イオン注入後、2つの電極間の電流-電圧特性を2端子法により測定する。
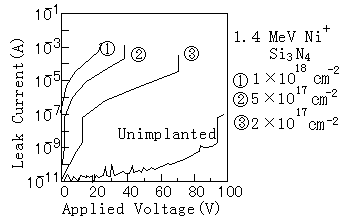
図2 1.4MeV ニッケルイオンビームで照射した試料の電流-電圧特性。(原論文1より引用。 Reprinted from Nuclear Instruments and Methods in Physics Research, B80/81, p. 1292-1295(1993), Fig.4 (p.1293), with kind permission of Elsevier Science.)
実験結果は次の通りである。図2は1.4MeVニッケルイオンビームを照射した試料の電流-電圧特性を示し、イオンの照射量をパラメーターにしている。イオンを照射しないときは抵抗が大きく、電流はほとんど流れないが、照射量が大きくなるに従い、抵抗が小さくなり、低い電圧で大きな電流が流れるようになるのが分かる。
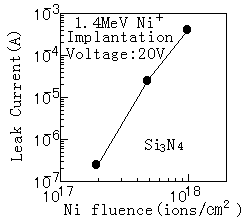
図3 印加電圧20Vの時の電流のニッケル照射量依存性。(原論文1より引用。 Reprinted from Nuclear Instruments and Methods in Physics Research, B80/81, p. 1292-1295(1993), Fig.5 (p.1294), with kind permission of Elsevier Science.)
図3は印加電圧20Vの時に流れる電流のニッケル照射量依存性を示している。照射量が約1桁増える間に流れる電流値は3桁増加し、イオンの注入量に対して大きな依存性を持つことが分かる。
2MeVニッケルイオンビームを照射した場合、明瞭な電気的接触を形成することができなかった。これはイオンビームの平均飛程がエネルギーが高いために長く、導通領域を形成する必要のある窒化珪素膜を通り越してイオンが止まるためと考えられる。実際、シミュレーションによる平均飛程は1.4MeVの場合、ちょうど窒化珪素のある深さになるが、2MeVの場合第2層のアルミニウム電極で止まる深さになる。これから、電気的導通状態を形成する場合、絶縁体のところにイオンが止まるようにエネルギーを調整する必要がある。
コメント :
1)高エネルギーを用いるため、比較的深い領域まで対象になり、応用範囲が広い。
2)実用的には、ビームの大きさが1μm 以下であることが必要と思われる。
原論文1 Data source 1:
Maskless Fabrication of Contact Vias by Focused MeV Heavy Ion Beam,
Mokuno Y, Horino Y, Kinomura A, Chayahara A, Kiuchi M, Tamura S, Fujii K, Takai M,
Osaka National Research Instutute, Ikeda, Osaka 563, Japan,
Nuclear Instruments and Methods in Physics Research B80/81,1292(1993).
キーワード:集束イオンビーム、重イオンビーム、高速イオンビーム、マスクレス加工,
focused ion beam, heavy ion beam, high energy ion beam, maskless fabrication
分類コード:010305
放射線利用技術データベースのメインページへ