原子力基盤技術データベースのメインページへ
作成: 1999/03/21 桜井 健次
データ番号 :180019
斜入射X線散乱法による表面形状解析技術
目的 :物質表面のナノメータスケールの形状を計測するための斜入射X線散乱測定装置の開発とミラー材料等の形状評価への応用
研究実施機関名 :科学技術庁金属材料技術研究所
応用分野 :ガラス材料、結晶材料、ミラー、薄膜
概要 :
X線の全反射現象を利用すると大気中で非破壊に表面敏感な測定を行うことができる。視射角と等角位置に観測される鏡面反射とその周辺に出現する散漫散乱には物質表面のナノメータスケールの形状(ラフネス、相関距離、フラクタル次元等)に関する詳細な情報が含まれている。これらの微弱な散乱X線を精度良く、また良好な角度分解能で測定するための装置技術が重要である。
詳細説明 :
平坦かつ平滑な物質表面にX線を斜入射で照射したときに観測される散乱X線は、鏡面反射と散漫散乱の大きく2つに分類される。鏡面反射とは、全反射条件の近傍で視射角と等しい角度の位置に観測されるいわゆる反射のことである。その強度の角度分布を測定する実験は、20世紀初頭のX線物理学の黎明期より行われ、現在では表面や薄膜の分析(各層の厚み、表面・各界面のラフネス、密度等)を分析する方法として広く用いられている。
他方、表面が理想的に平滑な鏡面でない場合には、反射の周囲、すなわち等角でない位置にも微弱な散乱が観測されることがあり、散漫散乱と呼ばれる。表面や界面のナノスケールの形状を詳細かつ精密に議論するのに有用であり、最近活発に研究が行われている。鏡面反射、散漫散乱とも、試料表面が結晶である必要はなく、得られる情報も結晶構造には依存しない。
微弱な散乱X線を精度良く、また良好な角度分解能で測定するためには、注意深く設計された専用の測定装置が必要である。図1は金属材料技術研究所において開発された斜入射X線散乱測定装置の写真である。銅の回転対陰極X線源(定格40kV-80mA)は小焦点(6度方向、30μm×3mm)であり、管球壁に固定されたチャンネルカットモノクロメータ(Si(111)対称カット)と入射スリット(40μm×10mm)で CuKα1線のみを取り出して試料に斜入射で照射させる。
散乱強度は、受光スリット(40μm×10mm)の背後に置かれた YAP:Ceシンチレーション検出器により測定する。測定は大気中で行う。精度を重視しつつ簡便にすべての部品を配置する観点から光学ベンチを用い、その上にほぼ一直線に並べた。それぞれの位置は独立したステージにより精密制御できる。試料の位置および回転角決めには、並進、回転、並進とステージ、ゴニオメータを3段重ねにする構造を採用した。また試料からの蛍光X線の測定も行えるように半導体検出器を備えている。
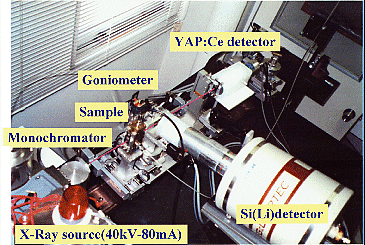
図1 斜入射X線散乱測定装置(写真)
図2に本装置を用いて超精密加工平面(合成石英ミラー、面精度λ/20、λ=632.8nm、平行度2秒)からの鏡面反射および散漫散乱X線を測定した結果を示す。ロッキングスキャン、検出器スキャンともに、視射角と脱出角の等しい角度で鋭いピークが得られているが、これは強い鏡面反射が重なるためである。また全反射臨界角に等しい視射角および脱出角に認められるピークは、表面でのX線強度の増大に対応するもので Yoneda Wing と呼ばれる。得られた結果を解析することにより、合成石英ミラーのラフネス、相関距離、フラクタル次元等の表面形状のパラメータを決定することができた。
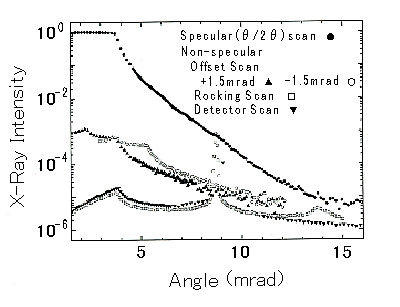
図2 超精密加工平面(合成石英ミラー)からの鏡面反射および散漫散乱の角度分布プロファイル(原論文9より引用。 Reproduced from Journal of Synchrotron Radiation 1998; 5:554-556, Figure 3 (p.556), K.Sakurai, S.Uehara, and S.Goto, A grazing-incidence reflectometer for BL-39XU at SPring-8, Copyright(1998), with permission from International Union of Crystallography. )
図3は本装置を用いてガラス基板上のCr/Au薄膜からの鏡面反射、散漫散乱およびクロム蛍光X線の角度分布を測定した結果である。鏡面反射およびクロム蛍光X線にはKiessig構造、すなわち、各界面での多重反射によって起きる干渉パターンが観測されており、これによって各層の厚さと表面/界面の粗さを決定することができる。
また、散漫散乱もロッキングスキャンおよび検出器スキャンのいずれの結果においても干渉効果を示すことがわかる。表面のナノメータスケールモルフォロジーの詳細情報に加え、界面の形状や界面間の相関が強度分布に寄与している。このような平坦で連続的な薄膜の例だけでなく、薄膜の初期成長段階に現れる島状粒子やナノ粒子、軽元素マトリックス中に凝集した金属が粒子状に分散するような場合にも有効であり、粒子サイズや粒子間距離等の情報を得ることができる。

図3 ガラス基板上のCr[51.8nm]/Au[100nm]/Cr[20nm]薄膜からの鏡面反射、散漫散乱およびクロム蛍光X線の角度分布プロファイル
コメント :
本測定技術は、通常のX線発生装置だけではなく、シンクロトロン放射光を用いることにより、一層真価を発揮することができる。本研究で開発された装置に改良を加えたモデルが、後に SPring-8 BL39XU のために設計、製作された。現在は調整も終え、広く共同利用実験に公開されている。今後展開される予定の研究領域には例えば次のようなものがある。表面X線散乱法によるナノメータスケール表面トポグラフィ(ミラー材料等精密加工表面の形状評価、表面損傷評価、薄膜およびナノ粒子の成長過程の研究)、蛍光X線・散乱X線の干渉効果を用いた薄膜界面の新解析法(急峻で粗い界面と傾斜していて平滑な界面の分類判定、特定界面への微量金属偏斥現象の直接観察)。
原論文1 Data source 1:
斜入射配置における散漫散乱X線プロファイルの測定
桜井健次
金属材料技術研究所
第32回X線分析討論会講演予稿集(1996.11 東京), p.9-10
原論文2 Data source 2:
斜入射散漫散乱・蛍光X線測定装置の開発
桜井健次
金属材料技術研究所
第44回応用物理学関係連合講演会予稿集(1997.3 船橋) , p.562
原論文3 Data source 3:
斜入射X線鏡面反射率および散漫散乱測定による表面粗さ解析
桜井健次
金属材料技術研究所
日本化学会第73秋季年会講演予稿集(1997.9 盛岡), p.222
原論文4 Data source 4:
微小角散漫散乱X線によるナノスケール表面形状解析のためのソフトウエアの開発
K.Stoev、桜井健次
金属材料技術研究所
第11回日本放射光学会年会・放射光科学合同シンポジウム講演予稿集(1998.1西播磨), p.192
原論文5 Data source 5:
微小角散漫散乱X線による精密平面基板のナノスケール表面形状解析
桜井健次、江場宏美
金属材料技術研究所
日本化学会第75秋季年会講演予稿集 (1998.9, 松山), p.191
原論文6 Data source 6:
SPring-8 BL-39 における斜入射X線分析装置の開発(II)
桜井健次、後藤俊治
金属材料技術研究所、SPring-8
第34回X線分析討論会講演予稿集(1998.11 仙台), p.21-22
原論文7 Data source 7:
斜入射X線散乱法による単結晶TiO2表面のナノスケール形状評価
斉藤多鶴子、桜井健次、松下正
総合研究大学院放射光化学専攻、金属材料技術研究所、物質構造科学研究所
第34回X線分析討論会講演予稿集(1998.11 仙台), p.23-24
原論文8 Data source 8:
シリコン基板上に堆積させた銅超微粒子の表面X線散乱
江場宏美、桜井健次
金属材料技術研究所
日本金属学会1999秋期(第116回)大会講演概要(1999.11 金沢), p.522
原論文9 Data source 9:
Grazing incidence reflectometer for BL-39XU at SPring-8
Kenji Sakurai, Shoji Uehara and Sshunji Goto
National Research Insitute for Metals, Kohzu Seiki Co. Ltd, SPring-8
J. Synchrotron Rad. 5, 554-556 (1998).
原論文10 Data source 10:
Grazing Incidence X-ray Fluorescence and Scattering Experiments at BL-39XU, SPring-8
Kenji Sakurai, Hiromi Eba and Sshunji Goto
National Research Insitute for Metals, SPring-8
Jpn. J. Appl. Phys. Suppl.38-1, pp.332-335 (1999).
参考資料1 Reference 1:
全反射現象及び微小角入射配置を用いたX線回折・散乱分析法
桜井健次、Luc Ortega
金属材料技術研究所
ぶんせき、1998 No.3, p.164-174
参考資料2 Reference 2:
Review on grazing incidence X-ray spectrometry and reflectometry
Krassimir N. Stoev and Kenji Sakurai
National Research Insitute for Metals
Spectrochimica Acta Part B 54, 41-82 (1999).
参考資料3 Reference 3:
キーワード:全反射、鏡面反射、散漫散乱、表面粗さ、相関距離、フラクタル次元
total reflection, specular reflection, diffuse scattering, surface roughness, correlation length, Fractal dimension
分類コード:180204
原子力基盤技術データベースのメインページへ