原子力基盤技術データベースのメインページへ
作成: 2000/03/13 桜井 健次
データ番号 :180018
薄膜の特定界面に敏感な蛍光X線分析
目的 :薄膜材料中の微量不純物の分析
研究実施機関名 :科学技術庁金属材料技術研究所
応用分野 :磁性体薄膜、超伝導体薄膜、半導体薄膜、セラミックス誘電体薄膜、高分子薄膜
概要 :
X線を斜入射で試料に照射し、入射X線と反射X線の間で生じる干渉効果を利用して、薄膜の特定界面に敏感な微量元素分析を行う方法が開発された。視射角を注意深く選ぶことにより、注目している微量不純物元素が隣り合う界面のいずれに偏析しているかを明瞭に識別することができる。この界面増感現象には周期性は必要でなく層数もあまり多くなくても生じるため、広範な薄膜への応用が期待できる。
詳細説明 :
X線の全反射現象を利用する分析手法は、基本的にX線の侵入深さが非常に浅くなる結果としての表面敏感性に立脚している。実際、回折、蛍光X線、XAFSなどさまざまなタイプのX線の実験手法を表面近傍のキャラクタリゼーションに応用することが指向されてきた。一方、測定対象が薄膜のように密度の異なるいくつかの層からなる場合、X線は表面のみならず各界面でも多重反射するため、それらの干渉効果があらわれる。鏡面反射率の角度あるいはエネルギー分布を測定する際に観測される干渉パターンはKiessig 構造としてかなり昔から知られているが、薄膜内部のX線電場強度に比例する信号、たとえば蛍光X線、オージェ電子、光電子などの収量についても同様な干渉効果が観測される。これらは、薄膜の構造、すなわち層の組成、厚み、界面の粗さなどに敏感であり、また膜内の強度分布を利用して特定の層や界面の解析を行える可能性も持っていることから、新しい薄膜の解析技術として注目を集めつつある。
図1は、シリコン基板上にスパッタ法で作成された銅[23.5nm]/金[50nm]薄膜についての蛍光X線強度角度分布である。界面を調べるねらいから、表面と銅/金界面に極微量の鉄とチタンがそれぞれ蒸着されている。表面のX線強度を反映する鉄の蛍光X線強度が臨界角近傍(約7mrad)で強くなるのは当然であり、これこそが全反射実験が表面分析に利用されるゆえんであるが、わずかに高角側の約 7.5 mrad でチタンの蛍光X線強度がピークを持つことに注意を払う必要がある。単調な侵入深さの増大により界面でのX線強度が相対的に強くなったのではなく、干渉効果によってこの界面が強調され、そこにあるチタンの蛍光X線が増感されているのである。干渉が起きていることは、両曲線に振動構造が見えていることからも確かめられる。
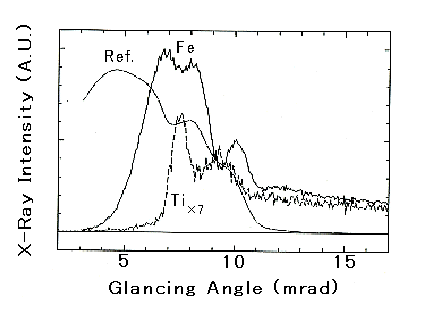
図1 8 keV のX線に対する銅[23.5nm/金[50nm] 薄膜の鏡面反射率と表面・界面からの蛍光X線強度。微量の鉄とチタンが表面および界面にラベルされている。(原論文5より引用)
別な測定例を図2及び図3に示す。試料の界面数(すなわち層数)が1つ多い、銅[10nm]/銀[23nm]/金[50nm]薄膜である。表面および界面は、順に鉄[0.3nm]、クロム[0.6nm]、チタン[1.8nm]でラベルされている。入射X線のエネルギーは 8keV であるため、図2において確かめられるように、第1層の銅からの蛍光X線は抑制されている。このようにSRの持つ入射エネルギー可変性は、微量成分の信号の検出を容易にするという重要な効用がある。低角である 6.2 mrad では鉄の蛍光X線が強くでているが、7.7 mrad ではクロムの強度が鉄よりも強くなった。この角度では第2層の銀からのL線も観測される。9.2 mrad では、チタンのピークが弱いながらも観測されるようになり、クロムの強度は再び弱くなった。
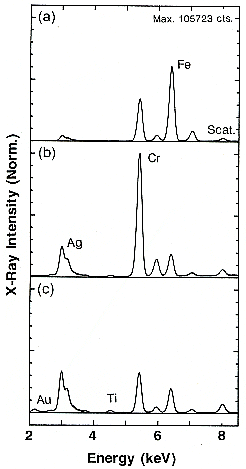
図2 銅[10nm]/銀[23nm]/金[50nm] 薄膜のさまざまな視射角で測定された蛍光X線スペクトル。(a) 6.2 mrad, (b) 7.7 mrad, (c) 9.2 mrad.(原論文5より引用)
図3からわかるように、各ピークの積分強度の角度分布を見ると、それぞれ違った角度位置にピークを持つことがわかる。このことは、蛍光X線スペクトルの測定に際し注意深く角度を選べば、それぞれの界面を強調するような結果を得ることができ、従って特定界面に偏析する微量元素に対する検出能力を高められることを意味する。事実、図2に示したスペクトルは、表面及び各界面を強調し、それぞれの元素組成を強く反映した結果になっている。図3より示されるもう1つの重要な点は、ある界面が強調されるとき、隣り合う界面での強度は弱くなることである。例えば、第1界面に対応するクロム蛍光X線強度のピークで、鉄の強度は弱くなり、第2界面のチタンのピークではクロムが弱くなっている。つまり、この実験は、ある元素が特定の層の上または下のいずれの界面に偏析するかを量的な情報を含めて知りたいような場合にも有力な手段になる。
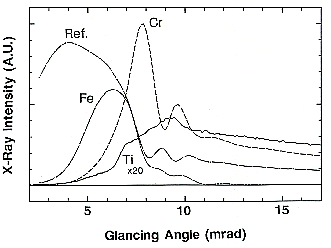
図3 銅[10nm]/銀[23nm]/金[50nm] 薄膜の表面、界面にラベルされた微量金属(鉄、クロム、チタン)からの蛍光X線強度の視射角依存性。(原論文5より引用)
コメント :
狭い意味での斜入射蛍光X線分析法が表面を選択的に励起する測定技術であるとすれば、干渉効果に注目することにより、これを拡張して特定界面の選択励起をも行うことができるようになったと言ってよい。埋もれた界面を非破壊的に見る方法は限られており、ここではX線法の良い特徴が生かされている。更にこのような情報は空間的なイメージング技術と結合された場合に画期的であると考えられる。X線を表面にほぼ平行に入射させる斜入射配置とは別に、入射X線は適当な角度で試料に照射させ、蛍光X線の取り出し角を極端に浅くする斜出射配置の実験も表面近傍の解析を行うのに有用な場合があり、相反定理により斜入射配置で得られるのと本質的に同じ情報が得られることが知られている。放射光マイクロビームを入射光に用い、特定界面に偏析する元素のマイクロイメージングに応用することも可能である。
原論文1 Data source 1:
SR斜入射蛍光X線分析法による薄膜界面の選択励起
桜井健次、飯田厚夫
金属材料技術研究所、高エネルギー物理学研究所
第55回応用物理学会学術講演会予稿集(1994.9 名古屋) No.2, p.558
原論文2 Data source 2:
斜入射X線実験における干渉効果を利用した分析法(2)薄膜界面の選択励起
桜井健次、飯田厚夫
金属材料技術研究所、高エネルギー物理学研究所
第8回日本放射光学会年会・放射光科学合同シンポジウム講演予稿集(1995.1 つくば)p.225
原論文3 Data source 3:
X線の干渉を利用した薄膜特定界面の分析法
桜井健次、飯田厚夫
金属材料技術研究所、高エネルギー物理学研究所
日本金属学会1995春期(第116回)大会講演概要(1995.4 東京) p.349
原論文4 Data source 4:
X線全反射現象における干渉効果に着目した薄膜界面の高感度蛍光X線分析
桜井健次
金属材料技術研究所
SR科学技術情報、Vol.6, No.2, 2-7 (1996).
原論文5 Data source 5:
Analysis of specific interface of thin films by X-ray fluorescence using interference effect in total reflection
K.Sakurai and A.Iida
National Research Insitute for Metals, Photon Factory
Adv. in X-Ray Anal. 39, 695-700 (1997).
参考資料1 Reference 1:
全反射蛍光X線分析
桜井健次、Krassimir N. Stoev
金属材料技術研究所
ぶんせき、1999 No.7, p.65-72
参考資料2 Reference 2:
参考資料3 Reference 3:
キーワード:全反射、斜入射配置、深さ方向分析、干渉効果、多重反射、微量分析、偏析
total-reflection, grazing-incidence geometry, depth analysis, interference effect, multiple reflection, trace element analysis, segregation
分類コード:180205
原子力基盤技術データベースのメインページへ