作成: 2000/03/08 鈴木 良一
データ番号 :170020
パルス陽電子寿命測定法によるアモルファスシリコンの材料評価
目的 :低速短パルス陽電子ビームを用いたアモルファスシリコン薄膜の微視的構造の評価
研究実施機関名 :電子技術総合研究所 量子放射部
応用分野 :アモルファスシリコン薄膜の評価、半導体薄膜中の空孔型欠陥の評価、空孔サイズ測定
概要 :
入射エネルギー可変の短パルス陽電子ビームを用いた陽電子寿命測定法は、陽電子のエネルギーを変えることによって表面から特定の領域の格子欠陥などの微視的構造を敏感に調べることができることから、アモルファスシリコンの高機能材料の薄膜の微視的構造評価法として有用である。
詳細説明 :
アモルファスシリコンは、太陽電池などの材料として期待されているが、光劣化など微視的構造に起因すると考えられる問題がある。陽電子寿命測定は微視的構造、特に空孔型欠陥に敏感な評価法として知られているが、従来の放射性同位元素を用いた方法は薄膜には適用できず、アモルファスシリコンのような薄膜プロセスで作成した材料の評価は難しかった。近年、低速短パルス陽電子ビームによって、特定の深さの微視的構造評価ができるエネルギー可変短陽電子寿命測定法が可能になったことから、この方法がアモルファスシリコンの微視的構造評価に適用され、研究が行われてきた。
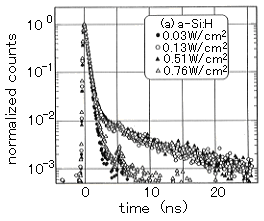
図1 Positron lifetime spectra of the a-Si:H films prepared at Powerdensities of 0.03 W/cm2, 0.13 W/cm2, 0.51 W/cm2, and 0.76 W/cm2 in the time range of 30 ns.(原論文1より引用)
図1は、入射エネルギー可変陽電子寿命測定法によって測定した水素化アモルファスシリコン薄膜の陽電子入射エネルギーが6keVの陽電子寿命スペクトルである。アモルファスシリコン薄膜は、Xe希釈プラズマCVD法によって作成したものであり、作成時のプラズマのRFパワー密度が0.03 W/cm2, 0.13 W/cm2, 0.51 W/cm2, 0.76 W/cm2の4個の試料について測定した。表1にこの測定の寿命解析結果を示す。
RFパワー密度が0.13 W/cm2と0.51 W/cm2の膜の結果には、約9ナノ秒の寿命の長寿命成分が観測された。これは、ポジトロニウム(電子と陽電子の束縛状態)の成分であると考えられ、寿命と空隙サイズの関係から直径約1.3ナノメートル(あるいはそれ以上)のサイズの空隙が試料中に存在すると推定できる。この試料と同じ条件で作られたもののX線小角散乱の結果から、2ナノメートル程度の構造のものがあることが予測されていた。陽電子寿命測定の結果はその構造がボイド(空隙)であることを示唆している。
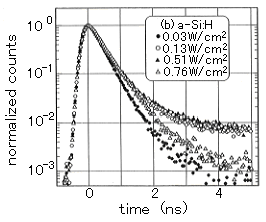
図2 Positron lifetime spectra of the a-Si:H films prepared at Powerdensities of 0.03 W/cm2, 0.13 W/cm2, 0.51 W/cm2, and 0.76 W/cm2 in the time range of 6 ns.(原論文1より引用)
図2は、図1の時間幅を拡大したものである。RFパワー密度が0.03 W/cm2と0.76 W/cm2の膜にはポジトロニウムの長寿命成分はほとんど見られないが、短寿命成分の寿命が異なっており、0.03 W/cm2の膜では陽電子寿命が319 psと結晶シリコンの複空孔に相当する空隙が見られるのに対し、0.76 W/cm2の膜では391 psと4個程度の原子が欠損した空孔クラスターに相当する寿命成分が主要成分として観測された。
表1 Results of multi-component analysis for positron lifetime spectra of a-Si:H films.(原論文1より引用)
------------------------------------------------------------------------------------------
Power density τ1 τ2 τ3 I1 I2 I3 Variance
(W/cm2) (ps) (ps) (ps) (%) (%) (%) of the fits
------------------------------------------------------------------------------------------
0.03 319±2 2588±1622 99.5±0.1 0.5±0.1 1.14
0.13 121±77 421±10 8961±144 19.2±4.6 66.8±4.5 14.0±0.1 1.16
0.51 67±26 440±7 8756±136 30.1±3.3 54.7±3.3 15.2±0.1 0.99
0.76 54±45 391±4 4271±245 13.6±10.3 84.0±10.2 2.4±0.1 1.04
------------------------------------------------------------------------------------------
光伝導率の測定では、RFパワー密度が0.03 W/cm2から0.51 W/cm2の膜は、初期の光伝導率は2x10-5 S/cmから6x10-5 S/cmの値を示すが、0.76 W/cm2の膜は他の膜に比べて光伝導率が2桁低い値を示した。また、0.03 W/cm2の膜は、通常のアモルファスシリコンに見られる光劣化特性を示したが、0.13 W/cm2や0.51 W/cm2の膜には光劣化は見られなかった。この光伝導率の結果と陽電子寿命測定の結果から、微視的構造とアモルファスシリコンの特性の関係を考察すると、以下のことが結論づけられる。
(1) 0.03 W/cm2の膜は、複原子空孔程度の空隙しか存在せずその構造は均一的である。複空孔程度の空隙は、光特性には影響を及ぼしていないと考えられる。
(2) 0.13 W/cm2と0.51 W/cm2の膜は、直径が1.3 nm程度のボイドが存在し構造が不均一的である。しかし、このボイドは、光伝導率の特性には影響しない。むしろ、光劣化を抑える働きをしている可能性もある。
(3) 0.76 W/cm2の膜には、原子が4個程度欠損した空孔クラスターが高濃度存在するが、0.13 W/cm2や0.51 W/cm2で見られるようなナノメートルのボイドは観測されない。この膜は、光伝導率が他の膜に比べて低く、空孔クラスターあるいは空孔クラスターに存在する荷電欠陥によって性能が劣化しているものと推測される。
コメント :
入射深さを制御できるパルス陽電子ビームによる陽電子寿命測定法は、アモルファスシリコン薄膜などの薄膜材料の微視的構造評価として有用である。陽電子ビームによる薄膜の微視的構造評価としては、このほかに消滅γ線のドップラー効果によるエネルギー拡がり幅を測定する方法があり、この方法は、不純物などに敏感な測定法である。この2つの測定法を組み合わせれば、さらに詳しい評価ができると考えられる。
原論文1 Data source 1:
Characterization of Hydrogenated Amorphous Silicon Films by a Pulsed Positron Beam
R. Suzuki, Y. Kobayashi, T. Mikado, A. Matsuda, P.J. CcElheny, S. Mashima, H. Ohgaki, M. Chiwaki, T. Yamazaki, T. Tomimasu
Electrotechnical Laboratory, 1-1-4 Umezono, Tsukuba, Ibaraki 305,
Japanese Journal of Applied Physics, 30 (1991) pp.2438-2441
キーワード:陽電子、低速陽電子、パルスビーム、陽電子寿命、アモルファスシリコン、薄膜、欠陥、ボイド
positron, slow positron, pulsed beam, positron lifetime, amorhous silicon, thin film, defect, void
分類コード:170103, 170205