原子力基盤技術データベースのメインページへ
作成: 1999/02/22 鈴木 良一
データ番号 :170012
パルス陽電子寿命測定法(応用)
目的 :低速陽電子ビームを用いた各種高機能材料の薄膜・表面近傍の評価
研究実施機関名 :電子技術総合研究所、ミュンヘン防衛大学
応用分野 :半導体薄膜の分析・評価、高分子材料の分析・評価、原子炉材料などの照射損傷の評価
概要 :
入射エネルギー可変の短パルス陽電子ビームを用いた陽電子寿命測定法は、陽電子のエネルギーを変えることによって表面から特定の領域の格子欠陥などの微視的構造を敏感に調べることができることから、半導体・金属・高分子などの高機能材料の薄膜や表面近傍の評価法として期待されている。
詳細説明 :
入射エネルギー可変の短パルス陽電子ビームを用いた陽電子寿命測定法は、短パルス化装置によって発生した100ピコ秒程度の短パルスビームを試料に入射し、短パルス化装置のタイミング信号と試料で消滅した時に放出される消滅ガンマ線の検出器のタイミング信号の差を測定することにより、陽電子寿命を測定する方法であり、試料にかける電位を変化させることにより、陽電子の入射深さを変化させることができる。
陽電子の平均入射深さは物質の密度に反比例し、入射エネルギーの1.6乗に比例することが知られており、比重が2.33のシリコン単結晶の場合は入射エネルギーが1keVの時は14nm, 30keVでは3.3μmであり、入射エネルギーを変化させることによってこの任意の深さに陽電子を入射でき、その領域の陽電子寿命を測定することによって欠陥などの微視的構造に関する情報を得ることができる。
この測定法は、金属や半導体だけでなく、陽電子ビームの強度が通常0.1pA以下であることから、チャージアップの問題はなく、セラミック、高分子などの絶縁体にも適用することが可能である。これによって、金属や半導体へのイオン注入によって生成される欠陥、原子炉材料の表面近傍の欠陥、高分子材料の荷電粒子や光による劣化、アモルファスシリコンやダイヤモンド薄膜などの薄膜材料などさまざまな高機能材料の微視的構造を調べることができる。
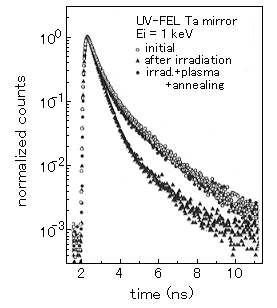
図1 Positron lifetime spectra of the Ta2O5/SiO2 mirrors, measured at the initial, after exposed to undulator radiation, and after treated with O2 plasma and annealed at 230℃.(原論文1より引用)
図1は、この入射エネルギー可変陽電子寿命測定法によって測定した自由電子レーザー用高反射率多層膜ミラーの陽電子入射エネルギーが1keVの陽電子寿命スペクトルであり、自由電子レーザー用蓄積リングのアンジュレータ光を照射前、照射後、照射後に熱処理と酸素プラズマ処理を行ったものである。
この入射エネルギーでは多層膜ミラーのSiO2領域に陽電子が入射しているが、その領域で長寿命成分が光の照射後に大きく減少している。この長寿命成分は非晶質のSiO2の空隙でできたポジトロニウム成分であるが、光の照射によりSiとOの結合が切れてポジトロニウムの形成が抑制されその成分が減少していると考えられる。熱処理後この寿命成分が元に戻っているが、多層膜ミラーの反射率もそれに対応して増減していることから、陽電子のサンプルしている欠陥と反射率を悪化させている欠陥とが同一であると予想される。
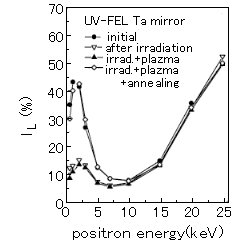
図2 Positron energy dependence of the intensity of the long-lived component for the Ta2O5/SiO2 mirror.(原論文1より引用)
図2はこの長寿命成分の入射エネルギー依存性を測定したものである。この試料では光照射後に長寿命成分が変化しているのはエネルギーの低い領域つまりSiO2の第1層のみであることがわかる。
このように、陽電子の入射エネルギーを変化させて陽電子の寿命を測定すると、試料の特定の深さの欠陥などの微視的構造の変化を非破壊で調べることができる。
低速陽電子ビームによる材料評価では陽電子寿命測定とともに消滅ガンマ線ドップラー広がり測定も用いられる。陽電子寿命測定では、陽電子の寿命が陽電子の消滅位置の電子密度を反映するのに対して、ドップラー広がり測定では、消滅相手の電子の運動量に関する情報を提供することから、寿命測定とは異なった情報を提供する。
そこで、入射エネルギー可変陽電子ビームを試料に入射し、陽電子・電子対が消滅した時に放出される2本のガンマ線の片方を陽電子寿命測定、もう片方を消滅ガンマ線ドップラー広がり測定に用いてその相関測定を行うことにより、欠陥とペアになった不純物など単独の測定よりも詳しい情報を得ることのできる。
コメント :
入射エネルギーを変化させることによって入射深さを変えることのできるパルス陽電子ビームによる陽電子寿命測定法は、表面近傍の特定の深さの領域の欠陥など微視的構造を調べることができることから、半導体デバイス材料などの高機能材料の評価手法として非常にすぐれた方法である。今後、陽電子寿命測定法と消滅ガンマ線ドップラー広がり測定法の相関測定が実現すれば、不純物などについての情報を得ることもできることから、さらに詳しく表面近傍の微視的構造について調べることができると期待される。
原論文1 Data source 1:
Slow Positron Study on Dielectric-Coated Mirror for Free-Electron-Laser Experiments
R. Suzuki, T. Ohdaira, K. Yamada, T. Yamazaki, N. Sei, T. Mikado, T. Noguchi, H. Ohgaki, S. Sugiyama, M. Chiwaki, T. Shimizu, M. Kawai*, M. Yokoyama*, S. Hamada*, K. Saeki#, N. Nishimura#, and T. Tomimasu#
Electrotechnical Laboratory, 1-1-4 Umezono, Tsukuba, Ibaraki 305; *Kawasaki Heavy Industries, Ltd., 1-1 Kawasaki-cho, Akashi, Hyogo 673; #Free-Electron Laser Institute, 4574-44 Tsuda, Hirakata-shi, Osaka 573-01
Journal of Radioanalytical and Nuclear Chemistry, 211 (1996) pp. 47-52
原論文2 Data source 2:
高強度低速陽電子ビームの短パルス化とその応用
鈴木 良一、大平 俊行、三角 智久、大垣 英明、千脇 光國、山嵜 鉄夫、小林 慶規
電子技術総合研究所
電子技術総合研究所彙報 第59巻 第4号 245-258 (1995年)
参考資料1 Reference 1:
Lifetime Measurements with a Pulsed Slow Positron Beam
D. Schodlbauer, G. Kogel, P. Sperr, and W. Triftshauser
Institute fur Nukleare Festkorperphysik der Universitat der Bundeswehr Munchen, Werner-Heisenberg-Weg 39, D-8014 Neubiberg, FRG.
Phys. Stat. Sol., a102 (1987) 549-554
キーワード:陽電子、低速陽電子、パルスビーム、陽電子寿命、エネルギー可変、薄膜、表面近傍
positron, slow positron, pulsed beam, positron lifetime, energy variable, thin film, near surface region
分類コード:170103, 170205
原子力基盤技術データベースのメインページへ