原子力基盤技術データベースのメインページへ
作成: 1999/11/24 岸本 直樹
データ番号 :110064
不純物添加Siの高エネルギー陽子照射に対する耐照射性光伝導
目的 :高エネルギー粒子線照射環境における半導体材料の光電気的性質の耐照射性改善
研究実施機関名 :科学技術庁金属材料技術研究所精密励起場ステーション
応用分野 :核融合プラズマ診断、耐照射性光センサー、耐照射性電子回路、放射線モニター
概要 :
核融合プラズマの計測診断等において、光センサー及び機器電子回路の多くは半導体Siで構成されており、放射線場において健全に動作する光学・電子材料の開発が望まれるが、半導体の光学・電子特性は一般に照射損傷に対して非常に脆弱であり、深刻な課題となっている。本研究では、高エネルギー陽子照射下で、結晶Siの光伝導の照射欠陥量依存性を、その場計測することにより、電子遷移過程の変遷を明らかにするとともに、イオン線量依存性において、不純物濃度に依存した二段階劣化現象を見出した。
詳細説明 :
次期核融合実験装置は、プラズマ物理の基礎研究のみならず炉としての運転をも併せて行うことから、広範なプラズマ診断技術を必要とする。ほとんどのプラズマ診断技術は、その電子回路や光学的素子としてSiを用いている。遠隔操作や放射線遮蔽は、Si素子に対する中性子負荷を軽減することはできるが、部分的にせよSi素子が核融合中性子に曝されることは避けられない。そこで、14 MeV中性子の場合と近似するよう17 MeV 陽子を用いて、シミュレーション照射研究を行った。Siの照射損傷はγ線、電子、中性子、イオンを用い、光物性、輸送現象、電子スピン共鳴等の多様な技術により研究が行われてきた。Siは照射により作られた深い捕獲中心により激しく劣化し、暗伝導度の耐照射性は、浅いエネルギー準位の不純物添加により、ある程度達成されることが知られている。しかしながら、14 MeV付近の中性子あるいは陽子に対する光応答の線量依存性のデータ、特にその場計測によるものは蓄積されていない。
光伝導測定は、光検知器の劣化という問題がないため、照射下のその場光学計測に適していることから、照射欠陥の蓄積に伴う光伝導の実時間変化が測定された。赤外・可視光分光器とHeガス循環冷凍装置(20 - 450 K)がサイクロトロンのビームラインに組み込まれた。17 MeV陽子(40 nA/cm2)と分光された単色光(波長λ = 0.95 μm)は、オーミック電極付きの短冊型Siに対し、交互に照射された。 位相検波法(10 Hz)及びパルス励起法が、それぞれ光伝導スペクトル及び寿命測定に用いられた。
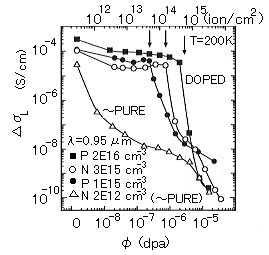
図1 Irradiation fluence dependence of photoconductivity ΔσL at 200 K under 17 MeV proton bombardment for pure Si; N2E12 and doped Si; P1E15, N3E15 and P2E16. The band-to-band transition at λ=0.95 μm is taken. The arrows indicate critical fluences, φC values, where the ΔσL(φ) drops abruptly. (原論文1より引用。 Reprinted with permission from Elsevier Science, Copyright 1996.)
図1は、200 Kにおける17 MeV陽子照射に対する光伝導の線量依存性を示す。試料は無添加 Si; N2E12、不純物添加Si; P1E15, N3E15 及び P2E16である。ここに試料名のNまたはPは、それぞれn型(P添加)またはp型(B添加)を意味する。光伝導強度ΔσL(φ)は、λ = 0.95 μmのバンド間遷移に対応する。矢印は、ΔσL(φ)が急激に落ち始める照射線量を示し、"臨界線量φC"(臨界条件での照射欠陥量)と名付けられた。本方法により、光伝導の実時間変化が得られ、n型及びp型Siは両者とも明瞭な二段階の依存性を示すこと、及び臨界線量が不純物濃度と相関を持つことが分かった。図から明らかなように、無添加Siが低線量から急激に劣化するのに比べて、不純物添加材は、約千倍程度の照射線量まで、その光感度を維持した。
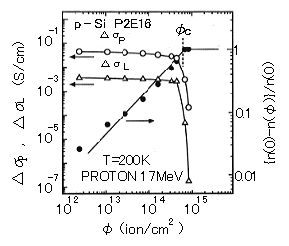
図2 Irradiation fluence dependencies of proton-induced conductivity ΔσP and photoconductivity ΔσL of the doped Si P2E16, at 200 K. A fraction of the trapped carriers to the initial carriers, {n(0)-n(φ)}/n(0), is also plotted, together with φC. (原論文1より引用。 Reprinted with permission from Elsevier Science, Copyright 1996.)
図2は、p型Si試料P2E16の17 MeV陽子照射に対する陽子線誘起伝導ΔσP、及び光伝導ΔσLの線量依存性を示す。照射前キャリヤー密度に対する捕獲キャリヤー密度の比{n(0)-n(φ)}/n(0)を示す。この図から分かるように、ΔσP及びΔσLは相似的な照射線量依存性を示し、添加されたキャリヤーが照射欠陥によって捕獲し尽くされないうちは安定で、それ以降は急激に低下した。パルス励起法によるキャリヤー寿命の測定結果より、この急激な劣化は、移動度変化によるのではなく、キャリヤー寿命が急激に短かくなることに起因することが分かった。従来、線量依存性のデータは電子線照射に対して得られているが、その場計測による17 MeV陽子の線量依存性は、二段階的変化の折れ曲がりが、はるかに明瞭である。この差異は、17 MeV陽子が電子と比べてより強い捕獲効率を持つ欠陥を生成するということを示唆している。
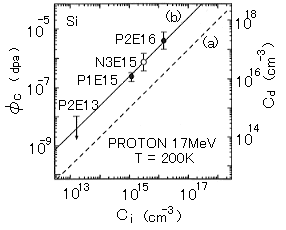
図3 Relationship between the critical fluence φC and the shallow impurity concentration Ci of the specimens measured. For P2E13, only the upper limit of the φC is shown. Line (a) denotes a 1:1 correspondence between defects and shallow impurities and the line (b) indicates that ten defects capture one carrier in average. (原論文2より引用。 Reprinted with permission from American Institute of Physics, Copyright 1995.)
図3は、種々の不純物添加Siについて、臨界線量φCと浅い不純物濃度Ciの間の相関関係を示す。p型試料P2E13については、臨界線量が小さいことから、上限値のみが与えられている。図中、直線 (a)は、1:1対応を示し、直線(b)は、10:1対応、すなわち、10個の生成欠陥が1個の不純物原子に対応する。ここに、臨界線量φCは、照射前の自由キャリヤー(浅い不純物より生成)を捕獲するのに必要な一次生成欠陥濃度である。すなわち、捕獲中心が一価であると仮定すると、一次欠陥濃度φCのときの残存欠陥濃度は不純物濃度(既知)に等しいことから、本方法は、一次欠陥濃度と残存欠陥濃度との間の定量的関係を与える。本照射条件で200 Kのとき、照射欠陥が残存する割合は1/10ということになる。このように、浅いエネルギー準位の不純物を添加すると二段階劣化挙動及び耐照射性を示すこと、及び自由キャリヤーと照射欠陥の捕獲過程に関する定量的な情報が得られた。
コメント :
半導体Siは、粒子線が照射されると、電気伝導度及び光感度が急激に低下する。従来、特に光感度劣化の改善は困難とされ、部品交換や放射線遮蔽以外に対策がなかった。本研究では、非照射では好ましくない不純物の添加を、逆に利用することにより、照射下光応答について、無添加Siより千倍程度の高い耐照射性が得られた。この特性を利用して、耐放射線性光検知器と積算線量モニターの特許(参考資料)が取得された。宇宙、原子炉や加速器等の放射線環境で、信頼性のある光検知や簡便な積算線量モニターが可能となる。
原論文1 Data source 1:
Radiation-Resistant Photoconductivity of Doped Silicon under 17 MeV Proton Bombardment
N. Kishimoto, H. Amekura, K. Kono and T. Saito
National Research Institute for Metals, 1-2-1 Sengen, Tsukuba, 305-0047, Japan
J. Nucl. Mater. 233-237 (1996) 1244-1248.
原論文2 Data source 2:
Photoconductivity Evolution due to Carrier Trapping by Defects in 17 MeV-Proton Irradiated Silicon
Hiroshi Amekura, Naoki Kishimoto and Tetsuya Saito
National Research Institute for Metals, 1-2-1 Sengen, Tsukuba, 305-0047, Japan
J. Appl. Phys. 77 (1995) 4984-4992.
原論文3 Data source 3:
Particle-Induced Conductivity and Photoconductivity of Silicon under 17 MeV Proton Irradiation
Hiroshi Amekura, Naoki Kishimoto and Kenichiro Kono
National Research Institute for Metals, 1-2-1 Sengen, Tsukuba, 305-0047, Japan
J. Appl. Phys. 84 (1998) 4834-4841.
参考資料1 Reference 1:
特許: 耐放射線性・不純物補償型光検知器
岸本 直樹, 雨倉 宏
National Research Institute for Metals, 1-2-1 Sengen, Tsukuba, 305-0047, Japan
特許登録第2884037号, 1999年2月12日.
参考資料2 Reference 2:
特許: 高エネルギー粒子線用積算線量モニター
岸本 直樹, 雨倉 宏
National Research Institute for Metals, 1-2-1 Sengen, Tsukuba, 305-0047, Japan
特許登録第2535786号, 1996年7月8日.
キーワード:耐照射性, 光伝導, ケイ素, 不純物添加, 高エネルギー陽子照射, 浅い不純物, キャリヤー捕獲, 核融合炉
radiation resistance, photoconductivity, silicon, impurity doping, high energy proton irradiation, shallow impurity, carrier trapping, fusion reactor
分類コード:110403, 110503
原子力基盤技術データベースのメインページへ