原子力基盤技術データベースのメインページへ
作成: 1999/11/26 成島 哲也
データ番号 :110043
シリコンのプラズマ酸化膜成長速度の表面方位依存性
目的 :酸素プラズマによる酸化膜成長過程におけるシリコンの面方位依存性の解明
研究実施機関名 :科学技術庁金属材料技術研究所第2研究グループ
応用分野 :原子炉材料、半導体プロセス、高信頼性極薄酸化膜形成の研究
概要 :
実時間偏光解析により、シリコンのプラズマ酸化の速度論的研究を行った。この研究により、特に酸化膜厚(2-3nm)以下の薄い膜領域において、プラズマ酸化速度が面方位によって異なることが明らかになった。すなわち、1000sまでの酸化過程でいずれの時間でもSi(111)の酸化速度はSi(100)より大きいことがわかった。これはダングリングボンドの表面密度の差異が面方位依存性に関係することを表している。
詳細説明 :
プラズマ酸化は、酸素プラズマを利用することで熱酸化では不可能な低い温度でもシリコン表面に酸化膜を成長させることが出来るという点で有利な手法である。ところで、酸素プラズマ中には中性の酸素分子のほかに、イオン、単原子、及び電子が存在するため、酸素ガス中の熱酸化に比べてシリコンの酸化はより複雑であり、酸化膜の成長過程についてはまだ十分よく理解されてはいない。シリコンの酸化はMOS(Metal Oxide Semiconductor)型半導体素子の製造において鍵となる重要なプロセスであり、素子の高集積化に伴い、絶縁性の優れた極薄酸化膜(< 5nm)の生成が要求されるようになってきている。また、核融合炉第一壁の研究において、最近シリコン系膜は核融合炉第一壁材の新たな候補材の一つにあげられており、そのプラズマとの相互作用の研究が必要となっている。よって、プラズマ酸化におけるシリコンの表面方位依存性を詳細に研究することは、これらの分野の発展のための一助となる。
シリコン表面の面方位の違いは極薄酸化膜特性に影響することが知られている。熱酸化の面方位依存性についてはいくつかの報告があるが、プラズマ酸化については定量的な研究データは少ない。Rayらは、RFプラズマでの酸化速度の測定を行ったが、Si(111)とSi(100)に有意な差異を見いだしてはいない。そこで、本研究では、実時間偏光解析の測定によりプラズマ酸化の面方位依存性の研究を行った。偏光解析法は物質を透過した光あるいは表面で反射された光の偏光状態から物質の光学的性質を測定する方法で、半導体等の表面処理や薄膜製造プロセスモニターとして有用である。
物質表面のプラズマ反応の観点から考えると、偏光解析は 1)非接触、非破壊であること、2)試料温度を選ばないこと、3)プラズマ雰囲気のような「過激な」試験雰囲気中でも測定できること、4)その場測定や実時間測定が可能なこと、5)プラズマ酸化開始直後からの変化を検出できること、6)他の測定あるいは表面処理と併用できることなどの長所を有している。このような観点から、種々の表面分析手法がある中で、偏光解析はプラズマ利用による膜成長過程、蒸着過程、表面侵食過程等の実時間測定に有効な研究手法である。
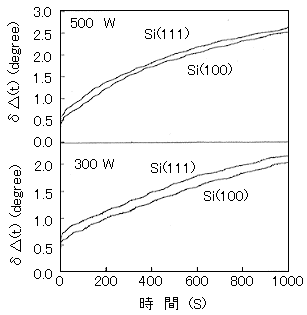
図1 実時間偏光解析で測定したSi(111)及びSi(100)のプラズマ酸化開始直後からのΔの相対変化δΔ(δΔ(t)=Δ(0)-Δ(t))と酸化時間との関係。(原論文2より引用。 Reprinted with permission from American Vacuum Society, Copyright 1994.)
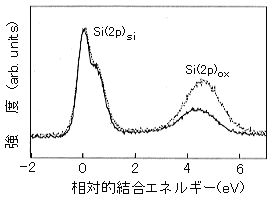
図2 プラズマ酸化後のSi(111)及びSi(100)のXPSスペクトル。実線:Si(100)、破線:Si(111)。RF電力は200W、ガス圧は2.0Pa及び酸化時間は1.4x104秒である。(原論文1より引用。 Reprinted with permission from Elsevier Science, Copyright 1993.)
図1はSi(111)とSi(100)に関して酸化時間とδΔ(δΔ=Δ(0)-Δ(t), Δ:偏光成分の相対的位相差あるいは膜厚)との関係であり、プラズマ酸化開始後1000sまでの変化を表す。プラズマ酸化は、試料温度は室温、酸素ガス圧は2Pa、RF電力は300Wおよび500Wで行ったものである。いずれの電力においても、δΔは全測定時間範囲においてSi(111)がSi(100)より大きい。(すなわち、酸化速度は(111)の方が大きい。)これは酸化試験後のXPS測定の結果とも対応する(図2)。XPSスペクトルから膜厚を求めると、Si(111)では1.7nmであり、Si(100)では1.3nmであった。また、同酸素ガス圧での熱酸化の実時間測定の結果を図3に示す。δΔはプラズマ酸化と同様にSi(111)がSi(100)より大きいことがわかる。

図3 熱酸化によるSi(111)及びSi(100)のΔの相対変化(δΔ)と酸化時間との関係。酸化温度は400℃である。(原論文2より引用。 Reprinted with permission from American Vacuum Society, Copyright 1994.)
Siの清浄表面は、表面に局在化されたダングリングボンドにより、化学活性が高いといわれている。Si(111)表面のダングリングボンドの数がSi(100)より多く、2)酸化の表面方位依存性(プラズマ酸化でも熱酸化でもSi(111)の酸化速度がSi(100)より大きい。)はO,O-あるいはO2等の酸化種の選択的な表面ダングリングボンドとの反応によると考えられる。
コメント :
高信頼の絶縁性を有する極薄のシリコン酸化膜の生成することは、現在の特にMOS型半導体産業分野において非常に重要なプロセスである。これまで用いられてきた熱酸化による生成法ではSi/SiO2界面に生成過程由来の歪みが残留してしまい、これが回路の絶縁性ひいては信頼性に悪影響を及ぼしてきた。本研究のようなプラズマを用いた酸化法で生成した酸化膜はこれらに比べると界面における歪みを低減することが出来、信頼性を向上することが出来ると期待をされている。
原論文1 Data source 1:
Silicon wafer orientation dependence in the initial plasma oxidation processes
H. Kuroki, K.G. Nakamura, T. Kawabe and M. Kitajima
National research institute for Metals
Solid State Commun., 88 (1993) pp. 487-489.
原論文2 Data source 2:
Real-time obsevation of ultrathin silicon oxide film growth using rapid ellipsometry
H. Kuroki, K.G. Nakamura, I. Kamioka, T. Kawabe and M. Kitajima
National research institute for Metals
J. Vac. Sci. Technol. A12(4) (1994) pp. 1431-1434.
参考資料1 Reference 1:
A.K. Ray
J. Electrochem. Soc., 128 (1981) 2461.
参考資料2 Reference 2:
吉信 淳、田中 慎一郎、西島 光昭
応用物理 60 (1991) 1196.
キーワード:プラズマ酸化、シリコン、表面方位、実時間偏光解析、極薄酸化膜
plasma oxidation, silicon, surface orientation, real-time ellipsometric observation, ultrathin oxide film
分類コード:110101, 110501
原子力基盤技術データベースのメインページへ