原子力基盤技術データベースのメインページへ
作成: 1999/11/01 山本 春也
データ番号 :110041
Nb/Cuエピタキシャル多層膜の作製およびキャラクタリゼ-ション
目的 :Nb/Cuエピタキシャル多層膜の作製およびキャラクタリゼ-ション
研究実施機関名 :日本原子力研究所高崎研究所材料開発部高機能材料第2研究室
応用分野 :核融合炉材料、多層膜光学素子材料、超伝導材料、水素吸蔵材料
概要 :
超高真空中の電子ビーム蒸着法により、α-Al2O3単結晶基板上に基板温度および蒸着速度を制御してNb/Cuエピタキシャル多層膜の作製を試みた。エピタキシャル膜はラザフォード後方散乱法およびX線回折により結晶方位関係などの構造評価を行った。Cu/Nb系ではお互い稠密面で積層した Cu(111)/Nb(110)がもっと結晶性の高いエピタキシャル多層膜の作製が可能であることがわかった。
詳細説明 :
Nb-Cu系はほとんど相互に固溶しないため急峻な界面をもった多層膜の作製が期待され、金属多層膜のモデル材料として多くの研究がなされている。しかし、そのほとんどが多結晶で積層した多層膜であり、界面構造が深く関わる電気的性質の膜厚依存性などの研究では、平坦な界面の形成が期待できる単結晶による積層が求められていた。本研究ではNbとCuからなる多層膜を超高真空下で電子ビーム蒸着法によりα-Al2O3単結晶基板上に積層した。α-Al2O3基板上のNbエピタキシャル膜の成長条件について調べるために、基板温度600℃〜800℃の範囲で種々の面方位のα-Al2O3基板面上に10-6 Pa台の真空下で、蒸着速度が約0.1 nm/secで厚さが約100 nmのNbを成膜した。

図1 Random and < 110> aligned spectra of 2.0 MeV 4He+ ions from single-crystalline Nb films (thickness: 107.4 nm) on α-Al2O3 (11-20) substrate. (原論文1より引用。 Copyright 1998, with permission from Elsevier Science.)
図1に基板温度750℃で蒸着したNb/α-Al2O3(1120) からのランダム入射およびNb< 110>軸入射の条件における後方散乱スペクトルを示す。解析ビームとして、2.0 MeV 4He+を入射し、荷電粒子検出器により散乱されたイオンを散乱角165°で計測した。Nb< 110>軸入射条件では、表面ピークおよびNb/α-Al2O3界面近傍の結晶の乱れによるピークが現れている。RBS/チャネリング法では軸チャネリングおよびランダム入射における後方散乱収量の比χmin(最小散乱収量)から結晶性を評価することができる。2.0 MeV 4He+のビーム条件の場合、Nbの完全結晶を仮定したNb< 110>軸のχminの計算値は0.043であり、実験値の0.043と一致している。この事から界面近傍を除いて非常に結晶性の高いNb膜が成膜されていることがわかる。
また、Nb膜上で解析ビームの位置を数箇所変えてχmin値を評価して結果、各点におけるχmin値は計算値とほぼ一致した値を示した。これよりNbの蒸着された領域の結晶性は一様であることがわかった。さらにX線回折測定よりNb膜と基板の間の方位関係は、Nb(110)/α-Al2O3(11-20) であることがわかった。基板温度750℃で、Nbをα-Al2O3の(0001),(1-102) および(10-10) 面に蒸着した試料の測定結果, 各面方位のα-Al2O3 基板に対してNb(111)/α-Al2O3(0001), Nb(001)/α-Al2O3(1-102), Nb(211)/α-Al2O3(10-10) の関係でNbエピタキシャル膜が成膜されていることがわかった。

図2 RBS/channeling spectra of 2.7 MeV 4He+ ions from Nb(50 nm)/Cu(50 nm)/Nb(50 nm) hetero-epitaxial multilayer on α-Al2O3(11-20). (原論文1より引用。 Copyright 1998, with permission from Elsevier Science.)
図2はα-Al2O3 基板上にNb(50 nm)とCu(50 nm)膜をそれぞれ750℃および200℃の基板温度で蒸着し、さらに基板温度500℃で50 nmのNb膜を蒸着した試料のランダム及びNb< 110>軸入射での後方散乱スペクトルを示している。スペクトル上の各ピークは高エネルギー側より表面側のNb層、基板上のNb層そしてCu層に対応している。これよりNb(110)/Cu(111)/Nb(110)/α-Al2O3(11-20) 基板の結晶方位関係でエピタキシャル成長することがわかった。
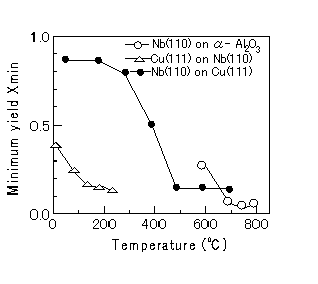
図3 χmin, relative fraction of the axial channeling minimum yields for Cu and Nb layers on α-Al2O3(11-20) substrate is plotted as a function of substrate temperature. Open circles are for the Nb(110) layer with 100 nm thickness on α-Al2O3 and triangles are for the further growth of Cu(111) layer with 50 nm thickness on Nb(110)/α-Al2O3. Solid circles in the temperature change of RT-700℃ are for Nb(110) on Cu(111)/Nb(110)/α-Al2O3. (原論文1より引用。 Copyright 1998, with permission from Elsevier Science.)
図3に基板温度に対するα-Al2O3(11-20) 基板上のNb(110)膜(○)、Nb(110)膜上のCu(111)膜(△)およびCu(111)層上のNb膜(●)のχmin 値を示した。この図よりNbおよびCuの蒸着速度が約0.1 nm/secの場合、基板温度: 750℃程度でα-Al2O3(1120) 基板上に蒸着することにより結晶性の高いNb(110)膜が得られることがわかる。またNb(110)膜上のCu(111)膜は基板温度: 200℃程度さらにCu(111)膜上のNb(110)膜は500℃以上で蒸着することにより結晶性の高いエピタキシャル膜が得られることがわかる。
コメント :
薄膜の構造解析において、特にエピタキシャル膜の面方位の決定にはX線回折法が有用である。深さ方向の結晶性の情報はRBS/チャネリング法により評価できる。したがって、X線回折法とRBS/チャネリング法を互いに相補的な分析法として用いることにより、信頼性の高い測定が可能となる。一方、エピタキシャル膜の作製に関してα-Al2O3基板上に直接エピタキシャル成長が困難なAl, Ni, Pd, Coなどについても、Nb単結晶膜をバッファー層として用いることによりエピタキシャル成長する可能性があり、種々のエピタキシャル多層膜の作製が期待される。
原論文1 Data source 1:
Characterization of epitaxially grown Cu/Nb multilayer on α-Al2O3 with RBS/channeling technique
S. Yamamoto, H. Naramoto, B. Tuchiya, K. Narumi and Y. Aoki
Japan Atomic Energy Research Institute, 1233 Wataniki Takasaki, Gunma, 370-1292, Japan
Thin Solid Films 335 (1998) 85-89.
原論文2 Data source 2:
Characterization of single-crystalline Nb films on sapphire by RBS/channeling technique
S. Yamamoto, H. Naramoto, K. Narumi, B. Tsuchiya, Y. Aoki, H. Kudo
Japan Atomic Energy Research Institute, 1233 Wataniki Takasaki, Gunma, 370-1292, Japan
Nucl. Instr. Meth. B 134 (1998) 400-404.
参考資料1 Reference 1:
Characterization of single-crystalline Cu/Nb multilayer films by ion beam analysis
S. Yamamoto, H. Naramoto B. Tsuchiya and Y. Aoki
Japan Atomic Energy Research Institute, 1233 Wataniki Takasaki, Gunma, 370-1292, Japan
Functionally Graded Materials 1996, ed. I. Shinoda and Y. Miyamoto (Elsevier Science B.V., 1997) pp. 719-723.
キーワード:ニオブ、銅、多層膜、 エピタキシャル、ラザフォ-ド後方散乱法、 X線回折
Niobium, Copper, Multilayer, Epitaxial, RBS, XRD
分類コード:110302, 110502
原子力基盤技術データベースのメインページへ