�����ϴ����ѥǡ����١����Υᥤ��ڡ�����
������ 1999/11/19 ī��������
�ǡ����ֹ桡������110039
���ե�������ľ�ؤΥ��륳�˥�����Υ��ԥ����������Ĺ
��Ū��������������������¸�ߤ���ñ�о��ϥΥ�ɡ��ץ��륳�˥�ñ�뾽����γ�ȯ
����»ܵ���̾�������ܸ����ϸ����ʪ���ʳظ������˸�ʪ�����楰�롼��
����ʬ���������ʪ���������桢��������Ƴ���桢��ٺ����������Ų������
���ס�������������
�������ʸ����Ų������١�����������Ȥ��Ƥβ�ǽ����ͭ����ZrO2����κ������ߡ�������ñ�뾽�Ȥ������뤳�Ȥ������̵ź��ñ�о���ZrO2�Υ��ԥ������������ΰ������ǽ�ˤ�����
��
�ܺ���������������
���������륳�˥���ϡ��ȥ�������ʬ�뤤�ϳ�Ǯ���ѿ�����¤���ܻؤ����ⲹ������Ų��Ѹ����Ų�����ޤ���١�����������Ȥ��Ƹ�����ʬ���Ϥᤢ����ʬ��Ǥα��Ѥ����Ԥ���Ƥ��롣�������ʤ��顢�������륳�˥����1170���ն����������ñ�о��Ϥε�ʳʻ�������Ѳ���ȼ�����֤������뤿�ᡢ�ɼ���ñ�뾽�������������Ƥ��餺�������Ǥα��Ѥ�����Ǥ��롣�ޤ���ñ�о��ϻ������륳�˥���Υ�������Ƴ���������������ʤɤ����餫�ˤ���Ƥ��ʤ������ߡ��Խ�ʪ��ź�ä����경�������������륳�˥���Τߤ��͡��ʼ�ˡ�ˤ�������Ƥ��뤬�������ʸ����Ų������١�����������Ȥ��Ƥβ�ǽ����õ�뤿�ᡢ��������ΰ��Ǥ���ʬ�������ԥ�������ˡ���Ѥ�̵ź��ñ�о��ϻ������륳�˥���������������ߤ���
��
��ʬ�������ԥ���������Ķ�⿿������ȯ��������ʬ�ҥӡ�����Ǯ��������l���ȼͤ���1�����ؤ������椷�ʤ�����ľ�˥��ԥ������������(�뾽�������Ĥη뾽���ˤ����ä�ñ�뾽����)����Ĺ�������ˡ�Ǥ��롣ʬ�������ԥ�������ˡ���̾�ο�������Ȱۤʤ�Τϡ���Ĺ��ο����٤Ǥ��롣1�����ؤ�������ǽ�Ȥ��뤿�ᡢʬ�������ԥ��������ˤ����Ƥ�����1���������٤Ȥ����Ƥ�ä��ꤷ����Ĺ®�٤ˤ��롣�������̾�ξ���Τ褦��lxl0-4Pa���٤ο���������Ĺ��Ԥ�������ɽ�̤����ӹ����α����ʬ�Ҥ����٤���Ĺ����˼����ޤ��Ȥ���ȡ���Ĺ��ι������Ҥ�Ʊ���٤ο����Խ�ʪ���Ҥ������ޤ졢�����ƽ��٤ΰ����줷�������ʤ����Ȥˤʤ롣�����ǡ�ʬ�������ԥ��������ˤ����Ƥ��̾�10-8��10-9Pa��Ķ�⿿�����Ѥ����롣
��
����ȯ���λ������륳�˥�����Żҥӡ���Dz�Ǯ��������®��0.01nm/s�����IJ��٤ϼ�������1000��ˤ����ƾ����Ԥ���RHEED�ˤ��ѻ����ʤä���RHEED��20keV���٤��Ż��������ɽ�̤��줹������ͤ�������ɽ�̾���������Ҥˤ�äƲ��ޤ����塢�����Ż������������֤��줿�ָ������������Ƥơ���������ѻ������ΤǤ��롣�Ż��������ɽ�̤��줹������ͤ����뤿�ᡢ�ŻҤϻ���ɽ�̤�1��2�����ؤ����������ʤ��Τǡ�������ɽ�̤θ�������˴ؤ������������Ĺ�����Ǥ����뤳�Ȥʤ��ꥢ�륿������Τ뤳�Ȥ��Ǥ�����ħ��ͭ���롣

��1��RHEED patterns of ZrO2 film grown with 3 molecular layers on sapphire-R substrate. The incident electron beam is parallel to (a) [100], (b) [110] and [010] axis of ZrO2, respectively. �ʸ���ʸ1�����ѡ���Copyright 1997, with permission from Elsevier Science.��
����1�˼������Τϡ����ĤȤ����Ѥ������ե�����ñ�뾽ɽ�̤˻������륳�˥����3����Ĺ�������ݤ�RHEED���Ǥ��롣�ɹ��ʥ��ԥ����������Ĺ�ˤ��ʿó��ñ�뾽ɽ�̤ˤʤ��RHEED�����̾盧�Τ褦�ʥ��ȥ���ѥ������ʤ���岼�˿��Ӥ����åɾ��ˤʤꡢ��Ĺ��Υ��ԥ�����������ɽ�̤η��֤��˥������뤳�Ȥ��Ǥ��롣�ޤ���RHEED���ˤ�ꥵ�ե�������ĤȻ������륳�˥�������Ȥ���Ĺ���̴ط������餫�ˤʤ롣ʪ����ñ�뾽ɽ�̾���̤�ʪ������Ĺ�����褦�Ȥ����硢���٤Ƥ��ڤ줿�ܹ�꤬�����˷�Ф졢�ɹ��ʥ��ԥ����������Ĺ���ʤि��ˤϡ�2�Ĥ�ʪ���֤Ƿ뾽��¤��������Ƥ��뤳�Ȥ�ɬ�פˤʤ롣���ե�����ñ�뾽ɽ�̤Ȼ������륳�˥���ǤϷ뾽��¤���褯������Ƥ����ɹ��ʥ��ԥ����������Ĺ����ǽ�Ȥʤä��ȹͤ����롣
��
������ˡ���2��3�ˤߤ���褦��X������ˡ�ˤ��ñ�о��������륳�˥������������(002)��(004)�Υ��㡼�פʥԡ�������¬���졢�ֳ����ۼ����ڥ��ȥ�ˡ�εۼ����ڥ��ȥ�ˤ��ñ�о��ϤǤ��뤳�Ȥ�Ʊ�ꤵ�줿��
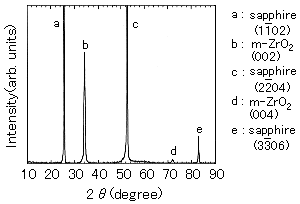
��2��X-ray diffraction pattern (CuK��) of an ZrO2 film grown with 20 nm thickness on sapphire-R substrate. The letter m-ZrO2 represents the monoclinic ZrO2 phase. �ʸ���ʸ1�����ѡ���Copyright 1997, with permission from Elsevier Science.��

��3��IR absorption spectrum of an ZrO2 film grown with 20 nm thickness on sapphire-R substrate. The letter m-ZrO2 represents the monoclinic ZrO2 phase. �ʸ���ʸ1�����ѡ���Copyright 1997, with permission from Elsevier Science.��
��
�����ȡ���������
���ܸ���ˤ��ʬ�������ԥ�������ˡ���Ѥ������������뤳�Ȥ�����Ǥ��ä�����������ñ�뾽���������������������奤������Ƴ�����β������̤���ͥ�줿�Ų��Ѹ����Ų��������ʤ��١�����������γ�ȯ�����Ԥ���롣
��
����ʸ�� Data source 1��
Epitaxtial Growth of Zirconium Dioxide Films on Sapphire Substrates
H. Asaoka, Y. Katano and K. Noda
Japan Atomic Energy Research Institute, Tokai-mura, Naka-gun, Ibaraki 319-1195.
Appl. Surf. Sci. 113/114 (1997) 198-201.
������ɡ�MBE�����졢�뾽��Ĺ�����륳�˥���RHEED��IR��XRD
MBE, thin films, crystal growth, zirconia, RHEED, IR, XRD
ʬ�ॳ���ɡ�110501, 110503, 110101
�����ϴ����ѥǡ����١����Υᥤ��ڡ�����