原子力基盤技術データベースのメインページへ
作成: 1998/08/20 小林 慶規
データ番号 :110012
陽電子ビームを利用した高分子の損傷非破壊検出
目的 :低速陽電子ビームの開発と損傷解析への応用
研究実施機関名 :通商産業省物質工学工業技術研究所
応用分野 :高分子の損傷解析
概要 :
測定対象に陽電子線を照射した時に発生するγ線を測定することにより、物質の疲労・損傷を解析することができる。近年陽電子をエネルギー可変のビームとして利用する技術が発展し、消滅γ線ドップラー広がり測定により損傷の深さ分布測定も行われるようになってきた。しかし、この方法の金属・半導体以外の材料への適用性についてはほとんど検討されていない。イオン照射した高分子の損傷解析を試み、この陽電子ビーム法の有用性を確認した。
詳細説明 :
陽電子(e+)は電子(e-)と同じ質量(m)を持つが、電荷がプラスの粒子(反粒子)である。陽電子は真空中では安定であるが、物質中では大量に存在する電子の1つと対消滅と呼ばれる現象を起こし、短時間のうちに消滅してしまう。この際、通常、2本のγ線が放出される。消滅する陽電子と電子の両方が静止していれば、γ線のエネルギーはアインシュタインの式から
E=2mc2/2=mc2=0.511MeV
となる。ところが、消滅する陽電子-電子対がγ線放出方向に平行な運動量を持っていると、ドップラー効果によりγ線エネルギーが0.511MeVから変化する。当然のことながら、このドップラーシフトは運動量が大きい場合ほど大きく、陽電子消滅により生じたγ線のエネルギー分布を解析することにより、消滅時の陽電子と電子の状態に関する知見を得ることができる。
本実験に使用した低速陽電子ビーム装置の模式図を図1に示す。試料室は線源側と電気的に絶縁されており、線源側に任意の高電圧を印加することにより、ビームエネルギーを自由に設定することができる。厚さ25μmで密度1.285g/cm3のポリエーテルエーテルケトン(PEEK)フィルムに1MeVおよび2MeVの酸素イオン(O+)を照射した試料について陽電子消滅ドップラー広がり測定を行った。PEEKは耐熱性にすぐれた高分子で、今後広範囲な利用が期待される材料である。イオン照射の最大照射量は6×1014ions/cm2であった。イオンの侵入深さをTRIMコードによりシミュレーション計算したところ、1MeV照射の場合1.7μm、2MeV照射の場合2.6μmであった。消滅γ線のプロファイルは、Sパラメーターにより評価した。Sパラメーターというのは、消滅γ線ピークの中央部分のカウント数のピーク全体のカウント数に対する割合で、値が大きいほどドップラー広がりがせまいことを示している(図1)。

図1 Variable-energy positron beam system.(原論文3より引用)
図2、図3に入射陽電子エネルギーを変化させて測定したSパラメーターを示す。
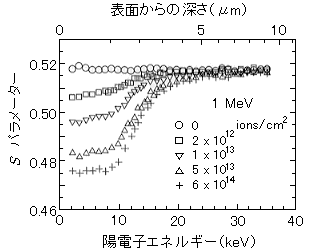
図2 S-parameters for poly (ether-ether ketone) (PEEK) irradiated with O+ ions of 1 MeV.(原論文3より引用)
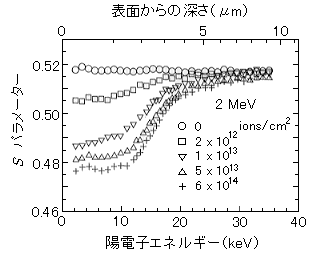
図3 S-parameters for PEEK irradiated with O+ ions of 2 MeV.(原論文3より引用)
陽電子の入射エネルギーと平均侵入深さの間には、次の関係があることが知られている。
< z>=(0.04/ρ)E1.6
ここで、< z>(μm)は陽電子の平均侵入深さ、ρ(g/cm3)はPEEKの密度、E(kV)は入射陽電子エネルギーである。図2、図3にはこの式から得られた陽電子の平均侵入深さも示されている。未照射試料のSパラメーターはほぼ一定であり、未照射試料が深さ方向に均一であったことを示している。イオン照射量が増加するにつれ、比較的低い陽電子エネルギーにおけるSパラメーターが減少している。これは、表面付近のイオンが通過した領域が損傷を受けたことを示している。
金属や半導体にイオン照射を行った場合、欠陥が生成し陽電子が捕獲されるため、Sパラメーターが増加することが知られているが、本実験はこれとは逆にSが減少している。また、図2、図3から、2MeVの酸素イオンを照射した場合の方が1MeV照射の場合と比べてSパラメーターの変化が高陽電子エネルギーまで及んでいることがわかる。この結果は、TRIMコードで計算されたイオンの侵入深さが2MeV照射の場合2.6μmで、1MeV照射の場合の1.7μmより大きいこととよく対応している。
コメント :
陽電子ビームドップラー広がり測定法による高分子の損傷のデプスプロファイリングは、ポリイミドなどの一部の高分子には適用できないという制約はあるが、初期段階の損傷を検出できるだけでなく、損傷の深さ分布が非破壊的に測定できるという特徴があり、今後多様な材料への応用が期待される。
原論文1 Data source 1:
Damage-depth profiling of an ion-irradiated polymer by monoenergetic positron beams
Y. Kobayashi, Isao Kojima, Shunichi Hishita, Takenori Suzuki, E. Asari and M. Kitajima
National Institute of Materials and Chemical Research, Tsukuba, Ibaraki 305-8565, Japan
Phys. Rev. B52, 823 (1995).
原論文2 Data source 2:
Damage depth-profiling of Au+ and O+-irradiated amorphous PEEK by monoenergetic positron beams
K. Hirata, Y. Kobayashi, S. Hishita and Y. Ujihira
National Institute of Materials and Chemical Research, Tsukuba, Ibaraki 305-8565, Japan
Appl. Phys. A64, 491 (1997).
原論文3 Data source 3:
陽電子ビームを利用した高分子の損傷非破壊検出
小林 慶規、平田 浩一
通商産業省物質工学工業技術研究所
検査技術 Vol. 2, No. 5, 28 (1997).
キーワード:エネルギー可変陽電子ビーム、ドップラー広がり測定、PEEK(ポリエーテルエーテルケトン)、損傷解析
variable-energy positron beam, Doppler broadening, PEEK(polyaryl-ether-ether ketone), damage analysis
分類コード:110203, 110401
原子力基盤技術データベースのメインページへ