原子力基盤技術データベースのメインページへ
作成: 1998/10/25 羽田 肇
データ番号 :110009
二次イオン質量分析法による気相合成ダイヤモンド中の軽元素不純物の評価とその混入制御
目的 :2次イオン質量分析法(SIMS)によるセラミックス中の微量分析
研究実施機関名 :無機材質研究所第4研究グループ
応用分野 :構造材料、高温材料、光学材料、電子材料、半導体材料
概要 :
気相合成ホモエピタキシャルダイヤモンド中の軽元素不純物の評価と不純物混入を抑制する手法に関する研究をSIMSを用いて行った。(100)ホモエピタキシャルダイヤモンド中には水素は含まれず、反応容器からのシリコンだけが検出された。(111)ホモエピタキシャルダイヤモンド中には水素とシリコンが検出された。しかし、両方の試料中には酸素の混入は認められない。これらの不純物混入は合成の原料ガスに酸素を添加することで完全に抑制することが可能である。また、酸素無添加の(111)ホモエピタキシャルダイヤモンドにはダイヤモンド以外の相が含まれるがこれも酸素添加により抑制できる。従って、酸素はダイヤモンドに混入することなく不純物混入を抑制し、バルクの結晶性を向上させる合成に有効な添加ガスである。
詳細説明 :
セラミックス材料には必ず極微量の不純物が含まれている。この不純物は高品位の材料合成に必要不可欠の場合もあれば、逆に特性を劣化させる原因にもなり得る。そこで、材料内の微量不純物の量や分布に関する評価は高品位材料合成に欠かせない情報である。2次イオン質量分析法(SIMS)は、深さ方向に高感度分析可能な装置である。
本報ではSIMSを応用した研究の1例として、気相合成(CVD)ダイヤモンド中の軽元素の不純物評価とその不純物混入抑制に関する研究を紹介する。ダイヤモンドは高い熱伝導性、硬度等の特性から幅広い分野での応用が期待されている材料の1つである。しかし、CVDダイヤモンドは、その合成環境を考えれば、水素等の軽元素不純物が含まれ、それがCVDダイヤモンドの品位に多大な影響を与えているのは明白である。しかし、現在までに不純物と結晶の関係は明らかにされていないのが現状である。
実験はマイクロ波CVD法で、高圧合成され研摩済みの(100)と(111)面にダイヤモンドを成長させた。合成は200ー100ml/minの全流量中にメタンを1%に水素希釈したガスで、これに酸素を0ー1%まで添加した。基板温度は830ー880℃になるようにマイクロ波を調整した。このようにして合成したダイヤモンド表面を走査型電子顕微鏡で評価し、膜内の結晶性をラマン分光法した。さらに、膜内の不純物の評価をSIMSで行った。SIMSで測定する場合に、水素のバックグラウンドを低減するために、1次イオンの電流密度の最適化とさらにサンプルを液体窒素温度にまで下げて分析を行った。

図1 Depth profile of (100) homoepitaxial diamond.(原論文1より引用。 Reprinted with permission from Data source 1 below. Copyright 1997, American Institute of Physics.)
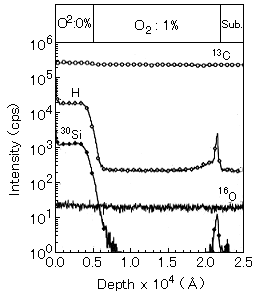
図2 Depth profiles obtained from two layered (111) homoepitaxial diamond films.(原論文2より引用。 Reprinted with permission from Data source 2 below. Copyright 1998, American Institute of Physics.)
図1は(100)面上に合成したダイヤモンド多層膜から得られたSIMSの深さ方向プロファイルである。合成中に原料ガスに添加した酸素濃度は最初最大濃度で最後に無添加にしてある。(100)ホモエピタキシャルダイヤモンド中にはシリコンの混入だけが認められる。そして、この混入量は酸素添加量の増加に従って減少している。これは酸素がシリコン混入を抑制する直接的な証拠である。この試料には水素と添加した酸素の混入は認められない。
図2は(111)面上に合成したダイヤモンド多層膜から得られたSIMSの深さ方向プロファイルである。酸素無添加で合成された膜内には水素とシリコンの混入が認められる。そして、酸素を1%添加して合成された膜内には水素とシリコンの混入は認められない。1%の酸素添加で、水素とシリコンの(111)ホモエピタキシャル中への混入は2-3桁程度抑制されている。この試料においても、添加した酸素の混入は検出されない。また、成長速度は酸素を1%添加することで、無添加の時の半分の速度にまで減少する。(100)面と(111)面に含まれる不純物量を比較すると、水素は(100)面の試料では検出されず、(111)面では水素のバックグラウンドよりも約2桁多く含まれている。シリコンに関しては、(111)面の方が(100)面よりも約3桁多く含んでいる。この結果は(111)面が不純物を取り込みやすい面であることを示している。
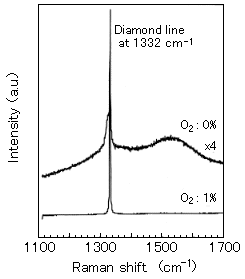
図3 Raman spectra obtained from two diamond films.(原論文2より引用。 Reprinted with permission from Data source 2 below. Copyright 1998, American Institute of Physics.)
図3は(111)面上に合成したダイヤモンド膜から得られたラマンスペクトルである。試料は酸素無添加で合成したダイヤモンドと酸素を1%添加した条件で合成したダイヤモンド膜である。膜厚はラマンの測定条件を考慮して5マイクロメーターになるよう合成時間を調整した。酸素無添加で合成されたダイヤモンドからはダイヤモンドピーク以外に乱れたグラファイト成分に起因するピークが観察される。
また、S/N比も大きくない。これに対して、1%の酸素を添加して合成されたダイヤモンドから得られたラマンスペクトルは高いS/N比を示し、そして、グラファイトに起因するピークなどは観察されない。このダイヤモンドは非常に高い結晶性を示している。また、試料表面のモルフォロジーに関しては、酸素無添加の場合は表面割れが観察され、高密度の三角形のテラスも観察される。一方、1%の酸素を添加したダイヤモンド表面は平坦で、かつ、表面割れはない。水素とシリコンの混入過程はダイヤモンド成長表面での反応経路が変化したことを意味している。今後はダイヤモンド表面での素反応の解明と、酸素の効果を応用した半導体添加物の制御行われるべき課題であろう。
コメント :
SIMSを用いて微量不純物を評価する手法は半導体分野では一般的である。しかし、セラミックスは電気を通さない絶縁体が主であり応用するには難しいとされている。SIMSはセラミックス分野でも使用に際し十分注意を払うことで威力を発揮し、深さ方向プロファイルだけでなくイメージングや高質量分解能などで、研究に必要不可欠な情報が得られる最高級の分析装置である。
原論文1 Data source 1:
Silicon Incorporation into Chemical Vapor Deposition Diamond: A Role of Oxygen
I. Sakaguchi, M. Nishitani-Gamo, K. P. Loh, H. Haneda, S. Hishita and T. Ando
Core Research for Evolutional Science and Technology (CREST) of Japan Science and Technology Corporation (JST) and National Institute for Research in Inorganic Materials (NIRIM)
Appl. Phys. Lett. 71 (1997) pp. 629-631.
原論文2 Data source 2:
Suppression of Surface Cracks on (111) Homoepitaxial Diamond through Impurity Limitation by Oxygen Addition
I. Sakaguchi, M. Nishitani-Gamo, K. P. Loh, S. Hishita, H. Haneda and T. Ando
Core Research for Evolutional Science and Technology (CREST) of Japan Science and Technology Corporation (JST) and National Institute for Research in Inorganic Materials (NIRIM)
Appl. Phys. Lett. 73 (1998) pp. 2675-2677.
原論文3 Data source 3:
Effect of Oxygen Addition on Boron Incorporation on Semiconductive Diamond CVD
I. Sakaguchi, M. Nishitani-Gamo, K. P. Loh, K. Yamamoto, H. Haneda and T. Ando
Core Research for Evolutional Science and Technology (CREST) of Japan Science and Technology Corporation (JST) and National Institute for Research in Inorganic Materials (NIRIM)
Diamond and Related Materials 7 (1998) pp. 1144-1147.
キーワード:2次イオン質量分析法、不純物分布、欠陥
Secondary ion mass spectrometry, Impurity distribution, Defect
分類コード:110103, 110503
原子力基盤技術データベースのメインページへ